ドレイン電流密度が改善され、ブレークダウン電圧が高い高性能AlGaNダブルチャネルHEMT
要約
この作業では、AlGaNダブルチャネルヘテロ構造を提案し、有機金属化学蒸着(MOCVD)によって成長させ、高性能AlGaNダブルチャネル高電子移動度トランジスタ(HEMT)を製造して調査します。ダブルチャネル機能の実装により、AlGaNチャネルヘテロ構造の輸送特性が効果的に向上します。一方では、垂直方向に沿った二重ポテンシャル井戸と強化されたキャリア閉じ込めにより、全二次元電子ガス(2DEG)密度が促進されます。一方、各チャネルの平均2DEG密度は低下し、キャリア-キャリア散乱効果の抑制により移動度が上昇します。その結果、最大ドレイン電流密度( I max )AlGaNダブルチャネルHEMTの)は、ゲート電圧0Vで473mA / mmに達します。さらに、AlGaNダブルチャネルHEMTの優れたブレークダウン性能も実証されています。これらの結果は、マイクロ波パワーエレクトロニクスにおけるAlGaNダブルチャネルHEMTの優れたアプリケーションの可能性を示しているだけでなく、III族窒化物ベースの電子デバイスの研究に対する新しい考え方を発展させています。
はじめに
グループIIIの窒化物ベースの高電子移動度トランジスタ(HEMT)は、高速スイッチング速度と低スイッチング損失により、次世代マイクロ波パワーエレクトロニクスの最も有望な候補として特定されています[1,2,3,4,5]。 。最近、最先端の窒化物HEMTは、650 Vまでの初期商用化を達成しました。しかし、デバイス製造技術の成熟に伴い、絶縁破壊電圧( V )をさらにスケールアップすることはますます困難になっています。 b )および高温でのデバイスの信頼性を向上させます。したがって、GaNよりもAlGaNのバンドギャップが大きく、熱安定性が優れていることを考慮して、AlGaNチャネルデバイスは、高電圧および高温アプリケーションでの窒化物HEMTの性能限界をさらに改善する有望な候補として提案されています[6、7、8 、9、10、11、12、13、14、15]。
南條他は、AlGaNチャネルHEMTの顕著な絶縁破壊電圧の向上を示し、得られた最大絶縁破壊電圧は、Al 0.53 で1650Vでした。 Ga 0.47 N / Al 0.38 Ga 0.62 ゲート-ドレイン距離が10μmのNHEMT [6]。その後、南條ら。 Al 0.40 の絶縁破壊電圧をさらに促進 Ga 0.60 N / Al 0.15 Ga 0.85 1700VまでのNHEMT [8]。張ら。新しいオーミック/ショットキーハイブリッドドレイン接点を備えたAlGaNチャネルHEMTを製造し、AlGaNチャネルHEMTで2200Vを超える記録的な高降伏電圧が得られました[11]。 Xiao etal。 807 cm 2 の高い2DEG移動度を持つAlGaNチャネルヘテロ構造を提案しました / V・s、および最大ドレイン電流とI on の記録 / I オフ 製造されたAlGaNチャネルHEMTの比率が報告されました[14]。その後、Xiao etal。超格子AlGaNチャネル層を備えたノーマルオフHEMTを初めて提案し、製造されたデバイスは、2000 Vを超える絶縁破壊電圧、768 mA / mmの高いオン電流密度、およびしきい値電圧( V > T )1.0Vの[15]。最近、Baca etal。 80 nmの長さのゲートを備えたAlGaNチャネルHEMTの無線周波数(RF)性能を評価しました。 f T 28.4GHzおよびf MAX 18.5 GHzは、小信号のSパラメータ測定から決定されました[12]。これらの結果は、RF電力アプリケーション向けのAlGaNチャネルHEMTの可能性を示しています。
ただし、以前に報告されたAlGaNチャネルデバイスの制限も同様に明らかです。一方では、三元合金の無秩序な散乱効果のために、AlGaNチャネルの二次元電子ガス(2DEG)の移動度は、GaNチャネルの移動度よりもはるかに低くなっています。その結果、AlGaNチャネルデバイスの電流駆動容量は、従来のGaNチャネルデバイスのそれよりもはるかに低くなります。一方、AlGaNチャネルに同量の2DEGを誘導するには、AlGaNバリア層のAlN成分を従来のGaNチャネルヘテロ構造よりも高くする必要があり、材料成長プロセスの難しさが増します。これらの矛盾は、AlGaNチャネルデバイスの広範なアプリケーションを深刻に阻害し、ヘテロ構造レイアウトの最適化が緊急に必要とされています。
ダブルチャネル技術は、電子移動度に悪影響を与えることなく窒化物ベースのヘテロ構造のチャネルキャリア密度を促進するための興味深いアプローチであり、デバイスの電流伝導能力が向上します[16、17、18]。しかし、これまで、AlGaNダブルチャネルヘテロ構造または電子デバイスに関する報告はほとんどありませんでした。この研究では、電流駆動能力と窒化物ベースの電子デバイスの破壊性能との間の矛盾を解決するために、初めてAlGaNダブルチャネルヘテロ構造が提案され、成長しました。さらに、新しいヘテロ構造に基づく高性能AlGaNダブルチャネルHEMTが製造され、詳細に調査されています。
メソッド
AlGaNダブルチャネルヘテロ構造の断面図を図1aに示します。成長プロセスは、次のように要約できます。まず、サファイア基板上に1600nmのGaNバッファ層を成長させました。次に、AlN組成が0から10%に増加する500 nmの傾斜AlGaNバッファ層を成長させました。これは、寄生チャネルの形成を抑制するのに有益でした。その後、100 nm下部のAlGaNチャネル、1 nm下部のAlN中間層、および23 nm下部のAlGaNバリアが連続して成長し、チャネル層とバリア層のAlN組成はそれぞれ10%と31%になります。最後に、30 nmの上部AlGaNチャネル、1 nmのAlN中間層、および23 nmの上部AlGaNバリア層を成長させました。これらの層の組成は、下部層と同じでした。 AlGaNダブルチャネルヘテロ構造の伝導バンド図は、メッシュサイズが不均一な有限差分法を使用する1次元のPoisson-Schrödinger方程式を自己無撞着に解くことによって計算できます[19]。 AlGaNダブルチャネルヘテロ構造の伝導帯図と抽出された電子密度分布を図2aに示し、AlGaNシングルチャネルヘテロ構造の結果も図2bに示しています。 AlN中間層とAl 0.10 の界面に2つの深いポテンシャル井戸が形成されます Ga 0.90 ダブル2DEGチャネルに対応するAlGaNダブルチャネルヘテロ構造のNチャネル層。さらに、上部チャネルの2DEG密度が下部チャネルの2DEG密度よりも高いことが観察できます。これは、2つの側面から説明できます。一方では、下部AlGaNバリアは、上部チャネルのバックバリアとして機能します。これは、上部チャネルの2DEG閉じ込めを促進するのに役立ちます。一方、窒化物ヘテロ構造におけるチャネル2DEGの主な供給源は、ドナーのような表面状態[20]であり、上部チャネルにより近くなっています。
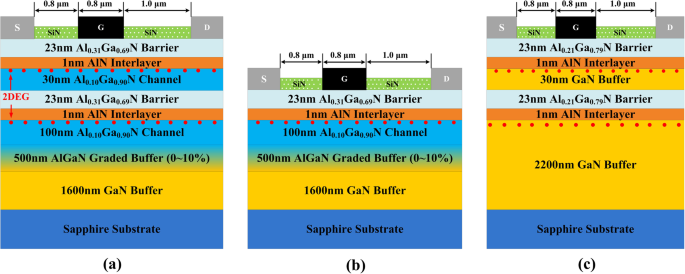
a の断面図(原寸に比例していない) AlGaNダブルチャネル、 b AlGaNシングルチャネル、および c GaNダブルチャネルヘテロ構造(HEMT)
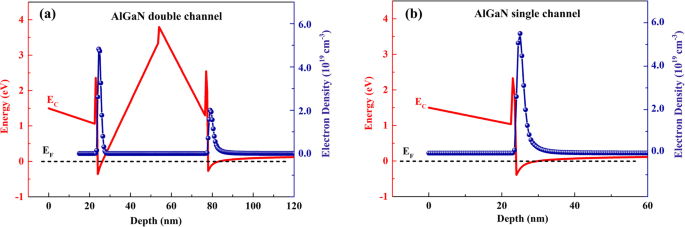
AlGaNダブルチャネルおよびシングルチャネルヘテロ構造の伝導帯図と電子密度分布
結果と考察
図3は、対称(0004)反射によるAlGaNダブルチャネルヘテロ構造の高分解能X線回折(HRXRD)ω-2θスキャン結果を示しています。 AlN核形成層、GaNバッファ、AlGaN傾斜バッファ、AlGaNチャネル、およびAlGaNバリア層からの回折強度を観察できます。さらに、71.0から73.2°までのスペクトルスキャンを図2bに拡大して示し、明確にするためにローレンツ関数を適用してマルチピークに適合させています。 GaNバッファー、AlGaNチャネル、およびAlGaNバリアの回折ピークは71.6°、72.2°、および72.8°にあり、AlGaN傾斜バッファーは、GaNバッファーとAlGaNチャネルのピークの間にプラットフォームをもたらします。これらの結果は、明確な多層構造と成長プロセスの高度な制御を示しており、AlGaNチャネルとバリアの10%と31%のAlN組成を抽出できます。

AlGaNダブルチャネルヘテロ構造のHRXRD(0004)面ω-2θスキャン
ヘテロ構造のダブルチャネル特性を調査するために、水銀プローブ構成での静電容量-電圧(C-V)測定を実行しました。図4の挿入図に示すように、AlN / Al
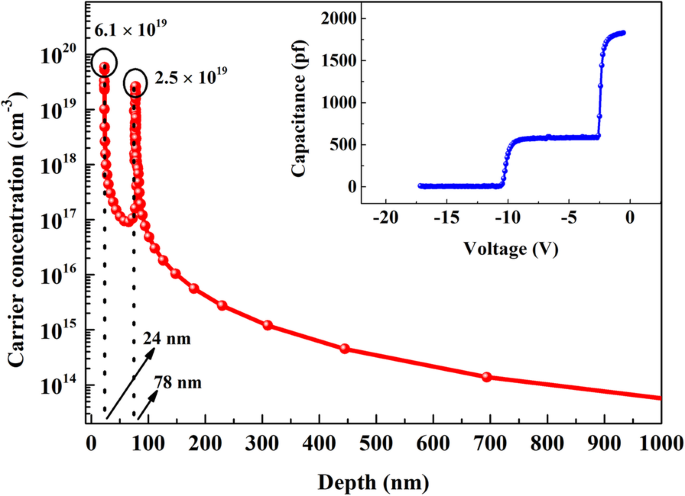
AlGaNダブルチャネルヘテロ構造のC-V特性と電子分布曲線
標準のHEMT製造プロセスは、AlGaNダブルチャネルヘテロ構造で実行されました。デバイスの製造プロセスは、電子ビーム蒸着によって堆積されたTi / Al / Ni / Au多層金属スタックで形成されたオーミック接触から始まり、続いて850°Cで30秒間N 2 で急速熱アニールされました。 雰囲気。次に、Cl 2 によってメサ分離が実行されました。 / BCl 3 深さ200nmまでの誘導結合プラズマエッチングと、プラズマ化学気相成長法によって厚さ100nmのSiNパッシベーション層が形成されました。その後、長さ( L G )0.8μmは、CF 4 で上部のSiNをエッチングした後のフォトリソグラフィーによって定義されました。 プラズマ、次にNi / Auショットキーゲート電極が堆積されました。ゲートソース( L GS )およびゲートドレイン( L GD )距離はそれぞれ0.8と1μmです。比較のために、従来のAlGaNシングルチャネルおよびGaNダブルチャネルヘテロ構造に基づく2つの追加のHEMTサンプルも製造され、断面図が図1bおよびcに示されています。追加のHEMTサンプルのデバイスプロセスと特性パラメータは、AlGaNダブルチャネルHEMTとまったく同じです。デバイスの出力および転送特性はKeithley4200半導体パラメータアナライザを使用して実行され、ブレークダウン特性はAgilentB1505A高電圧半導体アナライザシステムを使用して実行されました。
HEMTの典型的な出力特性を図5に示します。この場合、V GS およびV DS 0〜10 Vおよび0〜10 Vから掃引されました。最大ドレイン電流密度( I max )および差動オン抵抗( R on )のAlGaNシングルチャネルサンプルは、それぞれ265.3 mA / mmと27.1Ω∙mmです。これらの結果は以前の報告と一致しており、現在の駆動能力におけるAlGaNチャネルHEMTの不足を示唆しています。 AlGaNダブルチャネルHEMTの場合、 I max 473 mA / mmに劇的に増加します。これは、AlGaNシングルチャネルHEMTの1.8倍です。 I の改善によるものです max AlGaNダブルチャネルヘテロ構造の優れた輸送特性に。一方では、ダブルチャネル構造は垂直方向に沿って2つのポテンシャル井戸を持ち、AlGaN伝導チャネルのキャリアストレージ機能が促進されます。一方、総チャネルキャリア密度は増加しますが、各チャネルの平均電子密度は減少します。その結果、キャリア-キャリア散乱効果が抑制され、チャネル電子移動度が上昇します。ただし、 R on AlGaNダブルチャネルHEMTの12.5Ω∙mmは、GaNダブルチャネルHEMTのそれよりもさらに大きいです。この現象は、AlN組成が31%と高いAlGaNバリア層の高い接触バリア高さに関連しています。高い消費電力に起因する自己発熱効果により、 V の場合、GaNダブルチャネルHEMTの負性抵抗効果が観察されます。 GS > − 4Vおよび V DS > 6 V.それにもかかわらず、AlGaNチャネルHEMT(シングルチャネルとダブルチャネルの両方)の場合、この負性微分抵抗効果は大幅に抑制され、高温条件でのAlGaNチャネルHEMTの優れた性能を示します。

AlGaNダブルチャネル、AlGaNシングルチャネル、およびGaNダブルチャネルHEMTの出力特性
図6は、 V を使用したHEMTの一般的な伝達特性を示しています。 DS AlGaNシングルチャネルHEMTは、しきい値電圧( V )を示します。 T )-3.8 V、および下位ピークの外因性相互コンダクタンス( G m、max ) V 付近で80.5mS / mm GS =−1.5V。AlGaNダブルチャネルおよびGaNダブルチャネルHEMTの場合、 V T チャネルキャリア密度が高く、ゲート電極から下部2DEGチャネルまでの距離が比較的長いため、-9.2および-11.2Vに著しく低下します。高い V T オフ状態ではデバイスの電力損失が大きくなる可能性があります。この問題は、バリア層と上部チャネル層の厚さを適切に減らすなど、ダブルチャネル構造の成長パラメータをさらに最適化することで改善できます。特に、AlGaNダブルチャネルおよびGaNダブルチャネルHEMTの相互コンダクタンス曲線のダブルハンプ特性を観察できます。 AlGaNダブルチャネルHEMTの場合、97.9および42.5 mS / mmの2つのピーク値を V で抽出できます。 G =− 1.0および− 6.0V。サブピーク値はG m、max の43%に達します。 、AlGaNダブルチャネルHEMTの適切なゲート制御能力と直線性を示します。さらに、これまでの研究成果[21]に基づいて、AlGaNダブルチャネルの厚さや組成などの構造パラメータを変調することで結果をさらに改善でき、ダブルチャネルとデバイスの直線性の間の結合効果は次のようになります。強化されました。

AlGaNダブルチャネル、AlGaNシングルチャネル、およびGaNダブルチャネルHEMTの伝達特性
さまざまなヘテロ構造に基づくHEMTのオフ状態破壊特性が測定され、図7に示されています。 V b 漏れ電流が5μA/ mmに達するという基準によって定義されます。 3つのサンプルすべてがハードブレークダウン特性を示し、AlGaNチャネルHEMTのブレークダウン性能はGaNチャネルHEMTのブレークダウン性能よりも明らかに優れていることがわかります。 V b AlGaNダブルチャネルHEMTの143.5Vは、GaNダブルチャネルHEMTの2倍以上です。 L を取る GD =1μmを考慮に入れると、 V b、標準 ( V で定義 b / L GD )AlGaNダブルチャネルHEMTの場合、143.5 V /μmと高くなります。 私 max および V b、標準 この作業でのAlGaNダブルチャネルHEMTの結果は、図8の他のグループによって報告されたGaNチャネルおよびAlGaNチャネルHEMTに対してベンチマークされ、空乏モード(DM)デバイスと強化モード(EM)デバイスの結果が区別されます。さらに、以前のレポートとこの作業でのAlGaNチャネルHEMT(ヘテロ構造)のコアインデックスを表1にまとめています。図8に示すように、AlGaNチャネルHEMTの破壊性能は一般にGaNよりも優れていることは明らかです。 I の劣化を伴うチャネルHEMT max 。注目すべきことに、 I max この作業でのAlGaNダブルチャネルの結果は、GaNチャネルHEMTのほとんどの結果に匹敵します。さらに、 I に注意する必要があります max この作業の値は V で取得されます GS =0V。これは控えめであり、正のゲート電圧を印加することでさらに改善できます。したがって、これらの結果は、マイクロ波パワーデバイスアプリケーションにおけるAlGaNダブルチャネルHEMTの大きな可能性を説得力を持って示しています。

AlGaNダブルチャネル、AlGaNシングルチャネル、およびGaNダブルチャネルHEMTの故障特性
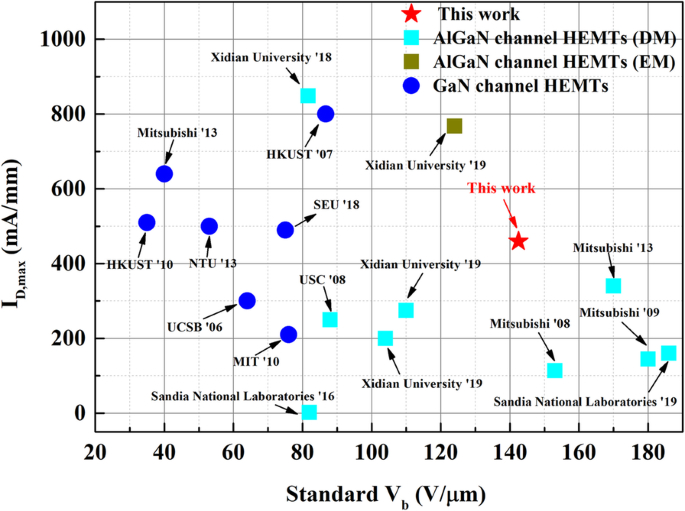
I のベンチマーク max および V b、標準 AlGaNチャネルおよびGaNチャネルHEMTの場合
結論
要約すると、AlGaNダブルチャネルヘテロ構造は、高性能HEMTを製造するために提案されています。 AlGaNダブルチャネルヘテロ構造の優れた輸送特性が明らかになり、HEMTの電流駆動能力が向上します。さらに、AlGaNダブルチャネルHEMTの優れたブレークダウン性能が実証されています。この研究の結果は、将来のマイクロ波電力アプリケーションにおけるAlGaNダブルチャネルデバイスの大きな可能性を示しています。
データと資料の可用性
この調査中に生成または分析されたすべてのデータは、この公開された記事とその補足情報ファイルに含まれています。
略語
- MOCVD:
-
有機金属化学蒸着
- HEMT:
-
高電子移動度トランジスタ
- 2DEG:
-
二次元電子ガス
- I max :
-
最大ドレイン電流密度
- V b :
-
絶縁破壊電圧
- V T :
-
しきい値電圧
- RF:
-
無線周波数
- HRXRD:
-
高解像度X線回折
- C-V:
-
静電容量-電圧
- L G :
-
ゲート長
- L GS :
-
ゲート-ソース間距離
- L GD :
-
ゲート-ドレイン距離
- R on :
-
オン抵抗
- G m :
-
相互コンダクタンス
- DM:
-
枯渇モード
- EM:
-
エンハンスメントモード
ナノマテリアル



