III族窒化物ナノロッド/ Si(111)ヘテロ接合太陽電池における光トラッピング誘起の高い短絡電流密度
要約
グリッド金属接触面積を除き、1太陽、AM 1.5G条件下で、電力変換で1.27%の有効面積光起電力効率が、エピタキシャル成長したp-GaN / i-InGaN / n-GaNダイオードアレイで得られました。 (111)-Si。短絡電流密度は14.96mA / cm 2 です。 開回路電圧は0.28Vです。歪みや欠陥のないIII族窒化物ナノロッドアレイ構造内での多重反射によって得られる強化された光トラッピングと、ワイドバンドギャップIII族窒化物成分によってブーストされた短波長応答がデバイスのパフォーマンスの向上が観察されました。
はじめに
グリーンエネルギーの開発はますます重要になり、太陽電池産業と同様に発光ダイオード(LED)は、ますます増大するエネルギー危機のために速いペースで発展してきました。過去数十年にわたって、III族窒化物半導体はLEDデバイスにうまく適用されており[1,2,3]、それは実質的な商業的利益をもたらしました。現在、多くの科学者が、光起電用途向けのIII族窒化物に関する研究の可能性を活用しようとしています[4、5]。グループIII-Vの窒化物材料は、吸収係数が大きい直接バンドギャップ[4、6]、バンドエンジニアリングによる太陽光スペクトルの大部分をカバーする広いバンドギャップ範囲[4、6、7]など、太陽光発電システムに多くの利点があります。高いキャリア移動度[7]、および優れた耐放射線性[8]。これらの優れた特性に基づいて、InGaN / Siタンデムセル[9、10、11、12、13、14]、ホットキャリア太陽電池[15]、ショットキーベースの太陽電池[16、 17,18]、単一[19,20,21,22,23,24]および複数[25、26]接合太陽電池、および太陽電池性能に対する分極効果[9、23、27]。シミュレーションでは、さまざまなシミュレーションモデルに基づいて、InGaN / Siヘテロ構造タンデムセルの効率が21〜36%になると予測されています[10、11、13]。 4つの異なるIn組成を持つInGaNホモ構造タンデム太陽電池の電力変換効率(PCE)は、1太陽放射照度で51%、250太陽集中条件下で58%であると提案されています[26]。しかし、不純物と非放射再結合の問題は、低温InGaN薄膜成長条件下でますます重要になります[28、29、30]。格子不整合による重大な積層欠陥と転位密度は、キャリア拡散長の減少と太陽電池PCEの制限につながります[31、32、33、34]。したがって、高効率のIII族窒化物光起電力デバイスの潜在的な機能を実現するには、多くの課題が残っています。
過去10年間で、自立型GaN基板上での高In InGaN結晶成長法[34]、p型InGaNドーピング[35]、量子井戸設計[36,37,38,39,40]、電極など、多くの関連する研究トピックがあります。設計[41,42,43,44]、集光型太陽光発電[37、41、45]、中間帯域太陽電池[46]、および反射低減構造[47,48,49]が研究されています。さらに、無極性窒化物ベースの太陽電池は、偏光効果について調査されました[50、51]。 Dahal etal。より長い波長(> 420 nm)で30%-In InGaN多重量子井戸太陽電池の動作を示し[38]、30日までの増加した照度で3.03%の効率を示しました[37]。森らコンセントレータ窒化物ベースの太陽電池を調査し[45]、300太陽までの高い光強度で動作する4%の最高のPCEに対処しました[41]。いくつかの研究グループが異なる構造または光学設計を提供し、成長技術を改善したにもかかわらず、III族窒化物太陽電池のPCEはあまり進歩しませんでした。一方、Reichertz etal。タンデム太陽電池は、p-n接合Si基板上にp-n接合GaNをエピタキシャル成長させることで実現可能であることを実証しました[14]。彼らの結果は、窒化物が短波長効率に寄与しているのに対し、Si基板は長波長効率に寄与していることを示した。シリコン基板は、低コストのソリューションだけでなく、PCEの強化と優れた熱伝導率も提供します[52]。
通常、太陽電池の成長では、連続的な膜層が互いの上に成長し、これにより高い転位密度が得られます。ただし、III族窒化物をナノ構造で成長させると、基板と接触する底部の面積が小さくなるため、貫通転位が減少し、歪みも最小限に抑えることができます。 Tessarek etal。直径が200nmに減少すると、GaNナノロッドの転位が消失したと報告されています[53]。したがって、シリコン基板上での膜成長の代替として、III族窒化物ナノロッド太陽電池を成長させて、コストを削減し、結晶品質を改善し、セル効率を高めることが好ましい選択である。また、ナノロッド/ナノワイヤは、電極への直接経路により、光生成電子が正孔と再結合する前により効果的に収集でき、ナノロッド構造が光トラップを改善して光子吸収を強化できるため、光起電用途に大きな容量を備えています[54、 55]。いくつかのグループが、III族窒化物ナノロッド[55]に基づく光検出器[56、57]、ナノレーザー[58、59]、ナノLED [60、61]、および光電気化学水分解アプリケーション[62]を実証しました。それにもかかわらず、ナノロッド太陽電池のデメリットは、光生成された電子正孔対が、表面欠陥のために豊富なキャリアトラップ中心で再結合することです。さらに、ナノロッド太陽電池のデバイス製造プロセスは、薄膜デバイスのそれよりも複雑です。ただし、上記のこれらの問題を克服すると、Wallentin et al。によって示されているように、PCEがほぼ3倍に増加しました。ここで、InPナノロッドアレイは、ナノロッドの直径と上部のnセグメントの長さの最適化による13.8%のPCEを持っています[54、63]。 Krogstrup etal。高い短絡電流密度(J sc )は、光の集中によって強化された1桁以上の光吸収により、シングルコアシェルGaAsナノワイヤ構造で得られました[64]。 Wierer etal。 [65]、Cansizoglu etal。 [66]、およびグエン等。 [31]は、GaNテンプレートとSi基板上のさまざまなタイプの窒化物ナノロッドアレイ太陽電池を実証しました。最近のナノロッド/ナノワイヤー太陽光発電研究の比較は、補足情報:表S1に記載されています。ただし、低コストのSi(111)基板上のさまざまなIn含有量のInGaNナノロッドアンサンブル光起電力デバイスの光電変換の寄与については、これまで体系的に議論されていません。
この研究では、8%および11%のインジウム濃度のMg:GaN / InGaN / Si:GaN III窒化物ナノロッドアンサンブルを、プラズマ支援分子線エピタキシー(PA-MBE、Veeco)によってnドープSi(111)基板上に成長させました。 EPI930)。構造特性とインジウム含有量は、高分解能X線回折(HR-XRD、Bede D1)測定によって推定されました。ナノロッドの微細構造は、高分解能透過型電子顕微鏡(HR-TEM、FEI E.O Tecnai F20 G2)によって分析されました。窒化物太陽電池の電流密度対電圧(J-V)特性は、1太陽、AM 1.5G照明(Newport 94023A)の下で議論されました。スペクトル応答を研究するために、外部量子効率(EQE、Enli Technology Co.、Ltd.、QE-R3018)を測定しました。電子と正孔の輸送を説明するために、バンド図の位置合わせとシミュレーションも調査されました。
実験方法
成長テクニック
Si:GaNおよびMg:GaN / InGaN / Si:GaNナノロッドの成長は、プラズマ支援分子線エピタキシー(PA-MBE)技術に基づいています。すべてのサンプルは、6N窒素プラズマ源(Veeco、UNI-Bulb)を備えたVeeco GEN930PA-MBEシステムによって成長しました。抵抗率が0.001〜0.005Ωcmのn型Si(111)基板を、アセトン、イソプロパノール、および脱イオン水で各ステップで5分間超音波浴で洗浄し、残留有機汚染物質を除去してから、 48〜51%HF:H 2 O =1:5の溶液で5分間、自然酸化物を除去します。化学的洗浄/エッチングプロセスの後、Si基板に窒素ガスを吹き付けて乾燥させました。 Si基板はバッファチャンバーに導入され、磁気結合されたトランスファーアームによって成長チャンバーに転写されました。ナノロッドを成長させる前に、基板を900°Cで30分間熱洗浄し、残留する自然酸化物を除去して、きれいで秩序だった7×7の再構成Si表面を得ました。活性化された窒素原子はプラズマガンによって生成され、そのフラックスと純度は、高分解能マスフローコントローラー(HORIBA STEC、SEC-7320 M)と窒素精製器(Entegris、CE35KFI4R)によって制御されました。高純度(6N以上)のGa、In、Si、およびMgの供給源は、固体供給源のエフュージョンセルによって提供されました。 III族金属およびN 2 プラズマビーム当量(BEP)はビームフラックスゲージで測定されました。 Nリッチ条件に対するIII / Vフラックス比を制御することにより、ナノロッドを得ることができます。まず、自己組織化Si:GaNナノロッドを760°Cで82分間成長させました。インジウムはサンプル表面から蒸発するため、InNの脱離は高温で重要です。ナノロッドにインジウムを保持するために、金属変調エピタキシー(MME)技術が利用されました[67、68]。 MMEは、金属フラックスを調整するために金属シャッターを定期的に開閉しますが、N 2 シャッターは開いたままです。 In濃度を調整するために、In原子とGa原子の2つの異なるサイクル時間が、550°Cで50周期で、20 s / 30 s(サンプルB)と30 s / 30 s(サンプルC)で交互に基板に衝突しました。最後に、Mg:GaN層を600°Cで成長させました。サンプルは9.25×10 -6 で栽培されました プラズマ出力450W、2.42×10 -8 のトル活性窒素BEP torr In BEP、および1.93×10 -8 torr GaBEP。さらに、単層Si:GaNナノロッド(サンプルA)も、同じ条件下で制御グループとして準備されました。
デバイス製造
ナノロッドの成長後、デバイス製造プロセスには次のステップが含まれていました。 (1)350×350μm 2 のデバイス領域 メサは、テトラフルオロメタン(CF 4 )でn型Siまでエッチングすることによって定義されました。 )フォトレジスト(Microchemicals GmbH、AZ1400)をマスクとして使用する反応性イオンエッチング技術(Advanced System Technology、Cirie-200)に基づいています。 (2)脱イオン水を使用した超音波浴を使用して、メサ領域のナノロッドを除くデバイスから緩んだナノロッドを除去しました。 (3)サンプルを(NH 4 ) 2 60°Cで1分間Sして、窒化物表面を不動態化し、自然酸化物の抑制と非放射再結合の還元を実現します[69,70,71,72,73]。 (4)100 nmの酸化インジウムスズ(ITO)薄膜をナノロッドの上に堆積させ、フォトリソグラフィー(M&R Nano Technology)を伴うスパッタリング(Advanced System Technology、Psur-100HB)によるMg:GaNオーミック透明接点として機能させました。 、AG350-6B)およびリフトオフ技術。 (5)ITO膜およびn型Si基板上の多層Ti / Al / Ti / Au(20 nm / 300 nm / 20 nm / 50 nm)グリッド金属接点は、電子ビーム蒸着(Advanced System Technology 、Peva-600E)フォトリソグラフィーとリフトオフ技術を使用。 (6)すべてのグリッド金属接点をラピッドサーマルアニーリングシステム(Advanced System Technology、FA04)で、窒素中、800°Cで30秒間アニールして、オーミック接点を得ました。
TEMサンプルの準備
結晶構造をさらに研究するために、サンプルBおよびCの個々のナノロッドをエタノール中での超音波処理によって抽出しました。 30分間の超音波処理後、エタノール溶液を数滴銅グリッド(Ted Pella)に塗布し、エタノールを室温で蒸発させました。測定前に、サンプルを150°Cでベークして遊離有機溶媒を除去しました。
結果と考察
形態学的および構造的特性
走査型電子顕微鏡(SEM)画像の上面図と断面図を図1a–fに示し、成長したままのナノロッドの形態を示します。左から右に、図1 a〜cは、Si:GaN(サンプルA)とMg:GaN / InGaN / Si:GaNの表面形態の変化を表しており、In / Ga原子が変化してサイクル時間が20s / 30になります。 50サイクルのInGaN成長中のs(サンプルB)と30 s / 30 s(サンプルC)。 Si:GaNおよびMg:GaN / InGaN / Si:GaNナノロッドの直径はそれぞれ30〜100 nmおよび80〜150 nmであり、面密度は約7×10 9 です。 cm −2 。ナノロッドの断面画像を図1d–fに示します。これは、サンプルA〜Cのナノロッドの長さが約700 nmであることを示しています。Mg:GaN / InGaN / Si:GaNサンプルの概略構造を示します。図1g。
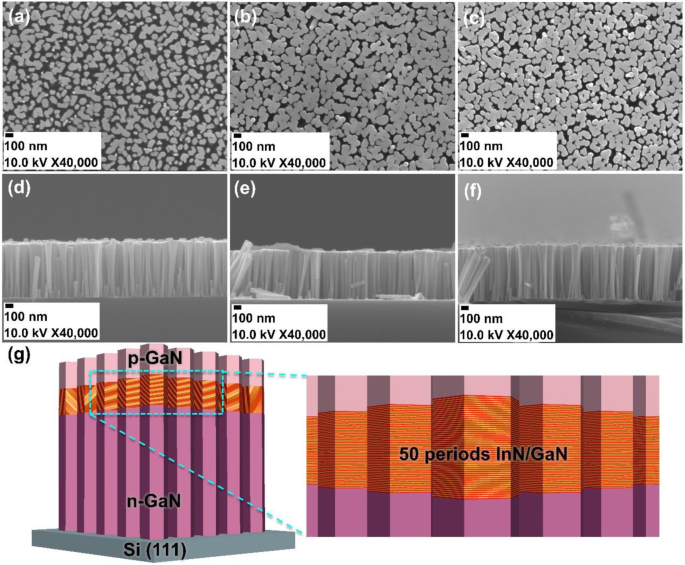
a のSEM上面図 n-GaN(サンプルA)、InおよびGa原子が b のサイクルタイムに影響を与えるp-GaN / InGaN / n-GaN 20 s / 30 s(サンプルB)および c 30 s / 30 s(サンプルC)。 d のSEM断面図 サンプルA、 e サンプルB、および f サンプルC。 g p-GaN / InGaN / n-GaNナノロッド構造の概略図
図2aは、サイクルタイムサンプルに衝突するさまざまな線源に焦点を当てたX線シータ-2シータ回折測定を記録したものです。 28.44°にある最も強いピークは、Si基板に由来します。 34.56°の鋭い明確なピークは、GaN(0002)回折に対応し、InGaN層からの相混合が良好に抑制されていることを示しています。サンプルBでは34.22°、サンプルCでは34.13°のGaN(0002)ピークの下側2シータ側のピークはInGaN(0002)です。 c InNとGaNの格子定数はそれぞれ5.760Åと5.185Åです[74]。ブラッグの法則に従い、 c InGaN(0002)の格子定数は、サンプルBでは5.23Å、サンプルCでは5.25Åと計算されます。 c のインポート ベガードの法則に対するInGaN(0002)の格子定数から、In濃度は、ひずみを考慮せずに、サンプルBで8%、サンプルCで11%と見積もることができます。図2bは、サンプルCの低倍率TEM画像とその構造の概略図を示しています。エリア1とエリア2は、それぞれn-GaN領域とInGaN領域です。領域1で取られた選択領域電子回折(SAED)パターンは、[0001]方向がナノロッドの長軸および窒化物ナノロッドの共通の成長方向に平行であることを示しています。また、結晶中に転位は見られません。図2cおよびdでは、原子分解能TEM画像により c が得られます。 GaNとInGaNの格子定数はそれぞれ5.19Åと5.25Åであり、XRDシータ-2シータスキャンを介してブラッグの法則によって計算された結果と同じです。さらに、 c サンプルBのInGaNの格子定数は、補足情報に示されている原子分解能TEM画像で5.23Åです。図S1。さらに、インジウム分布を示す高角度環状暗視野(HAADF)画像とエネルギー分散型X線分光法(EDS)ラインスキャンが補足情報に含まれています:図S2。
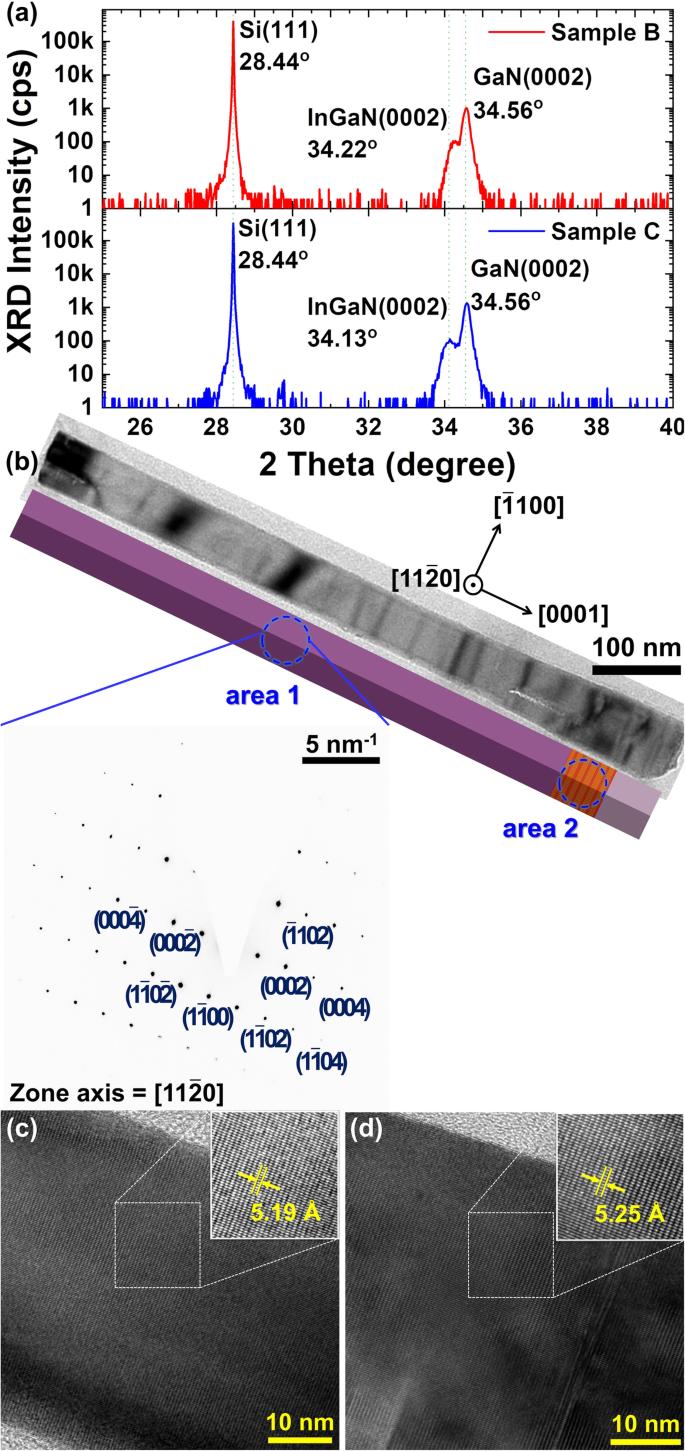
a theta-2thetaスキャンのHR-XRDスペクトル。ベガードの法則を使用して、InGaN材料のインジウム含有量はサンプルB(赤い曲線)で8%、サンプルC(青い曲線)で11%と推定されました。 b n-GaN領域の無転位窒化物ナノロッドTEM画像とSAEDパターン。画像の下にある単一のナノロッドの概略図は、構造的な相対的なスケールに従います。 c の原子分解能TEM画像 エリア1および d のn-GaN エリア2のInGaNは、転位がなく、 c 格子定数
電気的および光学的特性分析
電流密度対電圧の測定は、Keithley2400ソースメーターによって実行されました。図3aは、ナノロッドアセンブリ太陽電池の概略図を示しています。デバイスの総面積は0.12mm 2 です。 接触金属を除いた照明下の有効面積は0.0924mm 2 です。 。光子生成電子を収集するために、100 nmの透明導電性ITOフィルムをp-GaNの上部に堆積して、ナノロッドとTi / Al / Ti / Au(20 nm / 300 nm / 20 nm / 50 nm)を接続します。 )指電極。図3b–dに示すように、デバイスの光電特性分析も1太陽、AM1.5G条件下でソーラーシミュレーターを使用して実行されました。直列抵抗 R s 図3b–dから決定された値は、83Ω、250Ω、および2.5kΩであり、シャント抵抗 R sh 値は、サンプルA、B、およびCでそれぞれ413kΩ、550kΩ、および2MΩです。ゼロ電圧での光電流密度、J sc 、In 0.08 の Ga 0.92 Nデバイス(サンプルB)およびIn 0.11 Ga 0.89 Nデバイス(サンプルC)は7.77 mA / cm 2 および14.96mA / cm 2 それぞれ。 In濃度の増加に対する光電流の増強は、J sc を介して実証されました。 比較。さらに、Krogstrup etal。ナノロッド太陽電池の集光特性が光吸収を高め、高い光電流を提供できることを示しています[64]。開回路電圧(V oc )とサンプルCの曲線因子(FF)は、それぞれ0.28 Vと30%です。いくつかのグループは、V oc が低いナノロッド構造も示しました。 [72、75、76]。実際に照らされた領域、有効領域PCE、PCE eff での実際の光起電力性能を解明するために 、グリッド電極面積を除いた有効面積に基づいて効率を確立し、総面積PCE、PCE tot 、デバイス領域全体を考慮します。 PCE tot およびPCE eff 値は0.98%と1.27%であり、これはこれまでに報告された窒化物ナノロッド太陽電池のPCEが高いことを示しています。主な貢献は高いJ sc から来ています 、ただし、V oc 他のIII族窒化物ナノロッド太陽電池よりも低い[65,77]。 V oc が低い理由は2つ考えられます。 、バンド図に基づいてSiバンドギャップが1.12 eVであるp-n Si接合で制限された準フェルミ準位を含み、表面フェルミ準位のピン止めによって制限された電流経路が作成される可能性があります[66]。表1は、J sc をまとめたものです。 、V oc 、3つのサンプルのFF、およびPCEの比較。
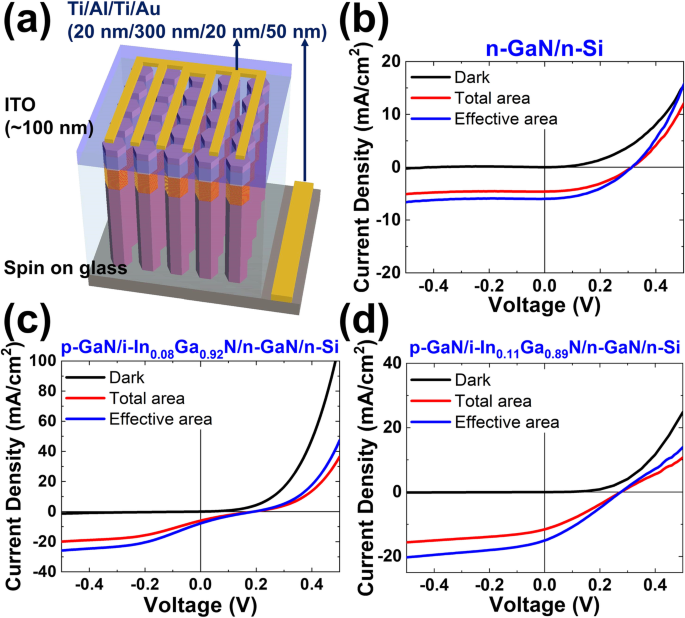
a ナノロッドは太陽電池の概略図を組み立てます。 b の電流密度-電圧曲線 n-GaN / n-Si、 c p-GaN / In 0.08 Ga 0.92 N / n-GaN / n-Si、および d p-GaN / In 0.11 Ga 0.89 N / n-GaN / n-Siナノロッドは、1太陽の下で測定された太陽電池、AM1.5Gソーラーシミュレーターを組み立てます
物理的および電気的特性を理解するために、バンド図は1D-DDCC(1次元ポアソン、ドリフト拡散、およびシュレディンガーソルバー)プログラムを使用して計算されます[78]。使用したITO、Si、およびGaNの電子親和力は、それぞれ4.40 eV、4.05 eV、および4.1eVです。図4aとbは、それぞれ電圧バイアスなしのITO / n-GaN / n-Siバンド図と暗所でのJ-V曲線を示しています。これは、ITO / n-GaN / n-Si構造には整流効果がなく、線形のJ-Vプロファイルを示していることを示しています。 SiとGaNの間の伝導バンドオフセットは50meVの小さな値であると予想されるため、キャリアが輸送するためのヘテロ界面のポテンシャル障壁は無視できます。この抵抗器のような線形J-V曲線は、実験結果と矛盾しています。

a ITO / n-GaN / n-Siバンド図、 b ITO / n-GaN / n-Si J-V曲線、 c ITO / n-GaN / p-Si / n-Siバンド図、および d 1D-DDCCプログラムによってシミュレートされたITO / n-GaN / p-Si / n-SiのJ-V曲線
J-V曲線の結果の考えられる説明は、Ga拡散がGaN / Si界面でp-Siを誘導し、p-n接合を生成することです。 Reichertz etal。 [14]およびNeplokh等。 [76]は、窒化物層の成長中のシリコン基板へのAlの拡散を検証しました。ホウ素、Al、およびGaは、p-Si層形成のドーパントとなるIIIB族元素です。ただし、Gaの拡散速度は700°Cで8 nm /日です[79]。図4cは、n-GaNとn-Siの界面の間に非常に薄い(1 nm)p-Si層を含むバンド図を示しています。小さなビルトイン電界がp-nSi接合に生成され、電子をn-Si基板に、正孔をITO接触層に駆動することができます。厚さに依存するJ-V曲線は、図4dでp-Si層の厚さが薄くなると、ダイオードのターンオン電圧が低下することを示しています。極薄のp-Siは、擬フェルミ準位分離の制限となり、V oc を低下させます。 太陽の性能の。 p-Si層を含むシミュレーション電気特性は、この研究結果に近いものです。したがって、Mg:GaN / InGaN / Si:GaN / p-Si / n-Si構造のバンド図は、図5のようにモデルとして構築できます。AM1.5Gの光を上から照射すると、 InGaNバンドギャップよりも高いエネルギーを持つ光子。光がロッドおよびロッド間の隙間を介してSiに照射されると、Siバンドギャップよりも大きなエネルギーの光子もp-n Si基板に吸収され、光電流が生成されます。同時に、短波長光によって窒化物領域に生成された電子正孔対は、p-i-n接合のビルトイン電界によって分離されます。最終的に、光生成されたキャリアは、Mg:GaNへの上部インジウムスズ酸化物(ITO)接点と下部Sin接点を介して収集できます。この構造モデルに基づいて、ITO接触によって導入されたショットキー障壁を考慮して、J-V曲線シミュレーションを図5bに示します。シミュレートされたJ-V曲線は、S字型がp接点の非オーミック挙動によって引き起こされることを示しています。これが、図3cおよびdのMg:GaN / u-InGaN / Si:GaN(サンプルBおよびC)に存在するS字型を説明するための考えられる理由です。したがって、負バイアスでの電流密度(J 負バイアス(-0.5 V) )S字型が平坦化されている場所を表S2に示します。 J 負のバイアス さらなる最適化と目標値のチェックポイントになる可能性があります。
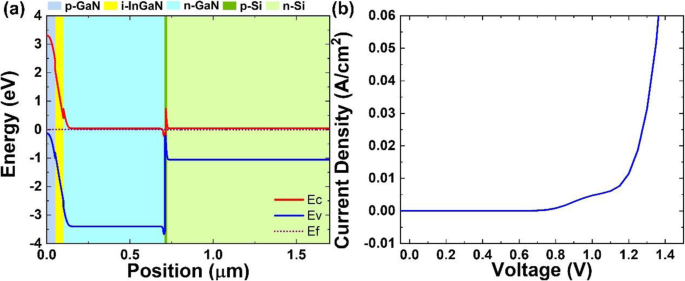
a 1D-DDCCプログラムによってシミュレートされたp-nSi太陽電池バンド図上のp-i-n窒化物ナノロッド。 b p-nSi太陽電池上のp-i-n窒化物ナノロッドのJ-V曲線シミュレーション
光バイアスなしのEQE測定結果(追加の非変調光)を図6aに示します。これは、Si:GaN / n:Si(サンプルA)、Mg:GaN / u-In 0.08 > Ga 0.92 N / Si:GaN(サンプルB)、およびMg:GaN / u-In 0.11 Ga 0.89 N / Si:GaN(サンプルC)。サンプルCのIn濃度は高く、InGaN層での吸収により短波長での値が高くなる原因となる可能性があります。サンプルA、B、およびCの最大EQEは、それぞれ32%、55%、および63%です。図6bに示すSiウェーハ、サンプルA、B、Cの反射スペクトルと比較すると、EQEの振動と反射スペクトルは、異なる層からの干渉によるものです。裸のSiウェーハは、その平坦な表面のために最も高い反射率を持っています。ナノロッド構造には光トラップ効果があるため、サンプルA、B、およびCの反射率は低くなります。サンプルCは、光トラップ効果が最も高いため、長波長で最高のEQEと最低の反射率を持っていることがわかります。この結果は、サンプルCで生成されたより高い光電流を説明することができます。サンプルBとサンプルCの室温(RT、300 K)フォトルミネッセンス(PL)スペクトルを図6cに示します。 3.40 eVにある最高ピークは、GaNニアバンドエッジ(NBE)発光です。 3.09eVと3.03eVにあるピークは、In 0.08 によるものです。 Ga 0.92 NおよびIn 0.11 Ga 0.89 NNBEエミッション。結果は、RTでの3.1eVおよび3.0eVのボーイング方程式計算の値と同様です[4]。また、EQEおよび反射スペクトルと同じ強力なファブリペロー振動(星印でマーク)を示し、各層/表面間の滑らかな界面を表しています。

a 3つの窒化物ナノロッド/ Siサンプルの外部量子効率スペクトル。 b 裸のSiウェーハと3つの窒化物ナノロッド/ Siサンプルの反射スペクトル。 c 2つのInGaNサンプルの室温フォトルミネッセンススペクトル
結論
プラズマ支援分子線エピタキシーによってn-Si上に成長させた高品質のMg:GaN / InGaN / Si:GaNおよびSi:GaNナノロッドの実証に成功しました。太陽光発電測定はPCE eff を示します 1.27%とPCE tot 1日で0.98%、Mg:GaN / u-In 0.11 のAM1.5G照明 Ga 0.89 N / Si:GaNは、In濃度が高く、光トラップ効果が高く、高い光電流を誘導します。 n-Siデバイス上のSi:GaNナノロッドには、顕著なp-n接合ビルトインフィールドがない場合がありますが、適切なヘテロ接合構造の設計は、光キャリアを上下の接点に駆動し、セルの性能を向上させるのに役立ちます。
データと資料の可用性
著者は、資料とデータが読者に利用可能であることを宣言し、この原稿で行われたすべての結論は、この論文で提示および示されているすべてのデータに基づいています。
略語
- LED:
-
発光ダイオード
- PCE:
-
電力変換効率
- J sc :
-
短絡電流密度
- PA-MBE:
-
プラズマ支援分子線エピタキシー
- HR-XRD:
-
高解像度X線回折
- HR-TEM:
-
高分解能透過型電子顕微鏡
- EQE:
-
外部量子効率
- BEP:
-
ビーム当量
- MME:
-
金属変調エピタキシー
- ITO:
-
インジウムスズ酸化物
- V oc :
-
開回路電圧
- RT:
-
室温
- PL:
-
フォトルミネッセンス
- NBE:
-
バンドエッジ付近
ナノマテリアル



