従来のスパッタリングによってサファイア上に成長させたMnSi薄膜のスキルミオン相
要約
トポロジー的に保護されたキラルスキルミオンは、基礎研究と将来のスピントロニクスアプリケーションのために多くの注目を集めている興味深いスピンテクスチャです。非中心対称構造のMnSiは、スキルミオン相をホストするよく知られた材料です。これまで、超高真空チャンバーを備えた特殊な機器を用いて、MnSi結晶の作製を検討してきました。ここでは、従来のマグネトロンスパッタリングの比較的低真空環境を使用して、サファイア基板上にMnSi膜を成長させる簡単な方法を紹介します。成長したままのMnSi膜は多結晶性を持っていますが、ホール抵抗率の寄与の現象論的スケーリング分析を含む磁気輸送特性を介して、広範囲の温度と磁場で安定したスキルミオン相が観察されます。私たちの調査結果は、スキルミオン相を持つ材料を準備する一般的な方法だけでなく、探究心の自由度を高めるためのさらなる研究への洞察も提供します。
はじめに
トポロジー的に保護されたキラルスキルミオンは、渦のような自明でない渦巻くスピンテクスチャを持ち、Dzyaloshinskii-Moriya相互作用(DMI)によって安定化された磁気スピンが球を取り巻く非共線的に整列します[1]。大きなDMIは、反転対称性が壊れているため、一般に非中心対称強磁性体で誘導されます[2]。この複雑なスピンテクスチャは、基礎研究と将来の技術での可能な応用の両方の興味深い物理的特性のために大きな注目を集めています[3、4]。磁壁と比較して、スキルミオン磁壁は非常に低い電流密度で安定した電流駆動運動を示し、低消費電力のスピントロニクスデバイスを可能にします[5]。
非中心対称B20相を持つMnSiは、スキルミオン格子をホストする典型的なヘリ磁性材料であり、理論的および実験的に数十年にわたって研究されてきました6,7,8,9,10]。 MnSiのスキルミオン格子では、スピン移動トルク(STT)が観測され、スピン偏極電流の注入に関するさらなる調査につながります[5]。特に、MnSiのスキルミオンサイズは〜18 nmの範囲であり、スキルミオンスピンテクスチャを持つ有名なグループの中で小さいと考えられています[11]。 STTは、スキルミオンのサイズを小さくすると大幅に増加する傾向があります[12、13]。材料パラメータはスキルミオンのサイズに影響を与えますが、DMIと強磁性交換相互作用は主にスキルミオンのサイズの決定に寄与します[14]。この点で、MnSiは応用物理学の優れた候補として優れた展望を持っています。
明らかなスカイミリオンを確認するために、ローレンツ透過型電子顕微鏡法、磁気透過型軟X線顕微鏡法、磁力顕微鏡法、および小角中性子散乱などのさまざまな測定ツールが使用されています15,16,17,18]。このような微視的なツールを使用すると、実空間でスキルミオン格子を直接識別できますが、高真空チャンバーを備えた特殊な機器で成長させる高品質の単結晶またはエピタキシャル薄膜が必要です。スキルミオンの存在を明らかにするもう1つの方法は、以前のレポート[9、9、19、20、21]に示されているように、磁気輸送特性とトポロジカルホール効果(THE)を測定することです。スキルミオンは、トポロジカル相が不純物や結晶性の影響を受けにくいトポロジカルオブジェクトであるため、多結晶サンプルでも観察できます[22]。
ここでは、従来のスパッタリングによって成長した多結晶MnSiの磁気輸送特性を報告します。 X線回折(XRD)と透過型電子顕微鏡(TEM)を使用して、MnSi結晶の単相とその結晶化度を特定しました。約25Kでの磁気転移は、温度に依存する磁化と抵抗の曲線を測定することで明らかになりました。磁気抵抗データも、転移温度の境界で識別可能な形状を示しました。測定されたホール抵抗からTHE信号を抽出し、温度と磁場の関数として地形ホール抵抗の輪郭マッピングをプロットすることに成功しました。さらに、MnSi膜の異常なホール抵抗率の寄与の分析は、多結晶MnSiサンプルの不純物と欠陥にもかかわらず、より広い範囲の温度と磁場でスキルミオン相の安定化を意味しました。私たちの調査結果は、スキルミオンが簡単で安価な機器によって成長した多結晶MnSi膜で観察できることを示しており、スキルミオン格子を有する同様の材料のさらなる調査を刺激することができます。
メソッド
MnSi膜はSi(001)と c に堆積されました -カットサファイア(Al 2 O 3 )1.0×10 –6 のベース圧力での直流(DC)/無線周波数(RF)マグネトロンスパッタリングによる基板 トル。 MnSi膜は、MnとSiのターゲットを5分間同時スパッタリングすることにより、10 mTorrのAr圧力下で室温で成長させました。 MnターゲットのDC電力は10〜20 W、SiターゲットのRF電力は100 Wでした。MnSiの堆積後、成長したままのMnSiは、その場で2時間のアニーリング処理を行うことによって結晶化されました。 550〜590°Cの温度範囲。サンプルの結晶相と構造は、60kVのMoおよびAgのX線源を使用したXRDによって調べられました。サンプルの形態学的特徴と化学組成は、走査型電子顕微鏡(SEM)、原子力顕微鏡(AFM)、およびエネルギー分散型分光法(EDS)を備えた高分解能透過型電子顕微鏡(HR-TEM)によって分析されました。磁気特性と電気特性は、超伝導量子干渉デバイス振動試料型磁力計(SQUID-VSM)を使用して測定されました。ここでは、磁場と温度がそれぞれ最大50kOeと2Kまで掃引されました。
結果と考察
MnSi膜の成長は、さまざまな方法で以前のレポートで詳しく説明されています[2、9、2、9、21、22、23、24、25]。しかし、MnSiを成長させるためのほとんどの技術は、超高真空環境を備えた特定の設備を必要としますが、比較的低いベース圧力での従来のマグネトロンスパッタリングの開発はまだ導入されていません。 Si(001)基板と立方晶MnSi構造の間の格子不整合は約19%と推定されるため、Si(001)基板上のMnSi膜の最適な成長条件をテストしました。 MnおよびSiターゲットを使用した同時スパッタリング法を採用し、RF電力、成長温度、アニーリング処理などの成長条件を細かく制御して、MnSi膜を成長させました(追加ファイル1:表S1)。 Aguf et al 。 堆積したままのMnSi膜は、アニーリング処理によって結晶化しない限りアモルファスであると報告されています[23]。実際、最初に堆積したアモルファスMnSiは、アニーリング処理後に結晶化したMnSi相に変化することがわかりました(追加ファイル1:図S1)。ただし、Si(001)基板を使用したほとんどの結果は、MnSiとMn 5 の混合相を示しています。 Si 3 XRD測定によって観察されました。このため、Si(001)基板はAl 2 に置き換えられました。 O 3 格子不整合が低い(〜4.2%)基板。
図1は、Si(黒い実線)とAl 2 上に成長したMnSi膜のXRDパターンを示しています。 O 3 (青と赤の実線)基板、ここでSi(001)とAl 2 上のMnSi膜 O 3 #1は、同じ成長条件(Mnの場合は15 Wの電力、Siの場合は100 Wの電力、590°Cのアニーリング処理)で堆積されました。かすめ入射X線回折技術が使用されたため、すべてのサンプルで基板のピークが表示されなかったことに注意してください。図のアスタリスクは、Mn 5 を示しています。 Si 3 (ICSDカード番号04–003-4114)フェーズ。 Si(001)上のMnSi膜では、主にMnSiのピークが観察されました。さらに、Mn 5 と一致する5つのピーク Si 3 相といくつかの未知の不純物ピークが検出されました。ただし、Mn 5 に関連するピークが見つかりました Si 3 相が抑制され、Al 2 上のMnSiの未知のピークが消失しました。 O 3 #1。さらに、Al 2 上のMnSi O 3 Mnパワーとアニーリング温度がそれぞれ10Wと550°Cに低下した#2サンプルでは、MnSi(ICSDカード番号04–004-7568)のピークのみが示されました。
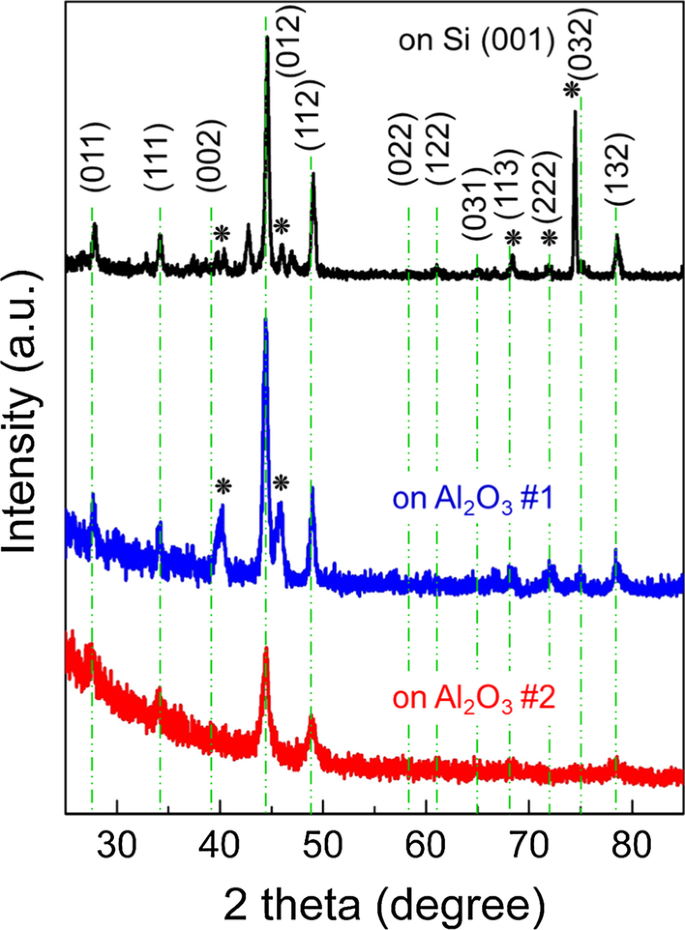
Si [(001)、黒い実線]およびAl 2 上のMnSi膜のXRDパターン O 3 (青と赤の実線)基板。すべてのピークは、緑色の点線でマークされた立方体のB20タイプのMnSi相にインデックス付けされています。黒と青の実線のアスタリスクは、Mn 5 からのピークを示します。 Si 3 フェーズ
Al 2 で成長したままのMnSi O 3 #2は、図2aのSEM画像と図2bのAFM地形画像に示されているように、やや欠陥のある表面を示し、非常に均一で凹凸の少ない表面が観察されました。 AFM画像の15×15μmスケールで、二乗平均平方根(RMS)粗さが1nm未満であると測定されました。詳細な構造と化学組成を特徴づけるために、Al 2 上で成長したままのMnSiの断面TEM分析 O 3 #2が実施されました。図2cは、Al 2 上のMnSiの代表的な断面TEM画像を示しています。 O 3 界面領域で第2位。スタッキング障害や重大な欠陥は観察されなかったことに注意してください。比較的低真空チャンバー内で従来のスパッタリングによりMnSi膜を成長させる場合、格子不整合や化学結合などの構造パラメータを考慮すると、MnSiが基板表面の優先方向にエピタキシャル成長することは期待できません。 Al 2 で成長したMnSi膜 O 3 XRDパターン(図1)とTEM画像の高速フーリエ変換(FFT)[図2cの挿入図]によって確認されるように、多結晶性を持っています。成長したままのMnSi膜の化学組成を調べた。図2dのTEM-EDSマッピングに見られるように、MnおよびSi元素のみの存在がいくつかの異なる領域で検出され、Mn / Si =1:1.1の原子比が推定されました。成長時間を制御することにより、MnSi膜の成長速度をテストしました。成長したままのMnSi膜の厚さは、成長時間に対して線形の振る舞いを示しました(追加ファイル1:図S2)。

Al 2 上に成長したMnSi膜の形態的および構造的特性評価 O 3 基板。 a 成長したままのMnSi膜のSEM画像。 b a に対応するAFM地形画像 。 RMS粗さは1nm未満と推定されます。 c サファイア上に成長させたMnSi膜の代表的なHR-TEM画像。挿入図:HR-TEM画像のMnSiの選択された領域からのFFT。 d 断面MnSi膜のEDSの元素マッピング
図3aは、Al 2 に対するMnSiの磁化の温度依存性を示しています。 O 3 (厚さ25 nm)1kOeの面外磁場で測定。 25 Kを超える温度で磁化が大幅に低下し、強磁性転移温度( T )を示しています。 C )、バルクMnSi [26、27]と同様。温度に依存する抵抗率は、 T を超えると金属的挙動を示しました。 C 、図3bに示すように。 T の下 C 、抵抗率は T とともに減少する傾向がありました 2 電荷キャリアがヘリマグネティック相のスピン変動に結合するため、温度が低下するにつれて依存性が高まります[28]。図3bの挿入図に見られるように、抵抗率と温度の導関数は T を強調しています。 C 約25KでのMnSi膜の成長。表面の多結晶と欠陥により、残留抵抗率が低くなります。つまり、[ρ (300 K)/ ρ (5 K)] 〜1.7。

a 1kOeの外部磁場における25nm厚のMnSi膜の温度の関数としての磁場冷却磁化。 b 温度の関数としてのゼロフィールド縦方向抵抗。挿入図:磁気遷移の異常を強調する温度の関数としての抵抗の導関数。 c 2、25、および50 Kでの垂直磁気抵抗。わかりやすくするために、任意のオフセットが追加され、50Kで測定された磁気抵抗は10倍に拡大されています
図3cは、2 K、25 K、50 Kのさまざまな温度での、フィルム面に垂直な磁場の磁気抵抗を示しています。前述のように、成長したままのMnSiフィルムは多結晶性を持っていたため、磁気抵抗ははっきりと観察されませんでした。しかし、低磁場では、磁気抵抗の温度依存性が際立った特徴を示しました。温度が上昇すると、ゼロ磁場付近の磁気抵抗の形状がフラット(2 K)からシャープ(25 K)およびブロード(50 K)のピークに変化しました。
スピンキラリティー駆動のホール効果に関しては、THEは強いスピン軌道相互作用と非中心対称B20結晶構造[29]から生じるDMIによって誘発される可能性があり、これはスキルミオン相の存在の特徴と考えられています。 THEに関連する異常抵抗率を観測するためにホール抵抗率測定を行いました。ホールの総抵抗率は、次の3つの要素の組み合わせとして表すことができます。
$$ \ begin {aligned} \ rho _ {{{\ text {Hall}}}}&=\ rho _ {{{\ text {normal}}}} + \ rho _ {{{\ text {AHE}}}} + \ rho _ {{{\ text {THE}}}} \\&=R_ {0} H + \ left({\ alpha \ rho_ {xx0} + \ beta \ rho_ {xx0} ^ {2} + b \ rho_ {xx} ^ {2}} \ right)M + n _ {{{\ text {Skx}}}} PR _ {{{\ text {TH}}}} B _ {{{\ text {eff}}}}、 \\ \ end {aligned} $$ここで、ρ 通常 、ρ AHE 、およびρ THE それぞれ、正常、異常、およびトポロジカルホール抵抗率です。 R 0 は通常のホール係数であり、α 、β 、および b は、スキュー散乱、サイドジャンプ、および異常なホール抵抗率への固有の寄与に対応する定数です。さらに、 n Skx は相対的なスキルミオン密度、 P は伝導電子の分極、 R TH はトポロジカルホール係数であり、 B eff は、実空間のベリー位相から得られる有効磁場です[20、30]。トポロジカルなホールの寄与は、測定された総ホール抵抗率から正常および異常なホール抵抗率の項を差し引くことによって抽出できます。
図4aは、10 KでのTHE信号を青い曲線として抽出するためのデコンボリューションされたホールデータを示しています。これには、正常な(緑の線)および異常な(赤い曲線)ホール抵抗率が含まれます。 ρの正の傾きに注意してください 通常 p を示します -タイプマジョリティキャリア、およびρ AHE は負であり、バルクMnSi [31]、薄膜[9]、およびナノワイヤ[20]のものと一致しています。 ρ 通常 高磁場での線形フィットから得られ、ρ AHE 磁化データから直接取得されます。 ρ THE 温度に応じて図4bに表示されます。興味深いことに、ρの記号 THE 磁気双極子遷移が予想された25Kの境界で反転しました。 ρの記号 THE 電荷キャリアのスピン偏極に非常に敏感です。 MnSiのバンド構造では、 d に局在する電子 バンドはフェルミ準位付近の状態密度に影響を与えますが、 s の巡回電子は バンドはバンド構造にわずかに寄与し[31]、スピン偏極を微妙にすることができます。さらに、スピン偏極は、引張ひずみや結晶純度などの外的要因によって温度によって変化する可能性があるため[9]、ρの符号が反転します。 THE 私たちの多結晶MnSiサンプルでは妥当です。図4cは、ρの等高線図を示しています。 THE 磁場と温度の関数として。バルクMnSiのスキルミオン相は、磁気転移温度に近い狭い温度範囲で観察されましたが、ゼロ以外のρ THE 符号に関係なく、2〜40Kで収集されました。 ρの絶対値 THE 10Kおよび4kOeで最大36nΩcmであり、MBE(10nΩcm)[9]、バルク(4.5nΩcm)[32]、およびナノワイヤー(15nΩcm)[32]によって成長した薄膜よりも大きい。 20]が、超高真空チャンバーを用いた軸外マグネトロンスパッタリングによって成長した薄膜のそれと類似している[25]。
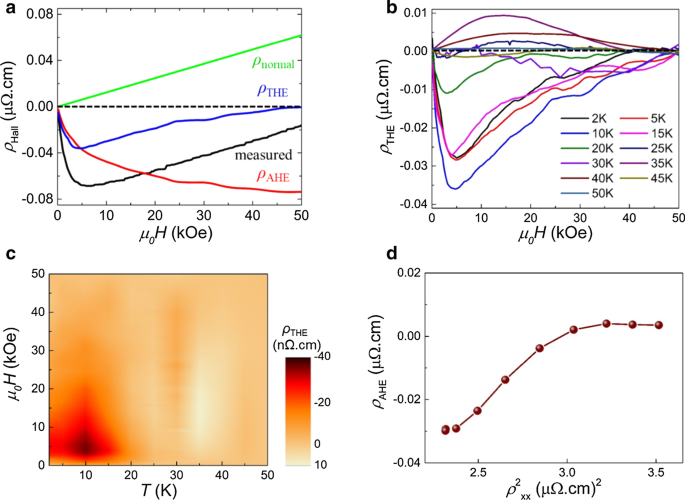
a 10 Kでの代表的なホール抵抗率曲線。THE信号(青い曲線)は、測定されたホール抵抗率(黒い曲線)の合計から正常(緑の線)と異常なホール信号(赤い曲線)を差し引くことによって抽出されます。 b 本文で詳述されているのと同じ手順を使用して抽出された、さまざまな温度でのトポロジカルホールの抵抗率。 c 磁場と温度の関数としてのTHE信号の等高線マッピング。温度間の地形ホール抵抗率の補間によって構築されます。 d トポロジカルホール抵抗率がゼロではない温度以下での縦方向の磁気抵抗率の2乗の関数としての異常ホール抵抗率
ρ AHE スキュー散乱、サイドジャンプ、および固有の寄与の3つのコンポーネントで構成されます。異常なホール寄与のスケーリングにおける含意は、ρであるということです。 AHE は、運動量空間のベリー位相に関連する固有の寄与\(\ rho_ {xx} ^ {2} \)に比例します[33]。図4dでは、ρをプロットしています。 AHE 20 kOeでの\(\ rho_ {xx} ^ {2} \)に対して、線形依存からの明らかな偏差を示しています。スケーリングの内訳は、異常なホール効果が、多結晶MnSiサンプルの不純物と欠陥によって引き起こされる外因性スキュー散乱とサイドジャンプの寄与に関連し、より広い範囲の温度と磁場でスキルミオン相の安定化を維持していることを示唆しています。
結論
要約すると、Al 2 上にMnSi膜を成長させる方法を示しました。 O 3 比較的低い真空チャンバーを用いた従来のマグネトロンスパッタリングによる。さまざまなナノ構造を製造するための簡単な方法を開発することが不可欠です[34、35]。分光学的および形態学的分析により、堆積されたままのMnSi膜は、非常に均一で低粗さの表面を備えた多結晶性を有することが確認された。磁気転移温度は以前の結果よりわずかに低かったが、輸送特性はMnSiの固有の特性を示している。さらに重要なことに、ホール抵抗率の寄与の複雑な影響に起因する、多結晶MnSi膜でも、広範囲の温度と磁場で安定したスキルミオン相が観察されます。この作業により、単結晶やエピタキシャル薄膜の作成の負担を超えて、スキルミオン相を有する材料を広範囲に調査する機会が開かれます。
データと資料の可用性
この調査中に生成または分析されたすべてのデータは、この公開された記事とその補足情報ファイルに含まれており、合理的な要求に応じて対応する著者から入手できます。
略語
- DMI:
-
DzyaloshinskiiとMoriyaの相互作用
- STT:
-
スピン伝達トルク
- THE:
-
トポロジカルホール効果
- XRD:
-
X線回折
- TEM:
-
透過型電子顕微鏡
- Al 2 O 3 :
-
サファイア
- DC:
-
直流
- RF:
-
無線周波数
- SEM:
-
走査型電子顕微鏡
- AFM:
-
原子間力顕微鏡
- HR-TEM:
-
高分解能透過型電子顕微鏡
- EDS:
-
エネルギー分散型分光法
- SQUID-VSM:
-
超伝導量子干渉デバイス-振動試料型磁力計
- RMS:
-
二乗平均平方根
- FFT:
-
高速フーリエ変換
- T C :
-
強磁性転移温度
ナノマテリアル
- AC相
- サファイア上に成長させたエピタキシャルn型ドープGaN層の赤外反射率分析
- 分子線エピタキシーによって成長したMoSe2のバンドギャップの温度依存性
- マイクロリットルスケールの溶液プロセスでコーティングされた銀ナノワイヤ薄膜を備えた大面積で高感度のSERS基板
- Ge(100)、(110)、および(111)基板上でのSrGe2薄膜の製造
- 原子間力顕微鏡によるポリスチレン薄膜の接着力とガラス転移の研究
- 微細構造の制御による有機-無機ペロブスカイトCH3NH3PbI3の薄膜のインピーダンス分析
- リチウムおよびナトリウムイオン電池の安定した性能の陰極としてのアモルファス酸化バナジウム薄膜
- c軸配向エピタキシャルBaドープBiCuSeO薄膜の熱電性能の向上
- 低温と高温の両方でのBi3.15Nd0.85Ti2.99Mn0.01O12薄膜の分極スイッチングと疲労に及ぼす配向の影響
- ホール移動度の高い非常に薄いアモルファスSnドープIn2O3膜のキャリア輸送を制限する要因に関する新しい洞察



