Si基板上での中赤外直接バンドギャップ放出のためのひずみ工学GeSn / GeSiSn量子ドットの設計
要約
Geマトリックス中のひずみ工学による自己組織化GeSn / GeSiSn量子ドットは、中赤外域での直接バンドギャップ放出に対する可能性を研究することを目的として、数値的に調査されています。 GeSn量子ドット(QD)の周囲媒体としてGeSiSn合金を使用すると、Siおよび/またはSnの組成を変化させることでQD周辺の歪みを調整できます。したがって、GeSn量子ドットとGeSiSn周囲層の間の格子不整合は、さまざまなドーム型QDサイズのSnバリア組成の変化により、-2.3〜-4.5%の間で調整されています。得られた結果は、特定のQD直接性基準を満たす発光波長を、3〜7μmの広い中赤外範囲で連続的に調整できることを示しています。これにより、センシングアプリケーション用のSiフォトニックシステムに完全に統合されたグループIVレーザー光源の新しい展望が開かれます。
背景
最近、Ge [1、2]およびSiGe [3、4]とスズの合金化による直接バンドギャップグループIV材料のデモンストレーションは、フォトニクスおよびエレクトロニクスの効率的なオンチップに向けた実際の実用的な機会により、集中的な研究活動を動機付けています。統合。実際、GeSn合金は、Lバレーと比較してΓの減少が速いため、特定の組成を超えて直接バンドギャップを示すことが示されています[5、6、7、8]。報告された結果は非常に有望ですが、材料特性とアプリケーションの可能性はまだ完全には調査されていません。実際、GeSnベースの半導体レーザーの動作波長をさまざまなガスの吸収線と重なる大気透過ウィンドウに向かって増加させるための実際に利用可能な主な経路[9]には、GeSn層のSn含有量の増加が含まれます[10、11 ]。ただし、GeとSnの間の格子不整合が大きいため(14%)、材料の結晶学的品質の維持がこの目標を妨げる主な課題として現れます[12、13]。発光波長を長くし、より良いキャリア閉じ込めを確実にするための潜在的に興味深い解決策は、ナノワイヤ[14、15、16]、ナノロッド[17]、量子ドット[18]などの低次元構造を中継します。特定の直接性基準の範囲内で、直接バンドギャップバンド間発光波長は理論的に4.3μmに制限されています[19]。これらの制限を克服するには、グループIVベースの量子構造の概念に追加の自由度を導入する必要があります。これは、GeSn量子ドット(QD)の周囲材料として三元GeSiSn層[20,21,22]を使用することで保証でき、適切なSiおよびSn組成を組み込むことでひずみ工学の可能性を提供します。 したがって、GeSn QDの周囲にGeSiSnひずみエンジニアリング層を使用すると、アクセス可能な直接バンドギャップ発光波長の範囲が広がることが期待されます。
これに関連して、直接バンドギャップバンド間発光波長でGeSnQDを囲むGeSiSn層のSn組成を変化させることによるひずみ工学の効果の理論的研究について報告します。
メソッド
二元および三元のSn含有IV族合金とGeの間のバンドオフセットは実験的に知られていないため、この作業に関与する異なるIV族半導体間の相対的なバンドアライメントを、Geの価電子帯端に関して評価します。 D'Costa et al。によって詳述されているように、Jarosのバンドオフセットの簡略化された理論[23]を使用します。 [24]。 Ge基板とGeSiSn層の間、およびGeSn QDと周囲のGeSiSn材料の間の格子不整合から生じるひずみ効果は、伝導帯と価電子帯のエッジについて評価されています。
実際、伝導帯の端は\(\ delta {E} _c ^ i \)だけシフトし、価電子帯の端はδEだけシフトします。 v 式に示すように。 (1)および(2):
$$ \ delta {E} _c ^ i ={a} _c ^ i \ left({\ varepsilon} _ {xx} + {\ varepsilon} _ {yy} + {\ varepsilon} _ {zz} \ right)$ $(1)$$ \ delta {E} _v ={a} _v \ left({\ varepsilon} _ {xx} + {\ varepsilon} _ {yy} + {\ varepsilon} _ {zz} \ right)+ b \ left({\ varepsilon} _ {xx}-{\ varepsilon} _ {zz} \ right)$$(2)ここで i LまたはΓの谷を示します。 a c および a v はそれぞれ伝導帯と価電子帯の変形ポテンシャルであり、 b はせん断変形ポテンシャルです。 \({\ varepsilon} _ {xx} ={\ varepsilon} _ {yy} =\ varepsilon =\ left(\ frac {a_s- {a} _ {\ mathrm {l}}} {a _ {\ mathrm {l }}} \ right)\)は計画内のひずみであり、\({\ varepsilon} _ {zz} =-2 \ frac {C_ {12}} {C_ {11}} {\ varepsilon} _ {xx} \)は成長方向のひずみです。 a s および a l それぞれ、基板と歪み層の格子定数です。 C 11 および C 12 は剛性定数です。
二元および三元合金の材料パラメータは、線形補間によってGe、Si、およびSnのパラメータから導出されます。これらのパラメータは、リファレンス[11]から取得されます。
組成に依存するひずみのあるバンドギャップは、対応するひずみによって生成されたエネルギーシフトを、式(1)で与えられるひずみのない材料のバンドギャップに追加することで評価できます。 (3)GeSnとEq。 (4)GeSiSnの場合:
$$ {E} _g ^ i \ left({\ mathrm {Ge}} _ {1- {X} _d} {\ mathrm {Sn}} _ {X_d} \ right)=\ left(1- {X} _d \ right){E} _g ^ i \ left(\ mathrm {Ge} \ right)+ {X} _d {E} _g ^ i \ left(\ mathrm {Sn} \ right)-{b} ^ i { X} _d \ left(1- {X} _d \ right)$$(3)$$ {\ displaystyle \ begin {array} {l} {E} _g ^ i \ left({\ mathrm {Ge}} _ {1- {x} _b-y} {\ mathrm {Si}} _ y {\ mathrm {Sn}} _ {x_b} \ right)=\ left(1- {x} _b-y \ right){E} _g ^ i \ left(\ mathrm {Ge} \ right)+ {x} _b {E} _g ^ i \ left(\ mathrm {Sn} \ right)+ {yE} _g ^ i \ left(\ mathrm {Si } \ right)-{b} _ {\ mathrm {Ge} \ mathrm {Sn}} ^ i {x} _b \ Big(1- {x} _b-\\ {} y \ Big)-{b} _ {\ mathrm {Si} \ mathrm {Sn}} ^ iy \ left(1- {x} _b-y \ right)-{b} _ {\ mathrm {Ge} \ mathrm {Si}} ^ i {x} _by \ end {array}} $$(4)ここで b は、表1に要約されている二元合金の対応するバンドギャップ湾曲パラメータです。
<図>キャリアの閉じ込められた状態を決定し、バンド間遷移エネルギーを推定するために、COMSOL Multiphysicsソフトウェアによって提供される有限要素法によってデカルト座標でシングルバンド有効質量シュレディンガー方程式が解かれました[25]:
$$-\ frac {{\ mathrm {\ hslash}} ^ 2} {2} \ nabla \ left(\ frac {1} {m ^ {\ ast} \ left(\ overrightarrow {r} \ right)} \ mathrm {\ nabla \ uppsi} \ left(\ overrightarrow {r} \ right)\ right)+ V \ left(\ overrightarrow {r} \ right)\ uppsi \ left(\ overrightarrow {r} \ right)=E \ uppsi \ left(\ overrightarrow {r} \ right)$$(5)E はキャリアのエネルギーを表し、ψは対応する波動関数です。 m * はキャリアの有効質量です。ћ は縮小プランク定数、\(\ overrightarrow {r} \)は3次元座標ベクトル、 V は、キャリアの閉じ込めの可能性(バンドの不連続性)です。 QD電子構造の計算手順を簡素化するために、ひずみ分布プロファイルの精度を明らかに高めることができる計算コストの高い原子シミュレーションアプローチの代わりに、定ひずみ近似[26、27]を採用しました[28、29]。実際、我々は、圧縮的に歪んだ量子ドット内のキャリア閉じ込めポテンシャルが、電子閉じ込め状態に対するひずみの不均一性の影響を最小限に抑えるのに十分な深さであると考えています[27]。さらに、バンドギャップの直接性を研究することを可能にするこの作業で最も重要なパラメータである伝導帯のエッジは、特に比較的低い格子不整合が考慮される場合、静水圧ひずみがひずみの不均一性にあまり敏感でないことによってのみシフトされます[30]。
結果と考察
主にGeSnQDの周囲のひずみの影響に関心があるため、QDのSn組成は28%に固定され、GeSiSnのSi組成は35%に固定されています。したがって、この研究は、Snバリア組成( x )の影響に焦点を当てています。 b )6〜22%の変動。 GeSiSn層またはGeSnQDのいずれかで得られた計画内ひずみを図1aに示します。
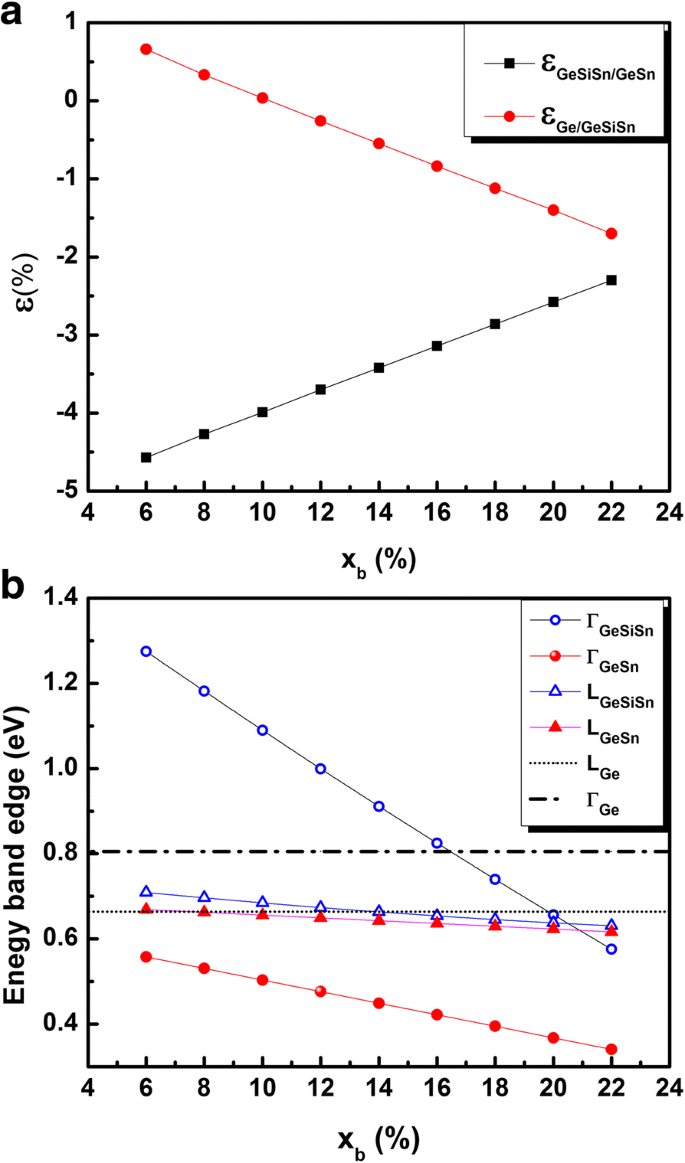
a Ge 0.65- xb 間の格子不一致 Si 0.35 Sn xb およびGe(黒丸)およびGe 0.72 の間 Sn 0.28 およびGe 0.65- xb Si 0.35 Sn xb (塗りつぶされた四角) x の関数として b 。 b Ge 0.65- xb のL谷とG谷のバンドエッジ Si 0.35 Sn xb 、Ge 0.72 Sn 0.28 、および x の関数としてのGe b
GeSiSn材料の2次元層の計画内ひずみは、0.6%( x )の間で変化します。 b =6%)および− 1.7%( x b =22%)。この層は疑似気象的に歪んだままであり、設計された構造を実験的に実現可能に保つことができると考えられます。 GeSnは、GeSiSn周囲の材料内で圧縮歪みが発生し、格子不整合が-2.3〜-4.5%の範囲であるため、自己組織化GeSnQDの形成に適した条件が保証されます。
図1bは、Ge 0.72 からのL点とΓ点での歪みバンドギャップの依存性を示しています。 Sn 0.28 およびGe (0.65- xb ) Si 0.35 Sn xb x の関数として b 。 Ge 0.72 のΓ谷 Sn 0.28 材料はL谷の下に残り、調査したスズバリア組成の全範囲でそのタイプIを証明しています。一方、電子の閉じ込めを考慮すると、有効バンドギャップが大きくなり、特に高ひずみのQDの場合、QDサイズの影響が決定的になります[18]。実際、量子閉じ込めが存在する場合、Γバンドの最小値ではなく、基底状態のエネルギーを考慮する必要があります。したがって、より小さいサイズのQDは、L谷(および/またはL谷の基底状態の電子エネルギー準位)を超える可能性がある、Γ谷のより高い閉じ込められたエネルギー準位を有すると予想される。したがって、特定の直接性基準に従ってQDサイズの範囲を調査することが重要です。
モデル化された構造を図2に模式的に示します。Ge 0.72 Sn 0.28 QDは、直径 D の円形の底面を持つドーム形状であると見なされます。 15〜40 nmの範囲で、高さと直径の比率は0.25に固定されています。 QDは、35%のSi組成と調整可能なSn組成を持つ15nmの厚さのGeSiSn層の内側に配置されます。この構造は、Geバッファ基板上に形成され、Ge層でキャップされていると考えられます。
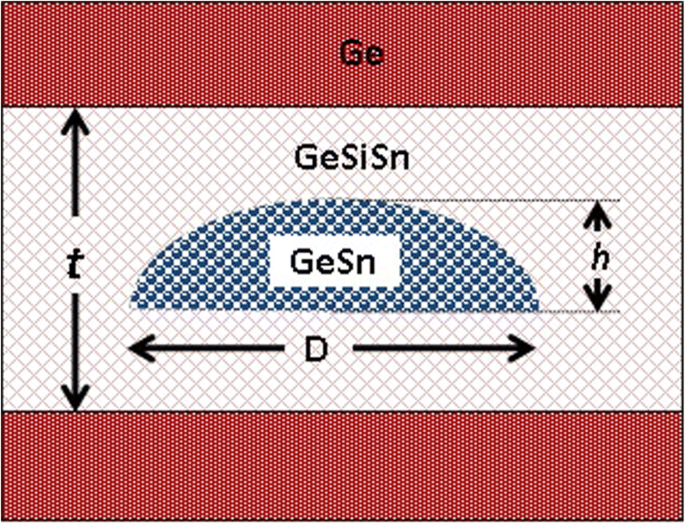
高さ( h )のモデル化されたGeSnQDの概略図 )と直径( D )GeマトリックスのGeSiSnひずみ低減層内
発光デバイスの動作を改善するための一貫したQD設計を保証するために、L谷とG谷の最低QD閉じ込めエネルギーレベル位置間のエネルギー間隔を考慮した適切な直接性パラメーターが導入されました[18]。このパラメータはGS L で表されます -GS Γ GS L の場合、熱活性化によるキャリアの損失を回避するために、室温の熱エネルギーよりも高くする必要があります。 (GS Γ )は、価電子帯の最大値に関するL谷(Γ谷)の電子基底状態のエネルギー準位を表します。 GS L の評価 -GS Γ 図3の挿入図に概略的に示されています。
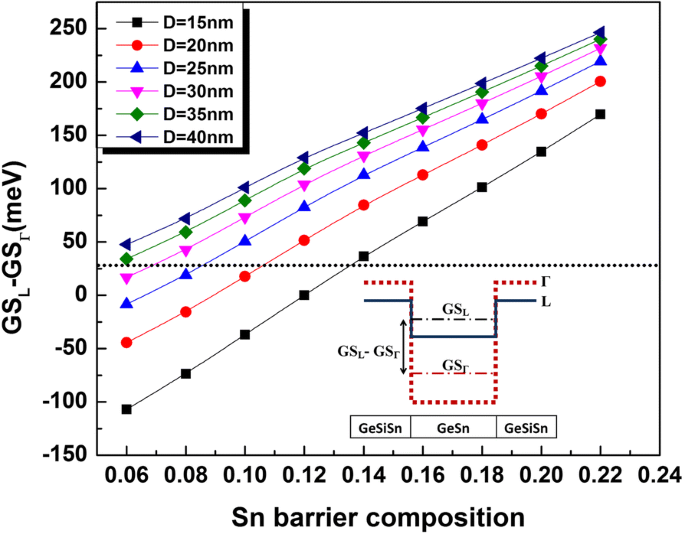
直接性パラメータ(GS L -GS Γ )Ge 0.72 の関数としての変動 Sn 0.28 Ge 0.65- x のQDサイズとSn組成 Si 0.35 Sn x 周囲の層。点線は室温での熱エネルギーを示しています。挿入図は、直接性パラメーターの概略定義を表しています
GeSiSnのSn組成の関数として、さまざまな直径のΓおよびL谷のGeSn QD電子エネルギーレベルを計算すると、対応する直接性パラメータ(GS L )を取得できます。 -GS Γ )。結果は図3にプロットされています。特定の x について b 、GS L の値 -GS Γ 主にQDサイズによって決まります。したがって、明らかに高い閉じ込めエネルギー状態を有する小さなドットは、直接性基準を満たすために、ひずみ低減によるより低いバンドギャップエネルギーを必要とする。図3に示すように、大きなドット( D > 25 nm)GS L を満たす -GS Γ> 26 meV for x b 8%以上。ただし、 x の値が高い場合は、小さいサイズのQDからの効率的な直接バンドギャップが保証されることがわかります。 b ( x b D の場合は≥14% =15 nm)。
この作業で採用されたパラメータ、特にバイナリ材料の湾曲パラメータ内で、GeSiSn材料のSn含有量の増加は、QDの周囲の汚れを減らし、周囲の材料のバンドギャップも減らします。実際、図1bに示すように、 x の増加 b 6%から22%にすると、Γ谷での伝導帯の不連続性が0.72eVから0.23eVに減少します。実際、図4に示すように、ここで、量子ドットの基底状態電子の二乗波動関数\({\ left | \ uppsi \ left(\ overrightarrow {r} \ right)\ right |} ^ 2 \)直径35nmは、6%と22%のSnバリア組成のxyプランに示されています。電子は、バリア組成(伝導帯の不連続性)に関係なく、QD内に完全に局在していることがわかります。強く閉じ込められた電子は、Si基板上の発光体の活性媒体として調査されたQDの信頼性が高いことを示しています。

直径35nmのGe 0.72 の二乗電子基底状態波動関数 Sn 0.28 a のQD Xb =6%および b Xb =22%
特定の x のQDサイズを制限する b 効率的な直接バンドギャップ放射を生成するものに対して、QD基底状態のバンド間放射波長を評価しました。結果を図5に示します。ここでは、発光波長が x に対してプロットされています。 b さまざまなQDサイズ用。この作業で考慮されている最大のQDサイズ( D )は注目に値します。 =40 nm)は、電子の基底状態と最初の励起状態(26 meV未満)の間に小さなエネルギー分離を示しているため、この研究では無視されています。それにもかかわらず、 x の関数として評価された発光波長 b 図5では点線で示されています。
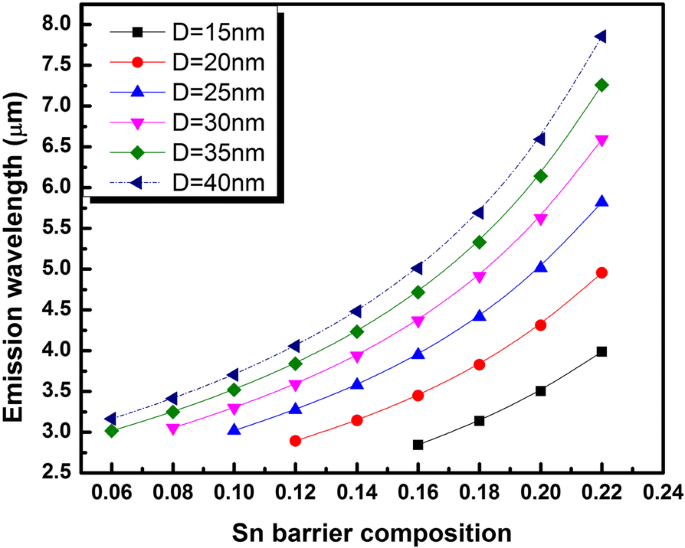
直接バンドギャップGe 0.72 からの室温基底状態発光波長 Sn 0.28 Ge 0.65- xb のサイズとSn組成の関数としてのQD Si 0.35 Sn xb 周囲のレイヤー
提案されたQD設計でカバーされると予測される波長範囲は、3〜7μmの範囲です。降伏範囲は、ガス検知アプリケーションにとって非常に重要です。この構造の実験的実装は、CMOS互換QDベースの中赤外オプトエレクトロニクスの新しい展望への道を開く既存のマイクロエレクトロニクス技術と完全に互換性のある材料で初めて中赤外範囲全体をカバーする機会を提供する可能性があります。
結論
Geマトリックス上のGeSiSnひずみ工学層のGeSnQDは、QDサイズと周囲の材料との格子不整合の関数として調査されました。 GeSiSnバリア材料のSn組成を変化させることにより、GeSn QDの周囲の歪みを低減すると、直接バンドギャップタイプIの発光波長が3〜7μmに向上することがわかります。設計された構造は、Siテクノロジーと完全に互換性のある中赤外発光体に新しい展望を開きます。
略語
- CMOS:
-
相補型金属酸化膜半導体
- GS L :
-
Lバレーの基底状態の電子準位
- GS Γ :
-
Γ谷の基底状態の電子準位
- QD:
-
量子ドット
ナノマテリアル
- Fe3 +の高感度測定のためのMXene量子ドットの蛍光を制御するN、N-ジメチルホルムアミド
- 電子増倍管の発光層の設計
- 再吸収抑制タイプII /タイプIZnSe / CdS / ZnSコア/シェル量子ドットの合成と免疫吸着アッセイへのそれらの応用
- 効果的な酵素模倣物としてのピリジニックリッチN、S共ドープ炭素量子ドットの合成
- アニーリングされたGaAsBi / AlAs量子井戸のビスマス量子ドット
- 変成InAs / InGaAs / GaAs量子ドットヘテロ構造の光起電力における双極効果:光感受性デバイスの特性評価と設計ソリューション
- 重金属を含まない発光ダイオードに適用するためのInP / ZnSコア/シェル量子ドットのグリーン合成
- 豆腐廃水から蛍光炭素量子ドットを合成するための簡単なアプローチ
- 水溶性硫化アンチモン量子ドットの合成とそれらの光電特性
- PCBを製造するための設計
- ダイレクト メタル レーザー焼結 3D プリントの設計のヒント



