InGaAs / InPコアシェルナノワイヤの自己シードMOCVD成長と劇的に増強されたフォトルミネッセンス
要約
有機金属化学蒸着(MOCVD)によるSi–(111)基板上のInGaAs / InPコアシェルナノワイヤの成長と特性評価について報告します。 InGaAsコアとInPシェル材料の間の大きな格子不整合によって引き起こされるコア-シェル界面のひずみは、InPシェルの成長挙動に強い影響を及ぼし、InGaAsコアの周りのInPシェルの非対称成長、さらにはナノワイヤーの曲げ。透過型電子顕微鏡(TEM)測定により、InPシェルがInGaAsコアとコヒーレントであり、転位がずれていないことがわかります。さらに、77 Kでのフォトルミネッセンス(PL)測定は、InGaAs / InPコアシェルナノワイヤからのPLピーク強度が、表面状態の不動態化と効果的なInPシェルのない唯一のInGaAsコアサンプルと比較して約100倍の増強を示すことを示していますInPシェル層に起因するキャリア閉じ込め。ここで得られた結果は、歪んだコアシェルヘテロ構造ナノワイヤの成長挙動の理解をさらに深め、Siプラットフォーム上のInGaAs / InPヘテロ構造ナノワイヤベースのオプトエレクトロニクスデバイスでのアプリケーションに新しい可能性を開く可能性があります。
背景
III-V半導体ナノワイヤは、その独自の電子的、光学的、および幾何学的特性により、次世代ナノスケールデバイスの有望な候補として認識されています[1,2,3,4]。 III-V半導体材料の中で、三元InGaAsナノワイヤは、制御可能な広い範囲の直接バンドギャップ、小さなキャリア有効質量、高いキャリア移動度などの優れた物理的特性により、フォトニクスおよびオプトエレクトロニクスアプリケーションに非常に魅力的です。さらに、III-V材料とSiプラットフォームの統合により、III-V材料の独自の物理的特性の利点と成熟した相補型金属酸化膜半導体(CMOS)技術の組み合わせが可能になります。フットプリントが小さいため、ナノワイヤは、材料間の格子定数の大きな違いを無視して、III-V材料をSiと統合する機会を提供します[5、6]。これまで、低電力高速トランジスタ[7、8]、トンネリングベースのデバイス[9、10]、発光ダイオード(LED)[11]など、三元InGaAsナノワイヤに基づくさまざまなデバイスがSi基板上に製造されてきました。 ]、フォトニックデバイス[12、13]、および太陽電池[14、15]。
しかし、一次元ナノワイヤの表面積対体積比が高いため、多数の表面状態が、高性能ナノワイヤベースのオプトエレクトロニクスデバイスを実現する上での主な制限となっています。一方では、これらの表面状態は、散乱と非放射再結合プロセスによって、III-V材料の電子的特性と光学的特性の両方を大幅に低下させる可能性があります[16、17、18、19、20]。一方、一部の狭いギャップの材料(InAs、In-rich InGaAsなど)のナノワイヤの場合、高密度の表面状態により、ナノワイヤ表面近くの電子バンド構造が曲がる可能性があります(表面フェルミ準位ピン止め効果)。 )。このような非フラットバンド構造は、電荷キャリアの再分布をさらに引き起こし、光ナノワイヤベースのデバイスの性能を大幅に妨げる可能性があります[21]。したがって、これらの表面状態を排除することが非常に必要です。 In組成の高い三元InGaAsナノワイヤの場合、材料システムがタイプIのバンドギャップ配列を形成し、キャリアをInGaAsに効果的に閉じ込めることができるため、InPは望ましい表面不動態化層です。さらに、平面構造で広く研究されているInGaAs / InP材料システムの場合、その発光波長は1.31〜1.55μmの範囲で調整可能であり、光ファイバー通信で有望です。
この作業では、有機金属化学蒸着(MOCVD)を使用して、Si–(111)基板上にInGaAs / InPコアシェルナノワイヤの成長と特性評価を行いました。コアとシェル材料間の大きな格子不整合に起因するコア-シェル界面のひずみは、InPシェルの成長挙動に強い影響を与えることがわかります。コア材料とシェル材料の間の大きな格子不整合は、InGaAsコアナノワイヤの周りのInPコーティング層の不均一な核形成、さらにはナノワイヤの曲がりにつながる可能性があります。成長条件を最適化することにより、良好な形態のInGaAs / InPコアシェルナノワイヤを実現できます。さらに、77 Kでのフォトルミネッセンス(PL)測定は、InGaAs / InPコアシェルナノワイヤからのPLピーク強度が、表面状態の不動態化とInPコーティングによる効果的なキャリア閉じ込めにより、裸のInGaAsナノワイヤと比較して約100倍の増強を示すことを示しています。レイヤー。
メソッド/実験
Nanowire Growth
InGaAs / InPコアシェルナノワイヤは、密結合シャワーヘッドMOCVDシステム(AIXTRON Ltd.、ドイツ)によって133mbarで成長しました。トリメチルインジウム(TMIn)とトリメチルガリウム(TMGa)をグループIIIの前駆体として使用し、アルシン(AsH 3 )およびホスフィン(PH 3 )グループVの前駆体として使用されました。超高純度水素(H 2 )をキャリアガスとして使用し、H 2 の総流量 12slmでした。成長の前に、Si–(111)基板をアニーリングのために635°Cに加熱し、次にAsH 3 の下で400°Cに冷却しました。 (111)Bのような表面を形成するフラックス[22]。 InGaAsコアナノワイヤは565°Cで15分間成長させました。成長プロセス中、TMInおよびAsH 3 流量は0.8×10 − 6 です。 mol / minおよび1.0×10 − 4 モル/分、TMGaの流量は変化します。流量TMGa /(TMGa + TMIn)の比率として定義されるTMGa気相組成Xvは、30%から40%まで変化しました。 InPシェルは、TMInとPH 3 を使用して565°Cで10分間成長させました。 2×10 − 6 の流量 mol / minおよび8.0×10 − 4 それぞれmol / min。成長後、PH 3 を使用してサンプルを室温まで冷却しました。 保護剤として。
特性評価方法
ナノワイヤーの形態は、走査型電子顕微鏡(SEM)(Nova Nano SEM 650)によって特徴づけられ、透過型電子顕微鏡(TEM)(JEM2010F TEM; 200 kV)とX線エネルギー分散分光法(EDS)を組み合わせて使用されました。それぞれ、結晶構造と組成を調べます。 TEM観察では、ナノワイヤをサンプルからカーボンフィルムでコーティングされた銅グリッドに機械的に転写しました。成長したナノワイヤの光学特性を調査するために、励起源として532 nmの波長のレーザーを使用してフォトルミネッセンス(PL)測定を実行しました。サンプルは、直径約150μmのスポットサイズで約100mWのレーザー出力で励起されました。 PL信号は、フーリエ変換赤外(FTIR)分光計に直接供給され、液体窒素で冷却されたInSb検出器によって記録されました。 FTIR分光計の可動ミラーは高速スキャンモードで動作し[23]、中赤外領域のInAsナノワイヤでのステップスキャン変調PL測定とは異なります[24]。
結果と考察
図1は、Si–(111)基板上でのInGaAs / InPコアシェルナノワイヤの成長と、ナノワイヤの成長のためのソース-供給シーケンスの概略図を示しています。 InGaAsナノワイヤは自己触媒メカニズムによって成長します[25]。 In液滴はAsH 3 の下で消費されることに注意してください 大気(図1の領域3に示されています)。 InPシェルの異常成長は、AsH 3 を切り替えることによって開始されました。 PH 3 へ フラックスとTMInフラックスを同時に開く。
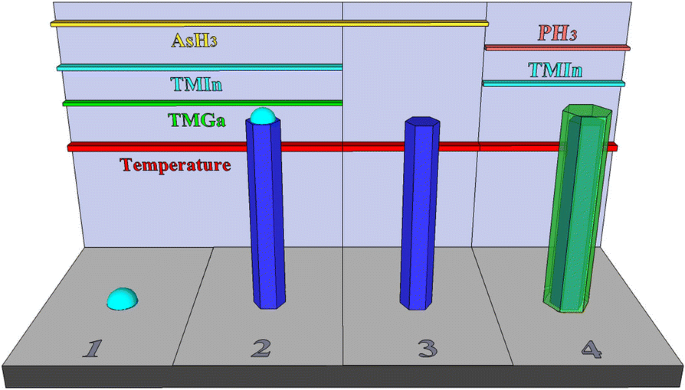
InGaAs / InPコアシェルナノワイヤの成長とナノワイヤ成長のソース-供給シーケンスの概略図
図2a、bは、それぞれXv =30%の裸のInGaAsおよびInGaAs / InPコアシェルナノワイヤの典型的なSEM画像を示しています。すべてのInGaAsナノワイヤは、全長に沿って均一な直径でSi基板上に垂直に整列しています。その後のInPシェルの成長後も、ナノワイヤは滑らかなサイドファセットを備えており、成長パラメータの最適化を示しています。裸のInGaAsおよびInGaAs / InPコアシェルナノワイヤの直径の統計的分布から、ナノワイヤの平均直径は、InPシェルの成長後に約65nmから約95nmに増加します。これは、約15の平均InPシェル厚さを示しています。 nm。ただし、図2bのInGaAs / InPコアシェルナノワイヤは目に見えて曲がっています。これは、コアとシェルの材料間の大きな格子不整合によるInPシェルによって引き起こされるInGaAsコアナノワイヤへの応力によって引き起こされます。図2c、dは、Xvがそれぞれ35%と40%のInGaAs / InPコアシェルナノワイヤのSEM画像を示しています。図2bのナノワイヤと比較して、Xvが35%のInGaAs / InPコアシェルナノワイヤの曲げは大幅に減少しました(図2c)。 Xvをさらに40%に増やすと、ナノワイヤは目に見える曲がりがなく真っ直ぐになります(図2d)。この現象は、Ga組成の増加に伴うInGaAsコアとInPシェル材料間の格子不整合の減少に起因する可能性があります。さらに、InGaAs / InPコアシェルナノワイヤの直径の統計的分布から、Ga組成が増加すると、同時にナノワイヤの直径も増加します。これは、InGaAsコアナノワイヤがInPコーティング後に曲がるのを妨げる可能性もあります。

a b のInGaAsナノワイヤ、およびXvを備えたInGaAs / InPコアシェルナノワイヤの30°傾斜SEM画像 30%、 c 35%、および d 40%
成長させたナノワイヤの結晶構造を調査し、InPシェルを成長させた後のコアシェル構造の存在を確認するために、詳細なTEM測定を実施しました。図3aに示すように、Xvが35%のInGaAsナノワイヤの結晶構造は、ウルツ鉱(WZ)と閃亜鉛鉱(ZB)のポリタイプ構造で構成されており、その成長に沿って多数の積層欠陥(SF)があります。方向、および構造欠陥とともにWZおよびZB構造が共存するため、対応する選択領域電子回折(SAED)スポットが分割され、成長方向に沿ってわずかに伸長します(図3aの挿入図)。これらの平面欠陥は、MOCVDによる外来触媒なしのInAsまたはInGaAsナノワイヤの成長で一般的に観察されます[26、27、28]。図3bは、Xvが35%の典型的なInGaAs / InPコアシェルナノワイヤの明視野(BF)低解像度TEM画像を示しています(図2cを参照)。 InPコーティング後も、ナノワイヤは先細りになることなく非常にまっすぐです。対応する高解像度(HR)TEM画像を図3cに示します。 InGaAsコアとInPシェルの間に明確な界面が見られます。さらに、コアシェル界面で{111}面をたどっても、ミスフィット転位は見つかりませんでした。したがって、成長したままのInPシェルはInGaAsコアとコヒーレントです。さらに、InPコーティング層のコヒーレントなエピタキシャル成長により、InPシェルの結晶構造はInGaAsコアナノワイヤの結晶構造を完全に継承します。これは、図のInGaAs / InPコアシェルナノワイヤの混合WZ / ZB構造によって確認されます。 。3c。この現象は、他の材料システムのコアシェルナノワイヤで観察されており[29、30、31]、この挙動は、自己触媒InGaAsナノワイヤの結晶品質を改善する必要性を浮き彫りにしています。
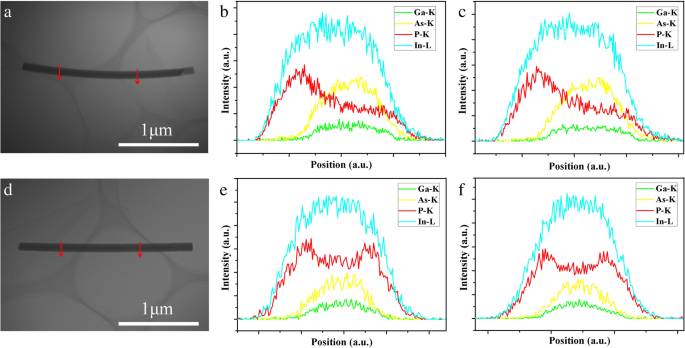
a <110>ゾーン軸から取得した裸のInGaAsナノワイヤ(Xv =35%)のHRTEM画像。挿入図は、対応する選択領域電子回折(SAED)パターンです。 b InGaAs / InPコアシェルナノワイヤの低倍率TEM画像(Xv =35%)。 c <110>ゾーン軸から見たナノワイヤのHRTEM画像。赤い破線は、コアとシェルの間のインターフェースを示しています
図4a–cは、図2bに示す典型的なInGaAs / InPコアシェルナノワイヤの低倍率TEM画像とEDS分析を示しています。ナノワイヤ全体のEDSラインスキャンによると、P信号はスペクトルで明らかに識別でき、InGaAsコアの周りにInPシェルが存在することを示しています。一方、P信号のEDSスペクトルは非対称であり、これは、InPシェルの過成長がInGaAsコアナノワイヤの周囲で不均一であることを意味します。この現象は主にコアとシェル材料間の比較的大きな格子不整合によって引き起こされる可能性があり、InPシェルのそのような不均一な核形成はさらにナノワイヤの曲がりをもたらすと推測されます。対照的に、図2cのストレートInGaAs / InP(Xv =35%)コアシェルナノワイヤの場合、図4e–fのEDS分析は、ナノワイヤ全体のP信号の対称的な分布を示し、周囲のInPシェルの均一性が向上していることを示しています。ここでGa含有量が増加したInGaAsコア。
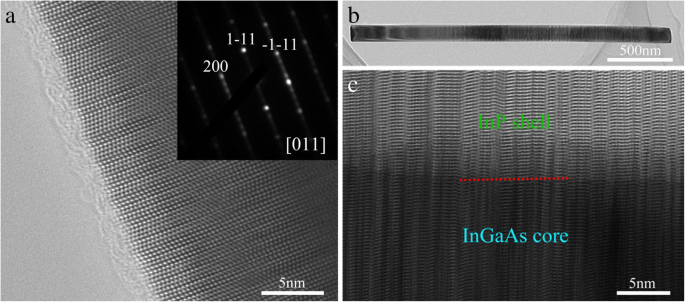
a InGaAs / InP(Xv =30%)コアシェルナノワイヤの低倍率TEM画像。 b 、 c EDSラインは、 a でマークされた2本の赤いラインに沿ってスキャンします 。 d InGaAs / InP(Xv =35%)コアシェルナノワイヤの低倍率TEM画像。 e 、 f EDSラインは、( d でマークされた2本の赤いラインに沿ってスキャンします )
成長したナノワイヤの光学特性を調査するために、フォトルミネッセンス(PL)測定を実行しました。図5は、77Kでの裸のInGaAsとInGaAs / InP(Xv =30%)コアシェルナノワイヤーの典型的なPLスペクトルを比較しています。裸のInGaAsナノワイヤーのPLスペクトルは、〜0.73 eVでピークに達するはるかに弱い発光を示しています(図5)一方、InGaAs / InPコアシェルナノワイヤのPLスペクトルは、約0.78 eVでピークに達する非常に強い発光を示し(図5の赤い線)、PLピーク強度は比較して約100倍の増強を示します。裸のInGaAsナノワイヤに。異なるサンプルからのナノワイヤ密度は同等であるため、InGaAs / InPコアシェルナノワイヤのこのような劇的なPL発光の向上は、InPコーティング層による表面状態とキャリア閉じ込めの効果的な抑制によって引き起こされると考えられます。
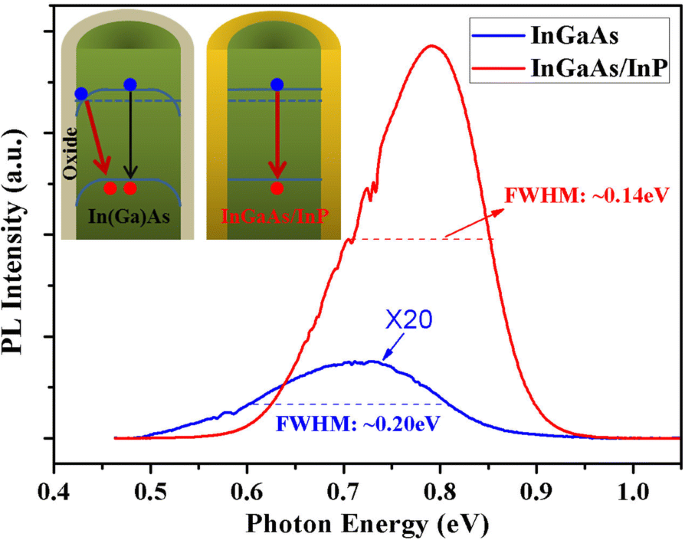
77Kでの裸のInGaAsおよびInGaAs / InP(Xv =30%)コアシェルナノワイヤのPLスペクトル。挿入図は、裸のInリッチInGaAsおよびInGaAs / InPコアシェルナノワイヤのバンド構造の概略図です。
もう1つの興味深い特徴は、裸のInGaAsナノワイヤと比較したInGaAs / InP PLピークのわずかな青方偏移(〜50meV)です。まず、この異なる動作は、InGaAsコアがInPシェルでコーティングされている場合の主要なキャリア再結合経路の変化に起因します。通常、自然酸化物で覆われた表面を持つ裸のInAsまたはIn-rich InGaAsナノワイヤの場合、表面のフェルミ準位は、ナノワイヤ表面の近くで下向きのバンドの曲がりを引き起こす多数の表面状態によって引き起こされる伝導帯に固定されます。次に、この非フラットバンド構造は、電子がナノワイヤ表面の近くに蓄積し、正孔がナノワイヤの中心に留まるキャリアの再分布につながります。照明下では、図5の挿入図に示すように、より低いエネルギーでの空間的に間接的な電子正孔対遷移が優先されます。裸のInAsナノワイヤの場合、近バンド端発光と表面関連のエネルギー差が報告されています。放出は約〜35–45meVです[21]。ただし、InGaAsナノワイヤの場合、Ga組成の増加に伴って表面バンドの曲がりが大幅に減少するため、このエネルギー差は同時に減少し、電子はナノワイヤ表面近くに閉じ込められなくなり、正孔はナノワイヤ中心に局在しなくなります。したがって、裸のInGaAsナノワイヤのPLスペクトルは、表面関連の発光とバンドエッジ付近の発光の混合であると考えられます。空間的に分離されているため、表面を介した遷移確率は非常に低くなります。さらに、多数の表面状態は、非放射再結合プロセスによって余分な電子正孔対を消費する可能性があります。したがって、裸のInGaAsナノワイヤのPL強度は非常に弱いです。
ただし、InGaAsコアナノワイヤがInPシェルでコーティングされている場合は状況が変わります。コアナノワイヤの表面状態が効果的に除去され、InPシェルがエネルギーバリアとして機能してキャリアをInGaAsナノワイヤに効果的に閉じ込めるため、PL発光の大幅な向上によって確認されるように、遷移確率の高いバンドエッジ付近の直接遷移が支配的になります。さらに、表面関連の発光が排除されているため、InGaAs / InPコアシェルナノワイヤのPLスペクトルは、裸のInGaAsナノワイヤと比較して半値全幅(FWHM)が狭くなっています。前述のように、ここで得られたInGaAsナノワイヤの表面バンドの曲がりが緩和されているため、バンド端付近の発光と表面関連の発光のエネルギー差は、ここで得られた〜50meVよりはるかに小さいはずです。したがって、この影響とは別に、観測された青方偏移の主な原因はひずみであると推測されます。 InPシェルは界面でのミスフィット転位のないInGaAsコア上でコヒーレントに成長したため、InGaAsコアは圧縮ひずみを受けており、InGaAsコアナノワイヤのバンドギャップの広がりを引き起こし、PLピーク発光の青方偏移を説明できます[ 32、33]。したがって、InPコーティング層を成長させることにより、InGaAsナノワイヤからのPLピークエネルギーは青方偏移を示し、そのPL発光強度を大幅に向上させることができます。
図6aは、77KでXvが異なるInGaAs / InPコアシェルナノワイヤの正規化されたPLスペクトルを示しています。PLピークエネルギーは、30〜40の範囲でXvが増加すると、連続的な青方偏移(〜0.78 eVから〜0.86 eV)を示します。 %。さらに、室温でのPL測定から、InGaAs / InPコアシェルナノワイヤの発光は、1.49〜1.68μmの波長範囲でピークに達します。これは、光ファイバ通信での電力減衰が最小です(〜1.55μm領域)。図6bは、Xv =40%のInGaAs / InPコアシェルナノワイヤサンプルの温度依存PLスペクトルを示しています。挿入図は、PLピークエネルギーの対応する温度依存シフトを示しています。通常、単結晶バルク材料では、発光の温度依存性は、Varshniの式に従って温度の上昇とともに連続的な赤方偏移を示します。興味深いことに、図6bの挿入図から、赤方偏移は60〜290Kの温度範囲でのみ観察できます。温度が60K未満の場合、PLピークエネルギーはほとんど変化しません。成長したナノワイヤの構造欠陥が高密度であることを考慮すると、この現象はバンドエッジ付近の局所的なトラップ状態が原因である可能性が高いと推測されます[34]。低温では、放出はトラップ支援によって支配されます。温度の上昇に伴い、トラップされたキャリアは低エネルギーのトラップ状態からバンドエッジに励起されます。したがって、低温領域でのPLピークエネルギーは、一般的に観察される温度による連続的な赤方偏移に従わず、正確なバンドエッジと比較して過小評価される傾向があります。
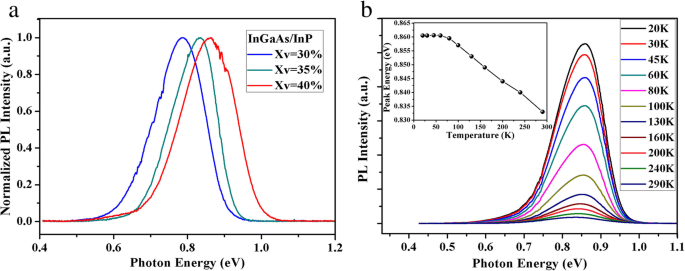
a 77Kでの異なるXv(Xv =30%、35%、および40%)のInGaAs / InPコアシェルナノワイヤの正規化されたPLスペクトル。 b Xv =40%のInGaAs / InPコアシェルナノワイヤの温度依存PLスペクトル。 b のはめ込み PLピークエネルギーの対応する温度依存シフトを示しています
結論
要約すると、MOCVDを使用したSi–(111)基板上のInGaAs / InPコアシェルナノワイヤの成長と特性評価を示しました。コアとシェル材料間の大きな格子不整合によって引き起こされるコア-シェル界面の応力は、InPシェルの成長挙動に強い影響を及ぼし、InGaAsコアの周りのInPシェルの非対称成長、さらにはナノワイヤー。 TEM測定により、InPシェルはInGaAsコア上でミスフィット転位なしにコヒーレントに成長していることが明らかになりました。 77 KでのPL測定から、InGaAs / InPコアシェルナノワイヤのPLピーク強度は、表面状態の不動態化とInPコーティング層による効果的なキャリア閉じ込めにより、裸のInGaAsナノワイヤと比較して約100倍の改善を示しています。 InPでキャップされたナノワイヤのこのような大幅な発光増強により、室温でも発光を観察することができます。全体として、ここで得られた結果は、歪んだコアシェルヘテロ構造ナノワイヤの成長挙動の理解をさらに深め、InGaAsナノワイヤに基づくオプトエレクトロニクスデバイスの製造の基礎を築く可能性があります。
略語
- BF:
-
明視野
- CMOS:
-
相補型金属酸化膜半導体
- EDS:
-
エネルギー分散型分光法
- FTIR:
-
フーリエ変換赤外
- FWHM:
-
半値全幅
- LED:
-
発光ダイオード
- MOCVD:
-
有機金属化学蒸着
- PL:
-
フォトルミネッセンス
- SAED:
-
選択領域電子回折
- SEM:
-
走査型電子顕微鏡
- TEM:
-
透過型電子顕微鏡
- TMGa:
-
トリメチルガリウム
- TMIn:
-
トリメチルインジウム
- ZB:
-
閃亜鉛鉱
ナノマテリアル
- 材料科学者はナノワイヤーに「踊る」方法を教えます
- ドラッグデリバリーを強化するためのナノファイバーとフィラメント
- Sb /パリゴルスキー石(PAL)ナノ粒子の調製と強化された接触水素化活性
- 有機金属化学蒸着によるInAsステム上での垂直GaSbナノワイヤの自己触媒成長
- 無電解エッチングで作製したシリコンナノワイヤの光学的および電気的特性
- 水溶性α-NaGdF4/β-NaYF4:Yb、Erコアシェルナノ粒子の合成と発光特性
- 最大の太陽エネルギー収穫のためのInPナノワイヤの効率的かつ効果的な設計
- 垂直に整列した単層カーボンナノチューブの成長に及ぼすアルミナ支持層の強化された熱安定性の効果とナノ濾過膜におけるそれらの応用
- 固体ソース2段階化学蒸着によって生成されたInGaAsナノワイヤの形成メカニズム
- 強化された光触媒評価と抗菌分析のためのZnOナノ粒子に対するMgドーピングの影響
- 5Gと指数関数的なデータ増加の課題



