固体ソース2段階化学蒸着によって生成されたInGaAsナノワイヤの形成メカニズム
要約
二段階固体化学蒸気堆積(CVD)法によって調製されたAu触媒InGaAsナノワイヤー(NW)の形態と微細構造を、走査型電子顕微鏡(SEM)と高分解能透過型電子顕微鏡(HRTEM)を使用して体系的に調査しました。詳細な構造特性と統計分析により、InGaAs NWでは、ジグザグ表面形態と滑らかな表面形態の2つの特定の形態が支配的であることが明らかになりました。ジグザグ形態は、双晶構造の周期的な存在に起因し、滑らかな形態は、双晶構造の欠如に起因します。 HRTEM画像とエネルギー分散型X線分光法(EDX)は、触媒ヘッドが2つの構造、Au 4 を持っていることを示しています。 InおよびAuIn 2 、立方相結晶形のInGaAsNWを生成します。 InGaAs NWの成長メカニズムは、Auナノ粒子が小さな球に溶けることから始まります。 In原子はAu球に拡散してAu-In合金を形成します。合金内部のInの濃度が飽和点に達すると、In析出物はGaおよびAs原子と反応して、触媒と基板の間の界面にInGaAsを形成します。 InGaAs化合物が形成されると、追加の沈殿と反応はInGaAsと触媒の界面でのみ発生します。これらの結果は、さまざまなデバイスアプリケーション向けの高品質のInGaAsNWの形成に不可欠なInGaAsNW成長プロセスの基本的な理解を提供します。
背景
ナノワイヤー、ナノチューブ、ナノロッドなどの1次元半導体ナノ材料は、その独自の特性と量子閉じ込め効果により注目を集めています[1,2,3,4,5,6,7,8,9,10,11、 12,13,14]。特に、ヒ化インジウム(InAs)ナノワイヤ(NW)は、その閉じ込め効果と高いキャリア移動度により、独自の磁気的および電気的特性を拡張するために使用されてきました。これにより、それらは広範囲(880〜3500 nm)のオプトエレクトロニクスデバイスアプリケーションおよび電界効果トランジスタ(FET)の潜在的な候補になります[15、16、17、18、19、20]。具体的には、3000〜10000 cm 2 の範囲で卓越した電子移動度を備えた単一のInAsNWFETです。 / Vsは広範囲に調査されています[15、18]。ただし、これらのデバイスは、元のInAs NWに基づいており、主に小さな電子バンドギャップ(0.34 eV)に起因する、大きなリーク電流と小さなオン/オフ電流比に常に悩まされています。大きなリーク電流と小さなオン/オフ電流比は、デバイスのスイッチング特性に影響を与え、NWFETの実際のアプリケーションで非常に重要です。
InAsと比較して、3項In x Ga 1 − x 調整可能な化学量論と同様に、0.34eV≤E g のバンドギャップ ≤1.42eVは、優れた代替デバイスチャネル材料であることが示されています。この置換により、高い電子移動度を大幅に犠牲にすることなく、リーク電流を大幅に減らすことができます[19、21、22、23、24]。以前の作品では、In x のコンポーネント間の関係 Ga 1 − x In x のNWおよび電気的特性として Ga 1 − x NWとして、FETは体系的に研究されてきました。 In濃度を下げると、オフ電流が約2桁減少し、オン/オフ電流比が約2桁向上しますが、移動度はわずかに低下します[21]。 NWの組成とは別に、双晶面やIII–V NWの積層欠陥などの結晶欠陥の数は、化学蒸着(CVD)法での不適切な成長パラメータに起因することがよくあります[19、25、26、27、 28]。これらの結晶欠陥は、幾何学的および電子的構造にも深刻な影響を及ぼします。たとえば、閃亜鉛鉱セグメントはキャリアをトラップし、それによって多型InPNWの電子輸送速度を低下させる可能性があります[28]。したがって、制御された構造と欠陥密度を備えたInGaAs NWを合成して、すべての技術アプリケーションでキャリアの移動度と寿命を向上させることが重要です。ただし、現時点では、成長プロセスが複雑であるため、In x の合成にはかなりの課題が残っています。 Ga 1 − x NWとして( x =0から1)構造が均一で、北西全体に沿って欠陥密度が低い。したがって、高品質のIn x を生成するための成長プロセスを設計します。 Ga 1 − x NWはまだかなりの課題であるため[1,26]。この目標を達成するためには、In x の成長メカニズムを徹底的に調査する必要があります。 Ga 1 − x CVD法を使用したNWとして。
私たちの以前の研究では、固体ソースCVDを使用した低コストでシンプルな2段階成長技術を開発し、優れた電気的特性を備えた高密度で長く結晶性の化学量論的InGaAsNWを合成しました。これは、アモルファスSiO 2 を使用して行われました。 気液固メカニズムにおける触媒シードとしての基板とAuナノ粒子[19、21、22]。これらのNWは、コンタクトプリント技術によって、平行に配置され、様々な種類の基板上に不均一に統合され得ることに留意されたい。これは、結晶性の基板上でより高価な分子線エピタキシー法または金属有機CVD法によって成長させた対応物と比較した場合、実用的なアプリケーションの有望な可能性を示しています[22、29]。 InGaAs NWの電気的特性は体系的に調査されましたが、NWの詳細な形態と結晶構造は十分にわかっていません[19、21、22]。したがって、アモルファス基板上に成長したAu触媒InGaAs NWの形態、構造組成、および化学組成を体系的に調査しました。この方法で作成されたNWは、滑らかな表面とジグザグの表面の両方を備えています。ジグザグの表面は、絡み合う構造が周期的に存在することに起因します。同時に、2種類の触媒ヘッド、Au 4 InおよびAuIn 2 、北西部でも観測された。さらに、触媒ヘッドとNWの間の配向関係も、HRTEMによって研究され、NWが気液固(VLS)成長メカニズムに従って成長することが示唆されました。この結果は、滑らかな表面、最小化された双晶欠陥、強化された結晶化度、およびその後の最適化されたデバイス性能を備えた「ボトムアップ」InGaAsNWの製造に関する貴重なガイダンスを提供します。
メソッド
InGaAsNWの準備
InGaAs NWは、高い成長収率を確保するために以前に報告されたように、固体ソースCVD法を使用して製造されました[15、16]。実験のセットアップを図1に示します。簡単に説明すると、InAsとGaAs粉末(純度99.9999%)を1:1の重量比で混合し、窒化ホウ素るつぼに入れました。このるつぼは、実験管の上流端にロードされ、Ga、In、およびAs原子を提供しました。基板(SiO 2 触媒として機能する厚さ0.5nmのAu膜を備えた厚さ50nmの熱成長酸化物を含む/ Siを、約20°の傾斜角で下流ゾーンの中央にロードしました。るつぼと基板の間の距離は10cmに保たれました。基板を800°Cに予熱し、10分間維持して、下流ゾーンでAuナノクラスターを取得し、次に冷却して、600°Cに維持しました。下流ゾーンが600°Cのとき、GaAsおよびInAs粉末ゾーンは820°Cに加熱されました。粉末ゾーンをこの温度で2分間保持して、Au触媒の核生成を可能にしました。次に、基板ゾーンを520°Cの成長温度に冷却し、30分間維持して、NWが成長するのに十分な時間を確保しました。 。純粋なH 2 流量100sccmの(純度99.9995%)を使用して、蒸発した前駆体を基板に運び、システムをパージして、NWの酸化を防ぎ、高品質のInGaAsNWを取得しました。続いて、ソースヒーターと基板ヒーターのスイッチを切り、システムをH 2 の下で室温まで冷却しました。 。
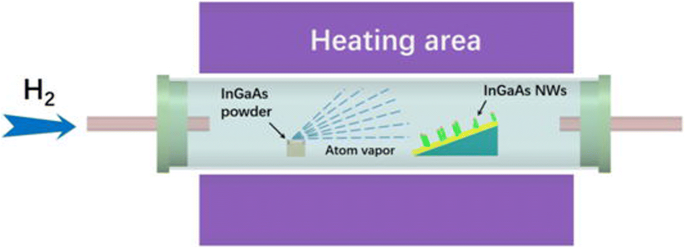
InGaAsNWの実験装置の概略図
InGaAsNWの特性評価
成長したInGaAsNWの形態は、SEM(Philips XL30)および明視野(BF)透過型電子顕微鏡(TEM、Philips CM-20)によって調査されました。成長したNWの結晶構造は、HRTEM-(JEOL 2100F、200 kVで動作)および高速フーリエ変換(FFT)画像によって分析されました。成長したInGaAsNWと触媒チップの化学組成は、JEOL 2100Fに取り付けられたエネルギー分散型X線(EDX)検出器によって研究されました。選択領域電子回折(SAED)、明視野(BF)、HRTEM、およびEDS検査は、200kVで動作するJEOL2100FTEMを使用して実行されました。 TEMサンプルの場合、InGaAs NWは最初に基板の表面から剥がされ、超音波処理によってエタノールに分散され、ホーリーカーボンフィルムでコーティングされた銅グリッド上に滴下されました。
結果と考察
図2aの上面SEM画像に示されているように、合成されたInGaAs NWは比較的真っ直ぐで密度が高く、10μmより長く、FET構造の狭いチャネルを通過するのに十分な長さです(<10μm)。断面図のSEM画像(追加ファイル1:図S1)に基づくと、NWは基板に垂直ではなく、基板とNWの間にエピタキシャル成長関係が存在しないことを示しています。 BF TEM画像(図2b)も、直径と長さが均一なInGaAsNWを示しています。 NWの直径分布を決定するために、100NWが測定されました。図2dに示すように、最も一般的な北西の直径は30〜50 nmで、平均値は39.5±7.1nmです。直径が50nmを超えるまたは30nm未満のNWはごくわずかです。 TEMを使用してさらに調査すると(図2c)、矢印で示されているInGaAs NWは、表面が真っ直ぐで滑らかであるだけでなく、上部に明らかなAuナノ粒子があり、VLS成長メカニズムによって成長したInGaAsNWが以前の報告と一致している[3、30]。他のNWは触媒ヘッドを示さず、これらのNWのほとんどはジグザグの表面を持っています。 TEMグリッドサンプルの超音波分配手順中にツインプランの欠陥が原因で、触媒ヘッドが破損した可能性があります。

a 反応後の基板表面のSEM画像。 b 、 c InGaAsNWのTEM明視野画像。 d InGaAsNWの直径分布ヒストグラム
非常に拡大されたTEM画像(図3a、b)に基づくと、InGaAsNWには2つの異なる形態が見られます。図3aは、NWの表面が滑らかでAu触媒シードが暗いことを示しています。 Au触媒とNWの両方の直径は約30nmです。図3bは、滑らかなものと同様の直径(〜35 nm)のNWを示していますが、多くのステップの粗い表面があり、触媒ヘッドはありません。これら2つの形態の微細構造を調査するために、HRTEMを採用しました。図4aに示すように、BF TEM画像は、ジグザグ表面がNW軸方向に沿って周期的に現れるいくつかの交互の明るいジョイントと暗いジョイントで構成されているNWを明確に示しており、平面欠陥構造の存在を示しています。図4bは、図4aでマークされた長方形領域の拡大HRTEM画像です。この拡大されたHRTEM画像に基づいて、ジグザグ形態は、白い矢印でマークされた双晶境界に周期的な双晶結晶が存在することに起因すると結論付けることができます。双晶の2つの部分は、同じ(111)結晶面を共有します。周期的な双晶の幅は約10〜20nmです。挿入図(i)〜(iii)は、それぞれ領域A、領域A / Bのインターフェース、および領域Bから取得したSAEDパターンです。挿入図(i)と(iii)は、領域AとBの結晶がすべて、InGaAsの<110>ゾーン軸に沿って捕獲された立方晶閃亜鉛鉱相を持ち、成長方向が<111>方向であることを示しています。挿入図(ii)は、黄色と赤の線でマークされた領域A / Bの界面に2セットの回折パターンがあることを明確に示しています。黄色と赤の線は、それぞれ挿入図(i)と(iii)と同じ回折パターンを示しており、ジグザグの形態が周期的な双晶の結果であることをさらに確認しています。
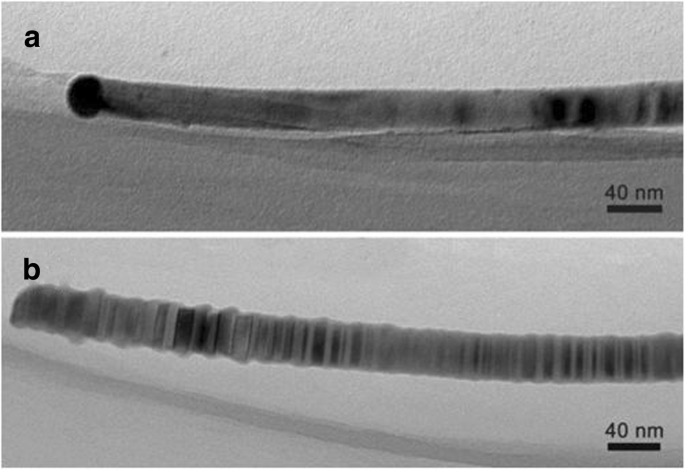
2つの異なる形態のInGaAsNWのTEM明視野画像 a 滑らかな表面と b ジグザグの表面

a ジグザグ形態の明視野TEM画像。 b a でマークされた長方形領域のHRTEM画像 、および(i)〜(iii)の挿入図は、それぞれA領域、A / B境界領域、およびB領域に対応するSAEDパターンです。
図5aは、滑らかな表面を持ち、ステップやジグザグの形態を持たないInGaAsNWのHRTEM画像です。さらに、北西の端に位置する半球形のAuナノ粒子が見られ、これがNWの成長を触媒します。滑らかなNWの微細構造をジグザグのものと比較するために、HRTEM画像を撮影しました(図5b)。InGaAsの<011>ゾーン軸を示しています。 2対の白い線でマークされた結晶面の面間間隔は3.40Aであり、これは立方相InGaAsの面に対応します。 40以上のNWのHRTEM画像の体系的な調査によると、滑らかなNWの微細構造はジグザグのものとは異なると結論付けることができます。滑らかなNWの結晶面は一貫性があり、コヒーレントであり、双晶や積層の欠陥はほとんどありません。これは、InGaAsNWの完全結晶構造が滑らかな表面の形成につながることを示しています。さらに重要なことに、滑らかな表面と低い双晶欠陥密度は、電子を散乱またはトラップしないため、NWに沿ったキャリア移動に有益です[18、19]。 InGaAs NWの双晶欠陥と粗い表面は、キャリアを散乱およびトラップする可能性があり、NWの電気的性能を大幅に低下させます[3、4、15]。したがって、制御可能な欠陥密度と滑らかな表面を備えたInGaAs NWを合成して、さまざまな技術アプリケーションの電気的特性を向上させることが重要です。
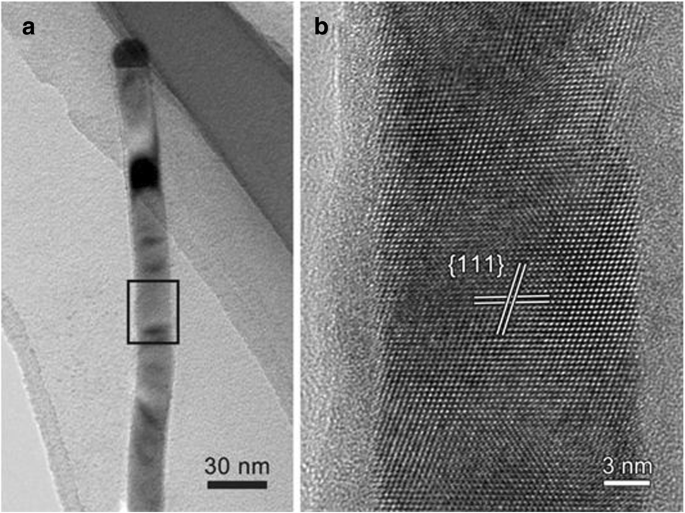
a 表面が滑らかな北西部の明視野TEM画像。 b a でマークされた長方形領域のHRTEM画像
報告されているように、触媒ナノ粒子、特にNWとの組成、微細構造、および配向関係は、CVD法によって生成されるNWの形成に重要な役割を果たします[3]。したがって、InGaAs NWの上部にあるAuナノ粒子の微細構造は、HRTEMを使用して広範囲に調査されました。 40を超えるNWの編集に基づいて、触媒ヘッドは主に2つの形式、Au 4 で見つかりました。 六角形の構造とAuIn 2 立方構造で。表面が滑らかなほとんどのNWは、各試行で同じ結晶構造を持っているため、2種類の触媒ヘッドの形成は、NWの冷却速度のわずかな温度差が原因である可能性があります。 Au 4 のHRTEM画像に示されているように ナノ粒子(図6a)では、触媒の直径は約24.8 nmであり、このサイズは23.5nmのNWに似ています。 <111>方向に沿って成長したInGaAsNWはエネルギー的に有利であるため、<111>配向に整列したNW核は常に成長が速く、成長プロセス中に支配的になる傾向があります(図6)[3、13]。 3本の白い線でマークされた結晶面(図6a)は、Au 4 の{10-10}面に対応しています。 これは、2本の白い線でマークされた立方晶相構造を持つInGaAs NWの{111}結晶面に平行です(図6a)。シード/ NWインターフェイスの方向関係がAu 4 であることが明示的に証明されています。 {10-10} | InGaAs {111}で。図6bのHRTEM画像は、AuIn 2 を備えた別の典型的な立方構造のInGaAsNWを示しています。 NW(30.2 nm)と同様の直径30.0nmの触媒ヘッド。同時に、白い線でマークされた結晶面は、AuIn 2 の{220}面に起因します。 これは、準備されたNWの{111}平面に平行で、平行な白い線のペアでマークされています(図6b)。これは、NWが<111>方向に成長したことを示しています。したがって、触媒ヘッドの組成と相構造は、固体ソースCVD法によって生成されたInGaAsの結晶構造と成長方向に影響を与えないと結論付けることができます。両方のキュービックAnIn 2 および六角形のAu 4 Inは、均一な立方相構造と<111>成長方向を持つInGaAs NWの成長を触媒することができます。これは、InGaAsNWの大規模なアプリケーションに有益です。触媒ヘッドの組成をさらに確認するために、EDX分析を図6a、bに示す触媒ヘッドで実行し、対応するスペクトルをそれぞれ図6c、dに示します。 Cu、Au、およびInの元素が触媒で検出されましたが、Cu信号はTEMグリッドからのものであり、完全に無視できます。図6c、dに示すスペクトルに基づいて、AuとInの原子比もそれぞれ4:1と1:2と定量化されました。これは、HRTEMの結果と一致しています。触媒ヘッドにGaまたはAs元素が見つからなかったことは注目に値します。これは、AuへのGaとAsの溶解度が低いため、GaとAsの元素が触媒ヘッドに効率的に拡散できなかったことが原因である可能性があります[15]。 CVD技術によって合成されたIII–V NWの場合、NWの形態と輸送特性は、触媒ヘッドの成分と結晶構造に強く依存します。したがって、Au触媒ヘッドと、触媒とNWの関係を体系的に調査することは、InGaAsNWのキャリア輸送特性の違いを理解するために重要です。

a の2種類の構造を持つAuナノ粒子のHRTEM画像 Au 4 と b AuIn 2 。 c 、 d a のAuナノ粒子のEDS および b 、それぞれ
HRTEMおよびEDSの結果の分析に基づいて、CVD法によって生成されたInGaAsNWのVLS成長メカニズムを推定することができます。図7は、二重温度ゾーンを備えた管状炉でのInGaAsNWの成長プロセスの概略図です。まず、GaAsとInAsの粉末を820°Cで加熱して、Ga、In、Asの原子を蒸発させました。次に、この蒸気は、キャリアガスの助けを借りて、成長の全期間にわたって基板に輸送された。反応の開始時に、Auナノ粒子はSiO 2 上で液体ボールに溶けました。 金属-半導体システムの共晶点より上の温度の基板。 In-Au合金は融点が低いため、In原子はAuナノ粒子に拡散し、In-Au合金を形成しました。 GaとAsのAuへの溶解度は非常に低いため、GaとAsの原子はAuナノ粒子に拡散しませんでした。反応時間が長くなるにつれて、インジウムの濃度はますます高くなり、Inが飽和点に達すると、In原子が沈殿し、触媒と基板の界面でGaおよびAs原子と結合しました。 InGaAsが形成されると、GaとAsによるInの析出は、NWと触媒の間の界面でのみ発生しました。したがって、InGaAs NWは、成長時間が長くなるにつれてますます長くなりました。この成長メカニズムは、従来のVLSメカニズムに似ています[3、31]。前述のように、この実験では、主に{111}面が密集していてエネルギーが最も低いため、ほとんどすべてのNWが<111>方向に沿って成長しました[3、21、22]。アモルファスSiO 2 による 成長基板の場合、NWは基板と特定の配向関係を持ちません(追加ファイル1:図S1に示されている断面SEM画像)。さらに、NWの形成中に、加熱温度のわずかな変化によりNWの内部にひずみ力が形成される可能性があります[5、21]。これらのひずみ力を解放するために、ジグザグ形態につながる北西部に形成された絡み合い構造。ひずみが完全に解放されれば、北西部の内部に欠陥は形成されず、滑らかな部分も観察できます。さらに、InはGaおよびAs原子と反応し、NWと触媒の間の界面でのみ触媒から沈殿するため、NWの直径は主に触媒の直径によって制御されます。これは、InGaAsNWの製造を示しています。触媒の直径を調整することで、特定の直径の製品を製造できます。
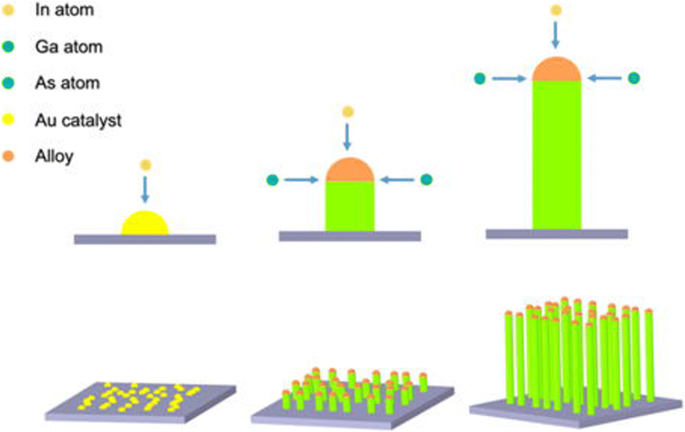
私たちの研究におけるInGaAsNWのVLS成長メカニズムの概略図
結論
結論として、InGaAsNWはCVD法によってうまく合成することができます。 NWの平均直径は39.5±7.1nmで、成長方向は<111>でした。 NWは、ジグザグ表面と滑らかな表面の2つの表面形態を示しました。それらの出現はランダムであり、同じ北西で発生する可能性もあります。 HRTEM調査により、ジグザグの形態は、主に北西部内のひずみ力に起因する絡み合い構造の周期的な存在に起因することが明らかになりました。 NWの形成メカニズムは、Auナノ粒子が溶融して小さなボールになり、In原子がAuボールに拡散してAu-In合金を形成することから始まります。 In濃度が飽和点に達すると、In原子が沈殿し、触媒と基板の界面でGa原子およびAs原子と結合して、InGaAsを形成します。 InGaAsの沈殿は、InGaAsと触媒の界面でのみ発生します。反応時間が長くなると、基板上に長いInGaAsNWが形成されます。さらに、NWの直径は触媒のサイズによって決定されるようでした。 2つの触媒、Au 4 InおよびAuIn 2 、どちらも<111>成長方向の立方体構造のInGaAsNWを生成します。すべての調査結果により、将来の技術的アプリケーション向けに最適化されたデバイス性能を備えた高品質のInGaAsNWの合成についてさらに理解することができます。
略語
- EDX:
-
エネルギー分散型X線分光法
- HRTEM:
-
高解像度透過型電子顕微鏡
- NW:
-
ナノワイヤー
- SAED:
-
選択領域電子回折
- SEM:
-
走査型電子顕微鏡
- TB:
-
ツインバウンダリー
- TEM:
-
透過型電子顕微鏡
ナノマテリアル
- 化学蒸着とは何ですか?
- 材料科学者はナノワイヤーに「踊る」方法を教えます
- マイクロLEDおよびVCSEL用の高度な原子層堆積技術
- 金属支援化学エッチング中の多孔質シリコンナノワイヤの形態進化とエッチング速度論の解明
- 有機金属化学蒸着によるInAsステム上での垂直GaSbナノワイヤの自己触媒成長
- 装填された薬物の化学的安定性に対するリポソームの微小環境pHの影響
- アスペクト比が異なり、高性能で柔軟な透明電極として使用される銀ナノワイヤーの容易な合成
- 二軸引張ひずみゲルマニウムナノワイヤの理論的研究
- オーミック接触を形成するためのp-GaNへのAlドープZnOの2段階堆積
- 化学蒸着によって成長した大きな単一ドメインを備えた大面積WS2膜
- パルス電位堆積技術によって電着されたテクスチャードFeナノワイヤアレイの一軸磁化性能



