金属前駆体としてCo(EtCp)2を使用したコバルト膜のプラズマ化学原子層堆積
要約
高度なCu相互接続技術については、TaよりもCuへの湿潤性が優れているため、Co膜がライナーおよびシード層の代替品として機能することが広く研究されています。この記事では、Co(EtCp) 2 を使用したプラズマ化学原子層堆積によってCo膜を成長させます。 前駆体として、Co膜の特性に及ぼすプロセスパラメータの影響を詳細に調査します。結果は、プロセスウィンドウが125〜225°Cで、成長速度が〜0.073Å /サイクルであることを示しています。つまり、EtグループをCp配位子に接続すると、125°Cで安定した膜成長が可能になりますが、対応する温度はCo(Cp) 2 で200°Cより高くなければなりません。 およびCo(MeCp) 2 。堆積した膜には、支配的なCoとCに加えて、NとOの元素が含まれています。さらに、NH 3 の延長 パルス時間はCo膜の導電率を大幅に向上させ、NH 3 で117μΩcmの低抵抗率を実現できます。 40秒のパルス時間。二乗平均平方根の粗さは、堆積温度による変化が小さく、約0.3 nmの低い値を維持しており、Co膜が平坦であることを示しています。
背景
高速超大規模集積回路における従来のCu相互接続プロセスを考慮すると、周囲の層間誘電体(ILD)へのCu原子の拡散を防ぐためにTaNなどのバリア層が不可欠です[1]。バリア層の他に、バリア層とCuの密着性を高めるためにTaのようなライナー層も必要です。さらに、Ta表面でのCu原子の核形成が弱いため、電気めっきによって直接ライナー層にCu線を堆積させることは困難です。結果として、Cuの電気めっきの前に、Cuシード層をライナー層にコーティングする必要があります。つまり、TaN / Ta / Cuシード層のスタックをILDとCuラインの間に挿入する必要があります。さらに、このスタックは、トレンチおよびビアとしてパターン化されたILDにコーティングされています。デバイスの機能サイズの縮小に伴い、Cu相互接続ラインで使用可能なボリュームは着実に減少しています。より低いCu相互接続抵抗を達成するために、種なしバリア/ライナー層が広く研究されてきました[2、3、4、5、6]。たとえば、TaNは引き続きバリア層として機能し、CoはTaをライナー層として置き換えます。 TaよりもCoのCuへの湿潤性が優れているため、CuをCo表面に直接電気めっきすることができます。伝統的に、バリア/ライナー層は物理蒸着プロセスによって成長します。ただし、PVDは高アスペクト比のトレンチとビアでのステップカバレッジ率が低いため、高品質のバリア/ライナー層の堆積は困難です。代わりに、自己制限的な成長特性のおかげで、原子層堆積(ALD)技術によって、極薄で連続的で優れたステップカバレッジフィルムを得ることができます[7]。
ALD Co膜に関しては、ビスシクロペンタジエニルコバルト(CoCp 2 )など、多数のCo前駆体、特にシクロペンタジエニル配位子(Cp)に基づく前駆体が広く研究されています。 )[8,9,10,11,12,13,14]、ビス(η-メチルシクロペンタジエニル)コバルト[Co(MeCp) 2 ] [15]、およびシクロペンタジエニルイソプロピルアセトアミジナトコバルト[Co(CpAMD)] [16]。 CoCp 2 の採用 低抵抗率と高純度のCo膜の成長を可能にします。ただし、安定した膜の成長は250°Cを超える温度に制限されます。 Cp配位子にメチル基を追加すると、200°Cでより低い温度成長を達成できます。これは、NH 3 の反応性が高いためです。 Cpリガンドと比較したMeCpリガンドに対するラジカル。 CoCp 2 によるCo膜の成長に基づく およびCo(MeCp) 2 前駆体として、プロセスウィンドウをより低い温度に移動することができます。つまり、エチル基がCp配位子に接続されている場合は、<200°Cになります。
この作業では、Co薄膜は、ビス(エチルシクロペンタジエニル)コバルト[Co(EtCp) 2 を使用したプラズマ化学化学化学化学化学(PE-ALD)によって成長しました。 ]およびNH 3 前駆体としてのプラズマ。 Co膜の特性に及ぼす異なるプロセスパラメータの影響を入念に調査した。その結果、125〜225°Cのプロセスウィンドウが正常に達成されました。さらに、Co膜はより低い抵抗率を示します(〜130μΩcm)。
メソッド
さまざまなCo薄膜が、200nmのSiO 2 上でPE-ALDによって成長しました。 熱酸化によりp型シリコン基板上に堆積した膜。 Co(EtCp) 2 金属前駆体として使用され、70°Cの容器に保管され、N 2 とともに堆積チャンバーに移されました。 キャリアガス。 NH 3 プラズマは、還元剤として機能する2800Wの電力でリモートプラズマジェネレーターによって生成されました。 N 2 の流量 は50sccmに保たれ、膜の成長中の使用圧力は約1000Paでした。膜の成長に対する堆積温度の影響を調査するために、基板温度を25°Cのステップで100から270°Cまで変化させました。さらに、プロセスパラメータを最適化するために、Co(EtCp) 2 のパルス時間 およびNH 3 血漿もそれぞれ変更されました。さらに、Co膜の性能に対するポストアニーリングの影響を調査するために、さまざまな温度で堆積されたサンプルをフォーミングガス(N 2 / 4%-H 2 )400°Cで30分間。
フィルムの厚さと密度はX線反射によって推定され、フィルムの微細構造は、Cu K α 放射線。フィルムの表面形態は、原子間力顕微鏡(AFM)(Bruker Icon)および走査型電子顕微鏡(SEM)(Zeiss SIGAMA HD)で観察されました。フィルムの元素組成と化学結合は、X線光電子分光法(XPS)(Kratos Axis Ultra DLD)によって分析されました。フィルムのシート抵抗は4点プローブで測定し、フィルムの抵抗率はフィルムの厚さとシート抵抗に基づいて計算しました。
結果と考察
ALDプロセスパラメータの最適化
図1aは、基板温度の関数としてのCo膜の成長速度を示しています。基板温度を125°Cに上げると成長速度が速くなり、125〜225°Cで0.073±0.02Å/サイクルの比較的安定した成長速度が得られることがわかります。ただし、基板温度が250°C以上になると、成長速度が速くなります。したがって、125〜225°Cの温度範囲は適切なプロセスウィンドウと見なすことができます。 Co(Cp) 2 との比較 およびCo(MeCp) 2 、Cp配位子にEt基を追加すると、プロセスウィンドウをより低い堆積温度に移動できます。これは、EtCp配位子とNH 3 との反応性が高いことを示しています。 プラズマ。 125°Cでのこのような低温成長は、熱収支を減らすのに役立ちます。 125°C未満の基板温度に関しては、比較的遅い膜成長は、化学反応のための適切な活性化エネルギーの欠如に起因するはずです[7]。 250°C以上でのこのような高い成長速度は、金属前駆体の熱分解に関連しています[17]。 Co(EtCp) 2 の影響を調査するには 堆積膜の成長速度のパルス時間、Co(EtCp) 2 のパルス時間 他のプロセスパラメータが固定されている間、1秒刻みで1秒から4秒に徐々に増加します。図1bに示すように、成長率はCo(EtCp) 2 の増加に伴い、〜0.06から〜0.073Å /サイクルに増加します。 パルス時間は1〜2秒で、比較的安定した値を維持します。これは、Co(EtCp) 2 の表面吸着を示しています。 2秒のパルス時間で飽和に達します。図1bは、NH 3 の影響も示しています。 -膜の成長速度に対するプラズマパルス時間。 NH 3 を長くすると、成長率が高くなります。 -プラズマパルス時間;ただし、プラズマパルス時間が20秒を超えると、成長速度は約0.12Å/サイクルの飽和値に達します。

ALDフィルムの成長速度の a への依存性 基板温度、 b Co(EtCp) 2 、およびNH 3 パルス時間
蒸着されたCoフィルムの特性評価
図2は、175°Cで堆積された膜のXPSスペクトルの調査を示しています。堆積した膜は、Co、N、O、およびC元素で構成されています。表面の汚染を完全に除去するために、XPSスペクトルを収集する前に、すべてのサンプルをArイオン衝撃で6分間その場でエッチングしたことは言及する価値があります。表1に、エッチング時間とともに175°Cで堆積した膜の元素パーセンテージを示します。CとOの含有量は、エッチングの6分後も一定であり、表面の汚染が完全に除去されていることを示しています。表2に、高解像度XPSスペクトルから抽出された、それぞれ100°Cと175°Cで成長した膜の元素原子比を示します。基板温度が100から175°Cに上昇すると、Cの相対含有量は40から32%に減少し、Nの元素パーセンテージは14から18%に増加します。さらに、Oの相対パーセンテージは、5%から7%へのわずかな増加を示しています。より高いC含有量は、EtCp配位子の部分除去に起因するはずです[15、16]。前駆体にはO元素が含まれていないため、堆積した膜のO原子は、おそらく反応チャンバー内の酸素に由来します。
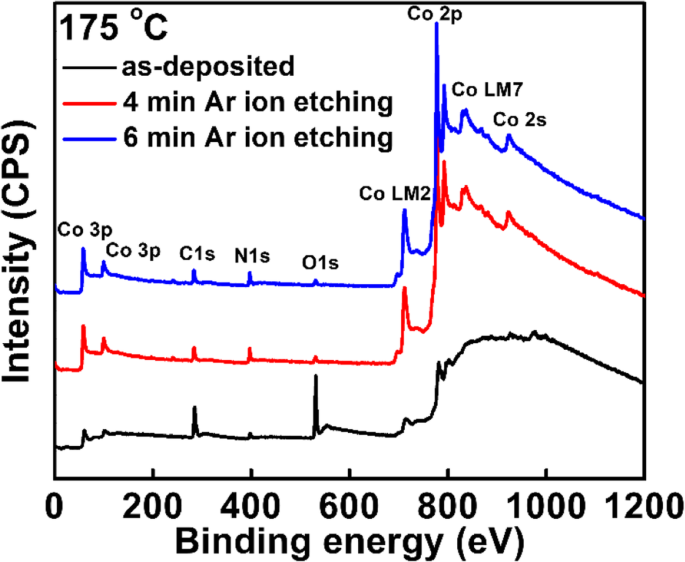
異なるエッチング時間で100°Cで堆積されたCo膜の調査スペクトル
図3aは、さまざまな温度で堆積された膜の高解像度C1sスペクトルを示しています。 C 1sスペクトルは、C-Co [12]、CC [12、18]、CN [15、19]、およびそれぞれCO [12]結合。温度が100から175°Cに上昇すると、C-C結合の相対含有量は61から56%に減少しますが、C-Co、C-N、およびC-Oの相対含有量はそれぞれ1%、2%、および2%増加します。これは、より多くのEtCp配位子がより高い温度で分解され、フィルム中のCの相対的な割合が減少することを示しています。図3bは、さまざまな温度で堆積された膜の高解像度N1sスペクトルを示しています。各N1sスペクトルは、ガウス-ローレンツ関数を使用して2つの成分に適切に分離できます。 397.8 eVにあるピークはN-Co結合[13]に関連付けられている必要があり、399.2eVを中心とするピークはN-C [20、21]結合に対応している必要があります。基板温度が100から175°Cに上昇すると、N-Coの相対含有量は72から69%に減少します。これは、膜からの窒素の脱離が高温で促進され、その結果、N-Co結合の形成が少なくなるためです。図3cは、高解像度のCo 2p 3/2 を示しています。 異なる温度で堆積されたCo膜のXPSスペクトル。図3a、bに示すように、C-Co結合とN-Co結合の存在に関しては、Co 2p 3/2 スペクトルは、それぞれ778、778.9、780.86±0.34eVの3つの成分に分けることができます。最小の結合エネルギーのピークは、Co-Co結合に起因するはずです[12、22]。さらに、C(2.55)のポーリング電気陰性度はN(3.04)よりも小さいため、Nに結合したCoの正電荷密度はCに結合したCoの正電荷密度よりも大きくなります。したがって、778.9と780.86±0.34にピークがあります。 eVは、それぞれCo-C結合とCo-N結合から発生する必要があります。堆積温度を100から175°Cに上げると、Co-N結合の相対含有量は48から32%に減少します。これは、図3bのN-Co結合の変化と一致しています。

高解像度の a Co 2p 3/2 、 b C 1s、および c それぞれ100°Cと175°Cで堆積された膜のN1sXPSスペクトル
Co膜の結晶特性は、図4に示すように、TEMによって特徴付けられます。それぞれ100°Cと250°Cで堆積されたCo膜は、両方とも結晶化されます。図5は、さまざまな温度で成長させたCo膜のAFM写真を示しています。堆積温度が100°Cから250°Cに上昇すると、二乗平均平方根(RMS)の粗さの変動は小さくなり、約0.3 nmの低い値を維持します。これは、Co膜が平坦であることを示しています。
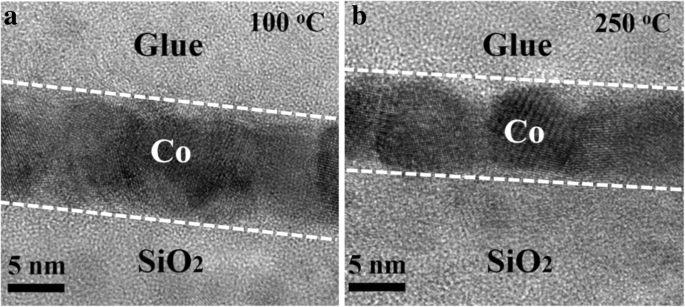
a で堆積されたCo膜(1200サイクル)の断面TEM画像 100°Cおよび b それぞれ250°C
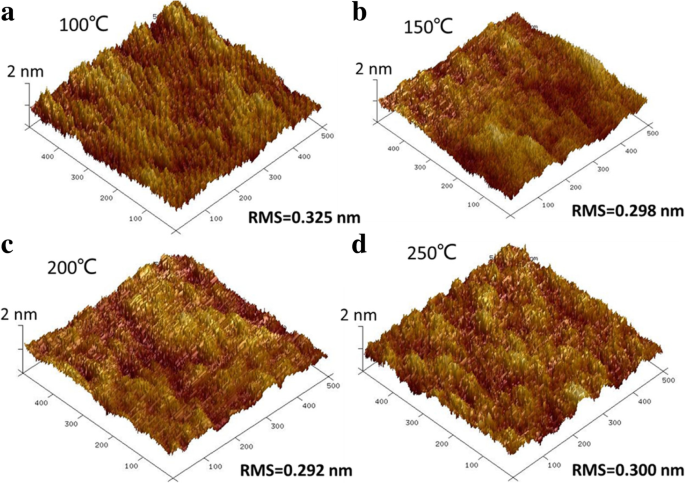
Co(EtCp) 2 で堆積されたCo膜(1200サイクル)のAFM画像 2秒のパルス時間とNH 3 さまざまな温度での10秒のプラズマパルス時間: a 100°C; b 150°C; c 200°C; d 250°C
図6a、bは、Co膜の抵抗率の基板温度とNH 3 への依存性を示しています。 パルス時間。膜の抵抗率は652から130Ωcmに著しく低下し、その後、堆積温度を100から275°Cに上げると一定に保たれます。結果は、フィルム中の金属Coの相対含有量の増加に起因するはずです。 NH 3 として パルス時間は10秒から40秒に増加し、Co膜の抵抗率は158から117μΩcmに減少します(図6bを参照)。図7は、Co 2p 3/2 を示しています。 異なるNH 3 で堆積されたCo膜のXPSスペクトル プラズマ時間。 NH 3 として プラズマ時間は10秒から40秒に延長され、Co-Co結合の相対的な割合は31から34%に増加し、Co-C結合の相対的な含有量は40から31%に減少します。さらに、NH 3 として、炭素含有量は22%減少します。 プラズマパルス時間は10秒から40秒に増加します。これは、EtCp配位子の除去が徐々に増加し、Co膜の抵抗率の低下に寄与していることを示しています。

成長温度の関数としてのCo膜の抵抗率( a )およびNH 3 パルス時間( b )、それぞれ
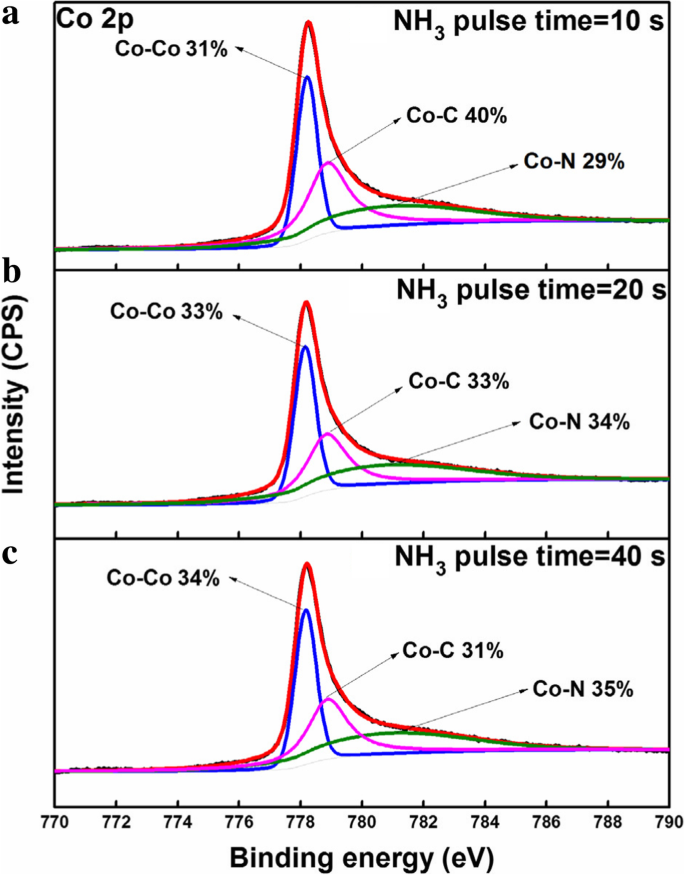
NH 3 が異なるCo膜のXPSスペクトル プラズマ時間: a 10秒; b 20秒; c 40秒
表3は、さまざまな前駆体によって成長したCo膜の性能比較を示しています。 CoCp 2 との比較 およびCo(MeCp) 2 、Co(EtCp) 2 より低い温度でのCo膜の原子層堆積を可能にします。さらに、Co(EtCp) 2 の金属前駆体を使用します 成長率が低くなります。理論的には、ALDプロセスは単分子層による単分子層の成長です。実際、前駆体の立体障害効果と表面吸着の両方が膜の成長に影響を及ぼします。立体障害効果に関しては、化学吸着された金属前駆体種のリガンドが部分的な表面を遮蔽し、他の金属前駆体種が基板表面に完全に吸着されるのを防ぐことができることを意味します。 Co(EtCp) 2 以降 CoCp 2 と比較してより大きなリガンドを持っています およびCo(MeCp) 2 、ALDプロセス中に重大な立体障害効果が発生すると想定されています。これはサブ単分子層の成長につながる可能性があり、その結果、成長率が小さくなります。一方、将来の実用化のためにCoライナー層をTaNバリア層に堆積する必要があるため、125°CでALDTaN膜上に1200サイクルのCo膜を成長させました。図8は、TaN表面に堆積したCo膜の断面TEM画像を示しています。 Co膜は連続的で均一であり、優れた成長挙動を示していることが観察されます。さらに、ALD TaN膜上に堆積されたCo膜の厚さ(約10 nm)は、SiO 2 上で成長したものと同様であることがわかります。 表面。
<図>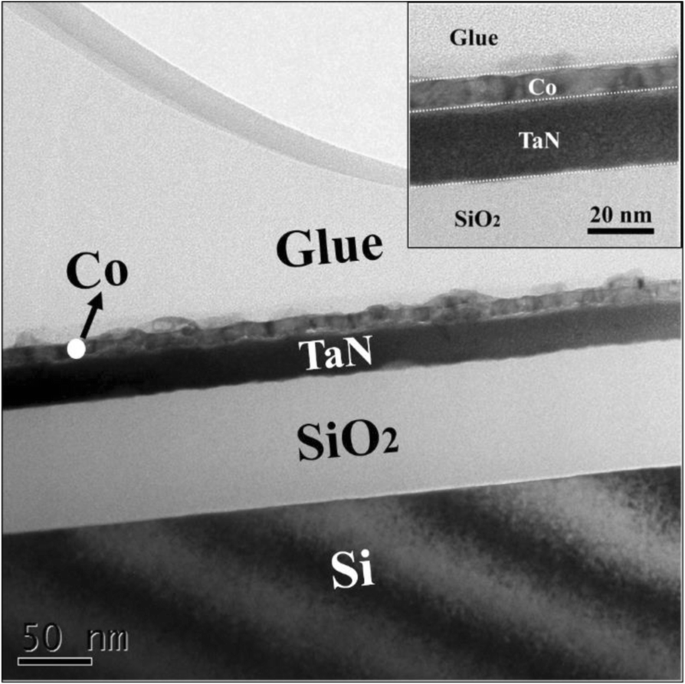
ALD TaN表面に125°Cで堆積されたCo膜(1200サイクル)の断面TEM画像と挿入図は拡大写真です
結論
Co薄膜の成長は、Co(EtCp) 2 の前駆体を使用したPE-ALDによって変化します。 、およびCo膜の特性に及ぼすプロセスパラメータの影響を調査した。 Cp配位子にEt基を追加すると、プロセスウィンドウを125°Cのより低い堆積温度に移動できます。さらに、Co膜は、いくつかのNおよびO元素とともにCoおよびC元素で構成されています。堆積温度を上げると、EtCp配位子がより十分に除去され、Cの相対元素パーセンテージが減少します。その結果、堆積したCo膜の抵抗率は652から130μΩcmに減少し、基板温度が100から275°Cに上昇しても安定した値を維持します。堆積温度が125°Cの場合、NH 3 が長くなると、抵抗率は徐々に低下します。 NH 3 の場合、パルス時間と117μΩcmの低抵抗率が得られます。 40秒のパルス時間が使用されます。二乗平均平方根の粗さは、堆積温度による変化が小さく、約0.3 nmの低い値を維持しており、Co膜が平坦であることを示しています。
略語
- AFM:
-
原子間力顕微鏡
- ALD:
-
原子層堆積
- Co(CpAMD):
-
シクロペンタジエニルイソプロピルアセトアミジナトコバルト
- Co(EtCp) 2 :
-
ビス(エチルシクロペンタジエニル)コバルト
- Co(MeCp) 2 :
-
ビス(η-メチルシクロペンタジエニル)コバルト
- CoCp 2 :
-
ビス-シクロペンタジエニルコバルト
- Cp:
-
シクロペンタジエニル
- ILD:
-
層間誘電体
- PE:
-
プラズマ強化
- RMS:
-
二乗平均平方根
- SEM:
-
走査型電子顕微鏡
- XPS:
-
X線光電子分光法
- XRD:
-
X線回折
ナノマテリアル
- マイクロLEDおよびVCSEL用の高度な原子層堆積技術
- 原子層堆積によって製造されたPtおよびTiNコーティング基板上のHfO2 / TiO2 / HfO2三層構造RRAMデバイスのバイポーラ抵抗スイッチング特性
- プラズマ化学原子層堆積によるその場で形成されたSiO2中間層を有するHfO2 / Geスタックの界面、電気、およびバンド整列特性
- 鉄修飾バイオチャーのナノコンポジットを用いた重金属イオン収着の調査
- 原子層堆積と水熱成長によって製造された抗菌性ポリアミド6-ZnO階層型ナノファイバー
- プラズマ化学原子層堆積によって調製されたCo3O4被覆TiO2粉末の光触媒特性
- オーミック接触を形成するためのp-GaNへのAlドープZnOの2段階堆積
- 超循環原子層堆積によるZnO膜のフェルミ準位調整
- ナノサイズのフェニレンジアミンフィルムを使用したアンペロメトリートランスデューサーの選択性の改善
- 顕微鏡を使用した層の厚さの測定
- 合金を使用する利点



