ニトロ化を伴うハイブリッド2D-MoS2 /3D-β-Ga2O3ヘテロ接合のバンドアラインメントの調査
要約
二次元(2D)および従来の三次元(3D)材料に基づくハイブリッドヘテロ接合は、工学的機能を備えたナノ電子デバイスへの有望な方法を提供します。この作業では、転送されたMoS 2 で構成される混合次元ヘテロ接合のバンドアラインメントを調査しました。 β-Ga 2 について O 3 (\(2- \)01)ニトロ化ありとなし。窒化されていない2D-MoS 2 の伝導帯と価電子帯のオフセット /3D-β-Ga 2 O 3 ヘテロ接合は、それぞれ0.43±0.1および2.87±0.1eVであると決定されました。窒化ヘテロ接合の場合、伝導帯と価電子帯のオフセットは、それぞれ0.68±0.1と2.62±0.1eVと推定されました。変更されたバンドアラインメントは、ヘテロ接合界面を横切る電荷移動によって形成された双極子に起因する可能性があります。 III族酸化物と遷移金属ジカルコゲナイド間のバンド配列に対する窒化の影響は、ヘテロ接合ベースの電子および光電子デバイスを設計するための実行可能な技術ルートを提供します。
背景
ベータ酸化ガリウム(β-Ga 2 O 3 )その優れた材料特性により、かなりの関心を集めています[1、2]。超ワイドバンドギャップ(4.6〜4.9 eV)の場合、理論的な破壊電界( E C )は約8 MV / cmと推定されています[3、4]。高い比誘電率(ε)と電子移動度(μ)を組み合わせると、バリガの性能指数(\(\ upvarepsilon \ upmu {E} _C ^ 3 \))はGaNまたはSiCの3倍になり、伝導損失が減少します。大幅に[1]。さらに、溶融成長およびエピタキシャル技術によって合成された大きなバルク単結晶の利用可能性は、産業用途に大きな利点をもたらします[5、6]。はるかに、β-Ga 2 O 3 発光ダイオード、ガスセンサー、光検出器、電界効果トランジスタなど、さまざまな電子アプリケーションで十分に実証されています[7、8、9、10]。ごく最近、ハイブリッドヘテロ接合、すなわち、2次元(2D)材料と3次元(3D)材料の統合は、それらの材料システムの補完的な特性のために特に興味深いものです[11]。
これまで、さまざまな2D層状材料がワイドバンドギャップ半導体上に積み重ねられ、MoS 2 などのさまざまな機能を備えた新しいアプリケーション向けのハイブリッドヘテロ接合を構築してきました。 / GaN、WSe 2 / GaN、MoS 2 / SiCなど[12,13,14,15]。構造的には、MoS 2 結晶は、2つの硫黄層の間に挟まれたMo原子層で構成され、弱いファンデルワールス力によって隣接する層に結合する2次元の六角形の3層を形成します[16、17]。バンドギャップがゼロのグラフェンとは異なり、バンドギャップの厚さに依存する変調は、MoS 2 の探索を動機付けました。 光学および電気デバイス[18、19]。 MoS 2 の物理学に基づく 、数層のMoS 2 の状態密度 単層(SL)MoS 2 よりも3桁高い 、弾道限界での高い駆動電流につながります。このコンテキストでは、数層のMoS 2 SL MoS2 [18]よりもトランジスタアプリケーションに大きな利点をもたらす可能性があります。したがって、MoS 2 の統合 β-Ga 2 を使用 O 3 確立された2Dと3Dの両方の材料のそれぞれのメリットを組み合わせるために非常に興味深いです。また、ハイブリッドヘテロ接合の光学的および電気的特性は、本質的に界面エネルギーバンドの整列によって支配されます。したがって、ヘテロ接合ベースのデバイスの性能を改善するために、調整可能なバンドアライメントを有することが非常に望ましい。この作業では、2D-MoS 2 のバンドアラインメントを調査しました。 /3D-β-Ga 2 O 3 X線光電子分光法(XPS)の特性評価と第一原理計算による窒化処理の有無によるヘテロ接合。
メソッド
SiO 2 / Si基板をアセトンとビソプロパノールでそれぞれ10分間超音波処理した後、脱イオン水ですすぎ、N 2 で乾燥させました。 。数層のMoS 2 膜はSiO 2 上で成長しました MoO 3 の前駆体を使用した化学蒸着(CVD)による/ Si基板 (0.08 mg、99%、Alfa Aesar)およびS粉末(1 g、99%)[20、21]。 MoO 3 とS粉末をSiO 2 の2つの別々のるつぼに入れました。 図1aに示すように、石英管内の/ Si基板。成長プロセス中、石英管はMoS 2 のために800°Cに保たれました。 5分以内のフィルム成長。図1bは、均一なMoS 2 の光学顕微鏡画像を示しています。 SiO 2 上のフィルム / Si基板。 MoS 2 の成長後 フィルムの場合、β-Ga 2 に転送されます O 3 (タムラ製作所、日本)PMMA支援法による基板[22]、図1cにスケッチ。転写プロセス中、PMMAは最初に成長したままのMoS 2 にスピンコーティングされました。 支持層としてフィルムを形成し、次にサンプルをKOH溶液に浸して、SiO 2 をエッチング除去しました。 層。続いて、MoS 2 を含むPMMA層 フィルムが溶液に浮き、その後、サンプルを脱イオン水で1分間すすぎ、残留K + を除去します。 さらにβ-Ga 2 に転送されます O 3 基板。最後に、最上部のPMMA層をアセトンで除去します。窒化されたMoS 2 の場合 /β-Ga 2 O 3 ヘテロ接合、ニトロ化はβ-Ga 2 に実装されています O 3 50秒N 2 の表面 MoS 2 の前の3Paの圧力でのプラズマ処理 移行。 RF電力とN 2 流量はそれぞれ100Wと80sccmでした。その結果、XPS測定用に4つのサンプルが準備されました。(1)コーティングされていないβ-Ga 2 O 3 基質(バルクβ-Ga 2 O 3 )、(2)数層のMoS 2 SiO 2 上のフィルム / Si基板(数層MoS 2 )、(3)転送されたMoS 2 β-Ga 2 のフィルム O 3 基板、(4)転送されたMoS 2 窒化されたβ-Ga 2 上のフィルム O 3 基板。
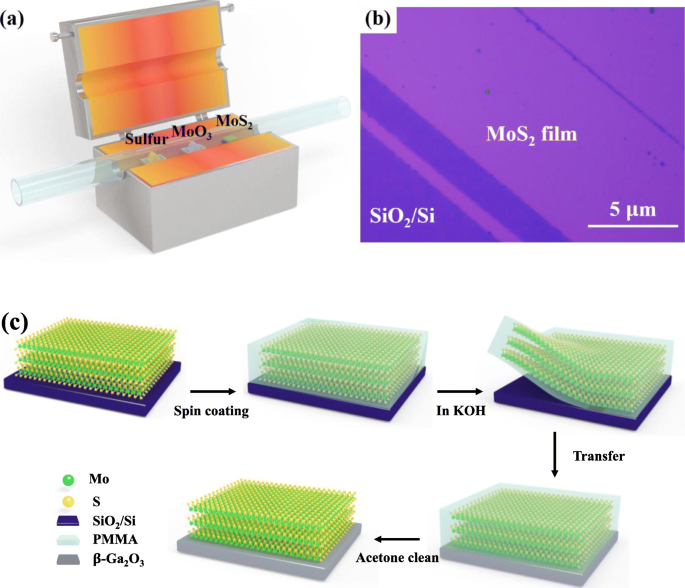
a MoS 2 のCVD成長のための実験装置の概略図 。 b 成長したままの数層MoS 2 の光学画像 SiO 2 上のフィルム / Si基板。 c MoS 2 のPMMA支援ウェットトランスファー法のプロセスフロー /β-Ga 2 O 3 ヘテロ接合形成
結果と考察
ラマン分光法を使用して、数層のMoS 2 の品質を調査しました。 フィルムだけでなく、関連するレイヤー番号を確認します。 MoS 2 のラマンスペクトル 転写前後のフィルムを図2に示します。これは、RENISHAWinViaラマン分光法によって特徴づけられました。 2つの特徴的なラマンモードが約381.91cm -1 で観察されました。 および405.84cm -1 、面内(\({E} _ {2g} ^ 1 \))モードおよび面外( A )に対応します 1 g )モード、それぞれ[23、24]。成長したままのMoS 2 と比較 フィルムでは、\({E} _ {2g} ^ 1 \)と A にラマンシフトはほとんどありません。 1 g 転送プロセス後のモード。損傷していないMoS 2 を示します。 転送プロセス後。 412.99 cm -1 のピーク 転送プロセスの後は、β-Ga 2 に由来します O 3 以前の報告[25]と一致する基質。 \({E} _ {2g} ^ 1 \)と A の周波数差 1 g モードは約23.93cm -1 であると推定されました 、数層のMoS 2 の4つの層を指定します 映画[26]。さらに、図2の挿入図に示すように、MoS 2 の厚さ 高分解能透過型電子顕微鏡(HRTEM)により、フィルムが約3 nm(約4層)であることが確認されました。これは、ラマンスペクトルとよく一致しています。図3aから、窒化物β-Ga 2 からN1sの高強度ピークが検出されたことがわかります。 O 3 基質、窒素の存在を示唆している。図3bは、MoS 2 のSIMSプロファイルを示しています。 /β-Ga 2 O 3 ニトロ化を伴うヘテロ接合。Mo、N、およびGaで表される主成分の信号が深さに対してプロットされます。 NピークがMoS 2 にあることが観察されます。 /β-Ga 2 O 3 界面、およびβ-Ga 2 に広がるN O 3 基板は、プラズマ処理または一次ビーム衝撃中に下にある層へのN注入によって寄与される可能性があります。 MoS 2 のより高いGaプロファイル β-Ga 2 よりも層 O 3 基質はおそらく、異なる材料マトリックスでの異なるイオン収量に由来します[27]。さらに、β-Ga 2 のMoのテール O 3 一次ビーム衝撃によって引き起こされる拡散または深度分解能の問題に起因する可能性があります[28]。
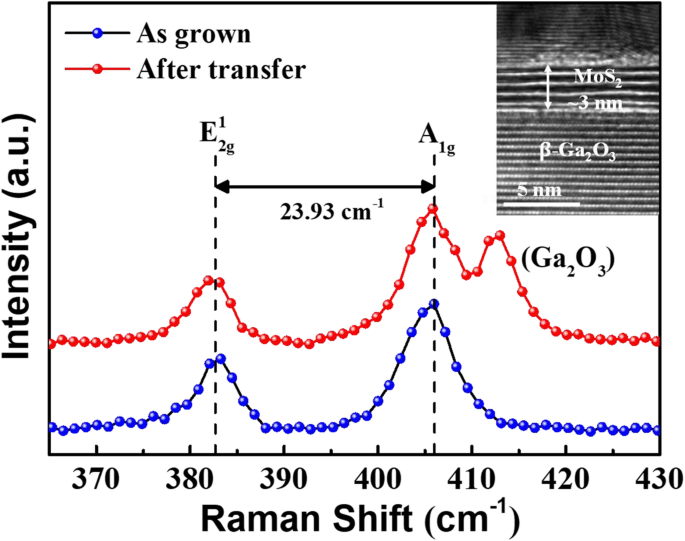
成長したままのMoS 2 のラマンスペクトル SiO 2 / Si基板と転写されたMoS 2 β-Ga 2 について O 3 それぞれ基板。挿入図は、製造されたMoS 2 の断面透過型電子顕微鏡(TEM)画像を示しています。 /β-Ga 2 O 3 ヘテロ接合
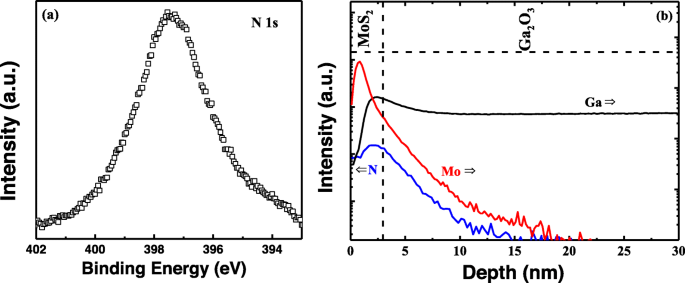
a N1のβ-Ga 2 のXPSスペクトル O 3 表面窒化を伴う基板。 b 製造されたMoS 2 のSIMS深度プロファイル /β-Ga 2 O 3 ヘテロ接合
MoS 2 のバンドアラインメントを取得するには /β-Ga 2 O 3 ヘテロ接合、0.05 eVのステップでのXPS測定は、単色AlKαX線源(hν=1486.6 eV)を備えたVG ESCALAB220i-XLシステムで実行されました。一定通過エネルギーは20eVに設定されました。さらに、結合エネルギー(BE)のキャリブレーションには標準のC 1 s(284.8 eV)が使用されました[29]。 MoS 2 での価電子帯オフセット(VBO)を評価するには /β-Ga 2 O 3 インターフェース、Mo3dおよびGa3dコアレベル(CL)は、数層のMoS 2 に使用されました。 およびβ-Ga 2 O 3 それぞれサンプル。図4aは、Mo3dのXPSナロースキャンと数層のMoS 2 からの価電子帯スペクトルを示しています。 [30]。 Mo 3d 5/2 のCL間の結合エネルギー差(BED) MoS 2 の価電子帯最大値(VBM) 228.59±0.1eVと計算されました。図4bに示すように、数層のβ-Ga 2 からのGa3dCLおよびVBMのBE O 3 それぞれ20.25±0.05および3.23±0.05eVであると推定されました。対応するBEDは17.02±0.1eVと決定されました。これは、Sunらによって報告されたものとよく一致しています。 [31]。図4cは、MoS 2 のMo3dおよびGa3dCLの測定されたXPSスペクトルを示しています。 /β-Ga 2 O 3 窒化を伴う/伴わないヘテロ接合。 Mo 3d 5/2 CLは非窒化ヘテロ接合の228.95±0.05eVから窒化ヘテロ接合の229.60±0.05eVにシフトし、Ga 3dCLは20.25±0.05から20.65±0.05eVにシフトしました。クラウトの方法に基づいて、[32]価電子帯オフセット(VBO、 ∆E V )数層のMoS 2 /β-Ga 2 O 3 ヘテロ接合は、次の式に従って計算されました。
$$ \ Delta {E} _V =\ left({E} _ {Mo \ 3 {d} _ {5/2}} ^ {Mo {S} _2}-{E} _ {VBM} ^ {Mo { S} _2} \ right)-\ left({E} _ {Ga \ 3d} ^ {Ga_2 {O} _3}-{E} _ {VBM} ^ {Ga_2 {O} _3} \ right)-{\ Delta E} _ {CL} $$(1)
a Mo 3dCLのXPSスペクトルと数層のMoS 2 からの価電子帯 。 b Ga 3dCLのXPSスペクトルとβ-Ga 2 からの価電子帯 O 3 基板。 c 製造されたMoS 2 のMo3dおよびGa3dCLのXPSスペクトル /β-Ga 2 O 3 表面窒化を伴う/伴わないヘテロ接合。 d β-Ga 2 のO1のCLエネルギー損失のXPSスペクトル O 3 表面窒化の有無にかかわらず基板
ここで、\({E} _ {Mo \ 3 {d} _ {5/2}} ^ {Mo {S} _2} \)および\({E} _ {VBM} ^ {Mo {S} _2} \ )はMo 3d 5/2 の結合エネルギーです。 MoS 2 のCLおよびVBM 、\({E} _ {Ga \ 3d} ^ {Ga_2 {O} _3} \)、および\({E} _ {VBM} ^ {Ga_2 {O} _3} \)は、Ga 3dCLの結合エネルギーです。およびβ-Ga 2 からのVBM O 3 、\({\ Delta E} _ {CL} =\ Big({E} _ {Mo \ 3 {d} _ {5/2}} ^ {Mo {S} _2}-{E} _ {Ga \ 3d} ^ {Ga_2 {O} _3} \))は、Mo 3d 5/2 間の結合エネルギーの差です。 およびMoS 2 のGa3d CL /β-Ga 2 O 3 ヘテロ接合。したがって、 ∆E V MoS 2 の β-Ga 2 について O 3 N 2 がある場合とない場合の基板 プラズマ処理は、それぞれ2.62±0.1および2.87±0.1eVと計算されました。
図4dは、β-Ga 2 のO1 sCLエネルギー損失スペクトルを示しています。 O 3 窒化の有無にかかわらず基質。バンドギャップは、4.70±0.1eVの値で窒化処理後も変化しないことに注意してください。したがって、伝導帯域オフセットは次のように抽出できます。
$$ {\ Delta E} _C ={E} _g ^ {Ga_2 {O} _3}-{E} _g ^ {Mo {S} _2}-{\ Delta E} _V $$(2)ここで、\({E} _g ^ {Ga_2 {O} _3} \)と\({E} _g ^ {Mo {S} _2} \)はβ-Ga 2 のバンドギャップです。 O 3 および数層のMoS 2 、 それぞれ。数層MoS 2 のバンドギャップ1.4±0.1eV この作業で使用されました。 34 式によると。 (2)、 ∆E C MoS 2 の間 およびβ-Ga 2 O 3 窒化の有無で、それぞれ0.68±0.1および0.43±0.1eVであると推定されました。ニトロ化の有無によるヘテロ接合の計算されたバンド図を、それぞれ図5(a)と5(b)に示します。
次に、窒化および非窒化ヘテロ接合の電子構造を、密度汎関数理論(DFT)に基づくVienna ab initioシミュレーションパッケージ(VASP)を介してさらに調べました[33、34、35]。 Perdew-Burke-Ernzerhof(PBE)パラメーター化の一般化勾配近似(GGA)が、交換相関関数に採用されました[36、37]。 DFT-D3分散補正アプローチを使用して、長距離ファンデルワールス(vdW)相互作用を記述しました[38、39、40]。プロジェクター拡張波(PAW)擬ポテンシャル法を使用して、平面波膨張の650eVの運動エネルギーカットオフによるコア-原子価相互作用を説明しました。ユニットセルの構造緩和のために4×4×1G中心のkメッシュを採用し、k点間の最小間隔は0.04Å -1 、これは、k点の数に関する収束テストによって十分に正確です。収束しきい値は10 -4 に設定されています システムのエネルギー差のeVと10 -2 eVÅ -1 ヘルマン-ファインマン力のために。隣接する2つの原子層間の人為的な相互作用を排除するために、真空層の厚さは約15Åに設定されています。ヘテロ接合の固有値は、Heyd-Scuseria-Ernzerhof(HSE06)混成汎関数計算によってさらに検証されます。これは、PBEおよびHartree-Fock(HF)汎関数の局在化および非局在化エラーを減らすことによって固有値の精度を向上させます[41]。短距離HF交換の混合率は25%です。スクリーニングパラメータは0.2Å -1 。

MoS 2 のバンド図 /β-Ga 2 O 3 ヘテロ接合 a なしおよび b 表面窒化を伴う
MoS 2 /β-Ga 2 O 3 ヘテロ接合は、図6aに示すように構築されました。結合エネルギーと原子分離の関係の単純な普遍的な形式を提供するユニバーサル結合エネルギー関係(UBER)法[42]を適用して、電子構造計算の前にエネルギー的に安定した構造を決定しました。さまざまな層間距離が考慮され、表面付着エネルギー W ad ヘテロ接合の場合を以下に示します
$$ {W} _ {ad} =\ frac {E_ {Ga_2 {O} _3} + {E} _ {Mo {S} _2}-{\ mathrm {E}} _ {Ga_2 {O} _3 / Mo {S} _2}} {A} $$
β-Ga 2 の原子構造と電荷密度分布 O 3 -MoS 2 積み重ねられたヘテロ構造 a なしおよび b 側面から見た4×4×1スーパーセル内の窒素ドーパントを使用。 Ga(O)原子は赤(灰色)、Mo(S)原子は青(オレンジ)です。 MoS 2 のバンド構造 /β-Ga 2 O 3 ヘテロ構造 c なしおよび d 窒素ドーパントを使用
ここで、Aはインターフェイス領域、\({E} _ {Ga_2 {O} _3} \)、\({E} _ {Mo {S} _2} \)、および\({E} _ {Ga_2 {O } _3 / Mo {S} _2} \)は、β-Ga 2 の総エネルギーです。 O 3 、単層MoS 2 およびMoS 2 /β-Ga 2 O 3 それぞれヘテロ接合。一度 W ad 最大に達すると、最適な層間距離が得られます。構造の最適化後、元のMoS 2 に窒素原子が置換的にドープされます。 /β-Ga 2 O 3 図6bに示すように、ヘテロ接合。 DFT計算における窒素濃度は約4.17%であり、実験における窒素濃度(3.61%)に近い。窒化されたMoSと窒化されていないMoSの両方の電子構造 2 /β-Ga 2 O 3 ヘテロ接合は、図6cおよびdに示すように計算されました。ミッドギャップ状態が導入され、MoS 2 全体の電荷移動が促進されることがわかりました。 /β-Ga 2 O 3 界面、および結果として生じる界面双極子は、測定された結合エネルギーシフトに寄与しました。さらに、計算された伝導帯オフセット ∆E C (\(\ Delta {E} _C ={E} _ {CB} ^ {Mo {S} _2}-{E} _ {CB} ^ {Ga_2 {O} _3} \))ドープされていない場合とドープされている場合β-Ga 2 O 3 / MoS 2 ヘテロ接合はそれぞれ0.82と1.0eVであり、実験結果と同じ傾向を示しています。また、HSE06法を使用して、\({E} _ {CB} ^ {Mo {S} _2} \)と\({E} _ {CB} ^ {Ga_2 {O} _3} \)の固有値を計算しました。上記の結論をさらに確認し、修正された ∆E C ドープされていないおよびドープされたβ-Ga 2 の場合は0.87および1.08eVです。 O 3 / MoS 2 それぞれヘテロ接合。
結論
結論として、それぞれのMoS 2 フィルムは、窒化されていない窒化物のβ-Ga 2 に転写されています。 O 3 MoS 2 を構築するため /β-Ga 2 O 3 ヘテロ接合。ラマン分光法を使用して、転送されたMoS 2 の品質を調査しました。 フィルム、およびSIMS研究は、MoS 2 の元素深度プロファイルを調査するために実行されました。 /β-Ga 2 O 3 ニトロ化を伴うヘテロ接合。窒化されたMoS 2 の場合、VBOは2.62±0.1eVであると決定されました。 /β-Ga 2 O 3 XPSによる非窒化ヘテロ接合のヘテロ接合と2.87±0.1eV。結果として得られたCBOは0.68±0.1および0.43±0.1eVであると推定され、これはDFT計算と同じ傾向でした。これらの発見は、バンドオフセットが表面窒化プロセスを介して変更できることを示した。この研究は、2D / 3D垂直ヘテロ接合に基づいて設計された電子デバイスの実装に関する素晴らしい展望を提供します。
データと資料の可用性
この原稿の結論を裏付けるデータセットは、原稿に含まれています。
略語
- β-Ga 2 O 3 :
-
ベータ酸化ガリウム
- SL:
-
単層
- MoS 2 :
-
二硫化モリブデン
- XPS:
-
X線光電子分光法
- CBO:
-
伝導バンドオフセット
- VBO:
-
ヴァランスバンドオフセット
- CVD:
-
化学蒸着
- PMMA:
-
ポリ(メチルメタクリレート)
- HRTEM:
-
高分解能透過型電子顕微鏡
- SIMS:
-
二次イオン質量分析
- BE:
-
結合エネルギー
- ベッド:
-
結合エネルギーの違い
- CL:
-
コアレベル
- VBM:
-
価電子帯の最大値
- VASP:
-
ウィーンabinitioシミュレーションパッケージ
- DFT:
-
密度汎関数理論
- GGA:
-
一般化された勾配近似
- PBE:
-
Perdew-Burke-Ernzerhof
- PAW:
-
プロジェクター拡張波
- UBER:
-
普遍的な結合エネルギーの関係
ナノマテリアル
- 電気触媒水素発生のための制御された厚さのMoS2
- プラズマ化学原子層堆積によるその場で形成されたSiO2中間層を有するHfO2 / Geスタックの界面、電気、およびバンド整列特性
- 化学センシング用の貴金属ナノ粒子で装飾されたエレクトロスピニングポリマーナノファイバー
- 高性能シリコン/有機ハイブリッド太陽電池用の溶媒処理を備えた高導電性PEDOT:PSS透明正孔輸送層
- 電気触媒作用のためのグラフェンナノシート上のMoS2ナノフレークの温度依存性結晶化
- ナノカーボンフィラーの電界支援配向による複合材料の電気的性質
- スーパーキャパシターの電極材料としての階層的多孔質構造を持つ単分散カーボンナノスフェア
- 平面ヘテロ接合太陽電池用の順次蒸気成長ハイブリッドペロブスカイト
- 後部に黒色シリコン層を備えた結晶シリコン太陽電池の調査
- ハイブリッド全誘電体-グラフェンメタ表面に基づく制御可能な複屈折を備えた偏光変換器
- 二重ドラッグデリバリーのためのナノリポソームベースのシステムの物理化学的特性に関する調査



