NiO /β-Ga2O3ヘテロ接合に基づく高性能深紫外線光検出器
要約
紫外線(UV)光検出器は、防衛技術から光通信まで幅広い用途があるため、幅広い関心を集めています。ワイドバンドギャップ金属酸化物半導体材料の使用は、その独自の電子的および光学的特性により、UV光検出器の開発において非常に興味深いものです。この作業では、NiO /β-Ga 2 に基づく深紫外線光検出器 O 3 ヘテロ接合が開発され、調査されました。 β-Ga 2 O 3 層はマグネトロンスパッタリングによって調製され、アニーリング後に(\(\ overline {2} \)01)結晶面のファミリーに沿って選択的な配向を示しました。光検出器は、高い応答性( R )で優れた性能を示しました )of 27.43 AW -1 245 nmの照明下(27μWcm -2 )および最大検出率( D *)3.14×10 12 の cmHz 1/2 W -1 、これはp-NiO /n-β-Ga 2 に起因していました O 3 ヘテロ接合。
背景
ミサイル警報、生化学的分析、火炎およびオゾン検出、光通信などの幅広い用途のために、紫外線(UV)光検出器の開発に多くの研究関心が寄せられています。 SiCおよびGaN半導体と比較して、ワイドバンドギャップ金属酸化物半導体に基づくUV光検出器には多くの利点があります。たとえば、金属酸化物ベースの光検出器は酸化しにくく、敏感な応答を示します。さらに、操作が簡単で、サイズを小さくすることができます[1、2]。そのため、近年、ワイドバンドギャップ金属酸化物とそのデバイスが多くの研究の注目を集めています。現在まで、ZnO [3,4,5]、TiO 2 などの金属酸化物 [6、7]、SnO 2 [8]、NiO [9]、およびGa 2 O 3 [10、11]は、高性能UV光検出器としての使用が研究されています。その中で、Ga 2 の安定相 O 3 (β-Ga 2 O 3 )は、UVバンドに効果的に応答する〜4.9 eVの超ワイドバンドギャップを備えた直接バンドギャップ半導体であるため、UV光検出器の好ましい材料になりつつあります。材料の容易な成長プロセスは、追加の利点です。
いくつかのグループが、2つの異なる金属酸化物半導体からなるヘテロ接合デバイスを開発することにより、UV光検出器の性能を向上させようと試みました。たとえば、Zhao etal。 ZnO-Ga 2 の研究を報告しました O 3 アバランシェ乗数効果により超高応答性と検出性を示したコアシェルヘテロ構造UV光検出器[12、13]。この作業では、NiO /β-Ga 2 などの別の金属酸化物ヘテロ接合 O 3 は、高性能UV光検出器を提供するために調査されました。まず、β-Ga 2 の格子不整合 O 3 NiOは比較的小さいです。また、NiOのバンドギャップは以前の研究で使用されたZnOのバンドギャップよりも大きい。 NiOおよびn型β-Ga 2 のp型挙動 O 3 NiO /β-Ga 2 の電気的特性の研究に関するいくつかの報告につながっています O 3 パワーエレクトロニクスアプリケーション用のヘテロ接合[14];ただし、光検出器でのヘテロ接合の使用に関する報告は限られています。この研究では、NiO /β-Ga 2 O 3 ベースのUV光検出器は、インジウムスズ酸化物(ITO)透明基板上にマグネトロンスパッタリングによって製造されました。結果は、NiO /β-Ga 2 O 3 光検出器は、UV光(245 nm)に対して優れた感度と安定性を示しました。
メソッド
Ga 2 O 3 NiOセラミックターゲット(99.99%)はZhongnuo Advanced Material(Beijing)Technology Co.Ltdから購入しました。(0001)面のサファイア基板はBeijing Physike Technology Co.Ltdから購入しました。ITOコーティングされた石英基板はBeijingJinjiAomengから購入しました。 Technology Co. Ltd.実験で使用されたすべての化学試薬は、さらに精製することなく使用されました。
β-Ga 2 O 3 フィルムは、室温でのRFマグネトロンスパッタリングによって調製された。特性評価のために、フィルムは(0001)面でサファイア基板上に堆積されました。堆積前に、基板をアンモニア水、過酸化水素、および脱イオン水(1:1:3)の混合溶液で80°Cで30分間ウェット洗浄しました。それを脱イオン水で繰り返しすすぎ、窒素を使用して乾燥させて表面の汚れを除去しました。これにより、基板上のフィルムの均一性と接着性が向上します。スパッタリングは、0.7 Paの圧力で、酸素とアルゴンをそれぞれ5と95sccmの速度で流しながら実行しました。膜の堆積には、200Wのスパッタリングパワーを60分間使用しました。最後に、堆積した膜を空気中で800°C(60分)、10°C /分の加熱速度でアニールしました。
Ga 2 の結晶構造 O 3 フィルムは、X線回折(XRD、EMPYREAN)および透過型電子顕微鏡(TEM、JEM-2100)を使用して研究されました。 Ga 2 の吸収スペクトル O 3 サファイア基板上のフィルムは、UV-Vis分光法(iHR-320)によって測定され、フィルムの光学バンドギャップの推定も提供されました。堆積したGa 2 の表面形態と厚さ O 3 原子間力顕微鏡(AFM、SPA-400)と光学顕微鏡(LEICA DM 2700 M)を使用してフィルムの特性を調べました。 Ga 2 の元素分析 O 3 フィルムは、X線光電子分光法(XPS、K-Alpha +)によって実行されました。電流-電圧( J - V )NiO /β-Ga 2 での測定 O 3 光検出器は、Keithley2400ソースメーターを使用して実行されました。すべての測定は室温で行われました。
結果と考察
図1aは、Ga 2 のXRDパターンを示しています。 O 3 アニーリングの前後にサファイア基板の(0001)面に成長した膜。アニーリング前は、基板に関連する2つのピーク(「*」でマーク)のみがパターンに観察されたため、堆積したままの膜はアモルファス状態を示しました。 800°Cでフィルムをアニーリングした後、XRDパターンはGa 2 のβ相の結晶面に対応する6つの特徴的なピークを示しました。 O 3 、単斜晶系に属します。観察されたパターンは、以前に報告された研究[15、16]と一致しています。アニーリングされたβ-Ga 2 のこれらの特徴的なピーク O 3 フィルムは、(\(\ overline {2} \)01)結晶面のファミリーに沿って優先配向した良好な結晶化度を示しました。
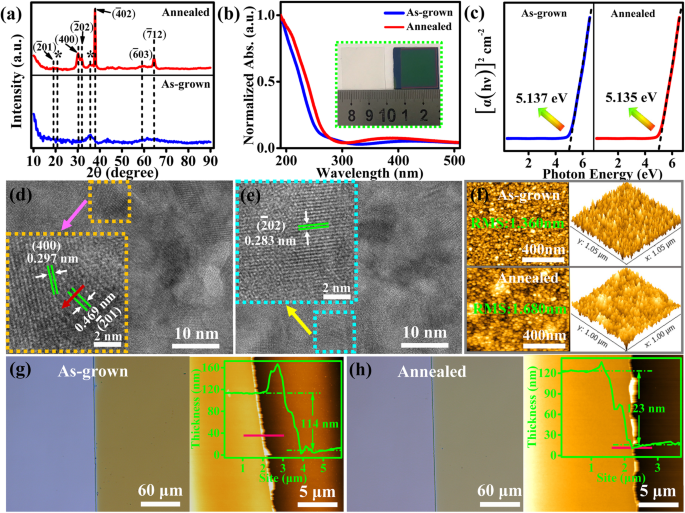
a β-Ga 2 のXRDパターン O 3 サファイア基板(0001)面に膜が堆積し、サファイア基板のピークはアスタリスク(*)でマークされています。 b β-Ga 2 のUV-Vis吸収スペクトル O 3 映画。 c [α(hν )] 2 対光子エネルギー。 d–e β-Ga 2 のTEMおよびHRTEM画像 O 3 アニーリング後のフィルム。 f β-Ga 2 のAFM画像 O 3 映画。 g–h フィルムと基板の間のステップエッジでの光学画像とAFM画像
図1dとeは、β-Ga 2 のTEMおよびHRTEM画像です。 O 3 アニーリング後のフィルム。示されているように、(\(\ overline {2} \)01)、(400)、および(\(\ overline {2} \)02)結晶面の格子縞間隔は4.69Å、2.97Å、および2.83Åでした。 、それぞれ、これも良好な結晶化度を示唆しており、以前に報告された文献[17、18]の研究とよく一致しています。
β-Ga 2 のAFM画像 O 3 サファイア基板上に堆積された膜を図1fに示します。堆積したままの膜は、1.36 nmの比較的小さな二乗平均平方根(RMS)表面粗さを備えた均一な粒状表面トポグラフィーを示しました。アニーリング後、フィルムのRMS粗さは1.68nmに増加しました。アニーリング後のRMS粗さのこのような増加は、Hao et al [19]によっても報告されました。アニーリング処理により、表面構造に欠陥が生じる可能性があります。アニーリング後の表面形態の変化の原因を理解するには、さらなる研究が必要です。アニーリング前後のフィルムと基板の間のステップエッジのAFMトポグラフィー画像を図1gとhに示します。これらのラインプロファイル(挿入図)は、114±6.4nmと123±2.0nmの膜厚を示しています(挿入図)。それぞれ約8%の増加)。アニーリング後の膜厚とRMSの増加は、アモルファスから結晶化度への相転移がナノ結晶粒子の成長につながる可能性があります。
β-Ga 2 のUV-Vis吸収スペクトル O 3 アニーリング前後のフィルムを図1bに示します。どちらのフィルムも、190〜300 nmの範囲で強いUV吸収を示し、可視光帯域ではほとんど吸収しませんでした。これは、アニーリング処理が吸収端に有意な影響を及ぼさなかったことを示した。吸収ピークがわずかに増強されただけで、約10nmの小さな赤方偏移が生じました。式(1)は、光学バンドギャップエネルギー( E )を推定するために使用できます。 g)映画の。
$$ \ alpha \ left(h \ nu \ right)=A {\ left(h \ nu -E \ mathrm {g} \ right)} ^ {1/2} $$(1)ここでα は吸収係数、hν は光子エネルギーであり、 A 定数です。 AFMで測定された膜厚を考慮して、 E 堆積されたままの膜とアニールされた膜のgは、それぞれ5.137eVと5.135eVの値を示した図1cのプロットから決定できます。これらの値は、理論上の E に近い値です。 β-Ga 2 のgは4.9eV O 3 。
β-Ga 2 のXPSスペクトル O 3 フィルムを図2に示します。図2a–cおよびd–fは、アニーリング前後のフルスキャン、GaおよびO元素のXPSスペクトルをそれぞれ示しています。フルスキャンで観察されたC元素は偶発的な炭素でした。アニーリング後、C 1のピークは大幅に減少し、アニーリング処理中にほとんどの炭素が除去されたことを示しています。図2bとeのGa3dの結合エネルギーはそれぞれ21.14eVと20.70eVに対応し、サンプルのGa-O結合に対応し、アニーリング後の結合エネルギーは0.44eV減少します。 O 1のピークには、酸素空孔(O V )に関連する2つの成分が適合していました。 )および格子酸素(O L )。 O V の面積比 およびO L (例:S OV :S OL) アニーリングの前後はそれぞれ0.47と0.12でした。これは、酸素原子が適切な格子サイトに移動するときに結晶化につながるアニーリング処理による格子酸素原子の増加を示唆しています。

β-Ga 2 のXPSスペクトル O 3 映画。アニーリング前に取得されたサーベイスキャン、Ga 3d、およびO1sコアレベルのピークを a–c に示します。 アニーリング後は d–f に表示されます 、それぞれ
β-Ga 2 で構成されるUV光検出器 O 3 フィルムが製作されました。光検出器用に、ITO / NiO / Ga 2 で構成される単純な垂直構造を設計しました。 O 3 / Al。デバイス構造の概略図を図3aに示します。 NiO層は、サファイア基板と同じウェットクリーニング手順を適用した後、ITOコーティングされた石英基板上に最初にスパッタリングされました。NiO膜の詳細な準備と特性は、追加ファイル1:図S1と図S2に示されています。 Ga 2 O 3 次に、上記の堆積パラメータを使用して層をスパッタした。準備されたヘテロ接合は、ITOへの加熱による損傷を避けるために、600°Cで30分間空気中でアニーリングされました(β-Ga 2 O 3 550°Cを超えるアニーリング温度で形成でき、続いてAl電極の蒸着(2×2 mm 2 )Ga 2 の表面 O 3 映画。最後に、Al電極とITO基板をそれぞれ上部電極と下部電極として使用しました。

a ITO / NiO /β-Ga 2 からなるデバイス構造を示す概略図 O 3 / Al。 b 光検出器のエネルギーバンド図。 c–d 測定された J-V J-V をログに記録します それぞれ、異なる波長の光で、暗い条件下で照らされた光検出器の曲線。 e–f 測定された J-V J-V をログに記録します それぞれ、異なるパワー密度で245nmのUV照明下での光検出器の曲線。 g–h 応答性( R )および検出性( D *)それぞれ、245nmの光照射下での異なるバイアス電圧での光検出器の
図3bは、光検出器のエネルギーバンド図を示しています。 E を計算しました 式(1)によるNiO膜のg。 (1)追加ファイル1に示すように:図S3。 E NiO膜のgはアニーリング後約3.4eVです。 β-Ga 2 のワイドバンドギャップエネルギー O 3 (5.1 eV)およびNiO(3.4 eV)層はUV光に反応します。 UV照明下(hν )、電子は伝導帯に移動するのに十分なエネルギーを獲得し、電子正孔対を生成します。これらの光生成された電子正孔対は、内蔵電場によって分離され、それぞれの電極によって収集されました。ここで、適切なバンドアラインメントを備えたヘテロ構造により、電荷の分離と収集が容易になります。
ヘテロ接合光検出器の性能は、測定された J から研究されました。 - V J をログに記録します - V バックライト入射デバイスから取得されたプロット。図3cとdは、 J を示しています。 - V J をログに記録します - V それぞれ異なる波長の光と暗い条件下で照らされた光検出器の曲線。光検出器が27μWcm -2 の245nmUV光で照らされたとき 、最大1.38 mAcm -2 の電流密度の大幅な増加 は、10Vの印加電圧で観察されました。電流密度は、285および365nmのUV光で照射された場合にも増加します。ただし、他の2つのUV光と比較して、245 nmのUV光によってより多くの電子正孔対を効果的に励起できるため、デバイスの深いUV検出が示されます。
J - V J をログに記録します - V 光検出器の曲線は、それぞれ図3 eとfに示すように、さまざまなパワー密度で245nmのUV照明の下で測定されました。測定は、暗所および紫外線条件下で実施された。電流密度は、245 nmのUV照明下での光強度とともに増加します。これは、光検出器が245nmのUV光に応答して光電流を生成する能力を持っていることを示唆しています。
応答性に対するバイアス電圧の影響( R )のデバイスを図3gに示します。 R 光電流密度( J ph )式によると(2)[5]:
$$ R ={J} _ {\ mathrm {ph}} / {P} _ {\ mathrm {opt}} $$(2)ここで P opt は、1.5 mWcm -2 の値を持つ光子パワー密度です。 。 R の増加 固定光子パワー密度の下でデバイスのバイアス電圧が増加するにつれて、図3gから明らかでした。最大 R 27.43 AW -1 でした 245 nmの照明(27μWcm -2 )で測定 )バイアス電圧10Vで。
検出性( D *)は、光検出器の性能を評価するためのもう1つの重要なパラメータです。 D *光検出器の*は、式(1)を使用して計算できます。 (3)次のように[20、21]:
$$ {D} ^ {\ ast} =R / {\ left(2q \ left | {J} _ {\ mathrm {d}} \ right | \ right)} ^ {1/2} $$(3)ここで、 q は絶対電子電荷(1.602×10 -19 C)および J d 暗電流密度です。 D 間の関係 *バイアス電圧を図3hに示します。これは、 D の増加を示しています。 *バイアス電圧が増加するにつれて。最大 D *は3.14×10 12 でした cmHz 1/2 W -1 245 nmの照明(27μWcm -2 )で測定 )バイアス電圧− 10Vで。 R の値に基づく および D *、NiO /β-Ga 2 O 3 光検出器は、他のNiOベースおよびGa 2 と比較して、UV検出で高いパフォーマンスを示しました。 O 3 表1に示すベースのUV検出器。
<図>結論
結論として、β-Ga 2 O 3 フィルムはRFマグネトロンスパッタリングによって作成され、800°Cでのアニーリング後に良好な結晶化度を示しました。ワイドバンドギャップ材料は、190〜300nmの範囲で強いUV吸収を示しました。 NiO /β-Ga 2 に基づく深紫外線光検出器 O 3 ヘテロ構造は、応答性の高い245 nmのUV光に非常に敏感でした( R )および検出性( D *)最大27.43 AW -1 および3.14×10 12 cmHz 1/2 W -1 、 それぞれ。ドーピングまたはデバイス構造の最適化により、UV光検出器の性能をさらに向上させることができると考えられています。
データと資料の可用性
この原稿でなされた結論は、この論文で提示され示されているデータ(本文と図)に基づいています。
略語
- AFM:
-
原子間力顕微鏡
- ITO:
-
インジウムスズ酸化物
- TEM:
-
透過型電子顕微鏡
- UV:
-
紫外線
- XPS:
-
X線光電子分光法
- XRD:
-
X線回折
ナノマテリアル
- Nano書記素、シリコンベースの柔軟な透明メモリ
- NiO光電陰極に及ぼすポリエチレングリコールの影響
- 誘電体ナノプリズムに基づくプラズモンセンサー
- 中空多孔質NiOに基づく高感度の非酵素的電気化学的グルコース検出
- SnO2-TiO2ナノメイスアレイに基づく高性能セルフパワーUV検出器
- 単一のCdSSeナノベルトに基づく波長制御光検出器
- グラフェン量子ドットで装飾されたZnOナノロッド/ GaN膜アイソタイプヘテロ接合に基づく高性能紫外線光検出器
- PAVL基板に埋め込まれた低コストの柔軟なZnOマイクロワイヤアレイ紫外線光検出器
- AlGaNベースの深紫外線発光ダイオード用のp-AlGaN / n-AlGaN / p-AlGaN電流拡散層について
- 異なる温度でのAlGaN深紫外線発光ダイオードのエレクトロルミネッセンス特性に及ぼす量子井戸幅の影響
- 高性能ペロブスカイト光検出器用の溶液処理三層構造



