原子層堆積によるZnO薄膜成長の酸化剤前駆体としてのオゾンと脱イオン水の同時投与
要約
3パルスオゾン(O 3 )がある場合とない場合のサファイア基板上の原子層堆積(ALD)成長ZnO薄膜の特性 )酸化剤前駆体および堆積後熱アニーリング(TA)として調査されます。 ZnOエピ層の堆積温度と厚さはそれぞれ180°Cと85nmです。堆積後の熱アニーリングは、酸素(O 2 )の環境下で300°Cで実行されます。 )1時間。強力な酸化剤O 3 成長中のZnOの堆積後のTA、固有のひずみと応力は、それぞれ0.49%と2.22 GPaに減少し、バックグラウンド電子濃度は非常に低くなります(9.4×10 15 cm -3 )。これは、フォトルミネッセンス(PL)スペクトルの積分強度の熱消光の分析における熱活性化欠陥の密度が低いことに起因します。 TAはさらに再結晶を促進し、欠陥のない粒子を形成し、ひずみと応力状態を低減して、電子濃度を著しく低下させ、表面粗さを改善します。
はじめに
いくつかの酸化剤がZnOの成長に使用されます。それらには水が含まれます(H 2 O)、過酸化水素(H 2 O 2 )、酸素(O 2 )、およびオゾン(O 3 )[1,2,3,4,5,6]。 H 2 Oは、原子層堆積(ALD)を伴うZnOの成長に一般的に使用される酸化剤です。 ALDは、レイヤーごとの自己制限的な成長メカニズムです。比表面積リガンドは、それぞれの前駆体の連続的なパルスと反応を交換します。表面の反応部位が完全に枯渇すると、表面反応は停止して飽和します。薄膜のALD成長には、表面と側面領域への優れたコンフォーマル蒸着、エッジの優れたステップカバレッジ、広い領域での高い均一性、層の厚さ制御の精度、低蒸着温度に適しているなどの利点があります[7,8,9]。 。
強力な酸化剤は、材料構造だけでなく、ALD蒸着ZnOの光電気特性にも影響を与えます。 H 2 O 2 酸化剤は、一般的に使用されるH 2 よりも酸素が豊富な条件を提供します 欠陥のある酸素空孔を不動態化するO前駆体(V O )および亜鉛格子間原子(Zn i )80〜150°Cの低成長温度でALD成長したZnO膜で。酸化剤の使用がH 2 から変更された場合、成長面の(002)優先配向を伴う柱状表面形態が発生しました。 OからH 2 O 2 [2]。 H 2 O 2 酸化剤は、O 3 を使用する場合と比較して、成長率を約70%増加させます。 200°CでALD成長したZnOのガス反応物。膜の成長面でのヒドロキシル(OH)基密度の上昇は、成長速度の増加の原因です[3]。純粋なO 2 を使用した場合のZnOの成長率の約60%の増加 H 2 の代わりに 酸化剤としてのOも報告されています[4]。
O 3 は、ALDで成長した酸化物材料の効果的な酸化剤です。 O 3 の高い電気化学ポテンシャル 低い成長温度で速い反応速度を引き起こします。 O 3 H 2 よりも揮発性が高い O、H 2 O 2 、およびO 2 、およびパージが簡単です。したがって、各サイクルのパージ時間を短縮することができます。 O 3 に水素がない 分子は、成長中の水素とヒドロキシルの汚染を減らします。 ZnOの再結合表面損失による厚さの均一性の低下は、10秒のO 3 で示されています。 成長が200°Cのときの曝露時間[5]。 O 3 を含むALDで調製されたドープされていないZnO膜 酸化剤は、H 2 のサンプルと比較して2倍の熱電力率を示します。 O酸化剤。 H 2 O-およびO 3 -成長したZnO膜は、V O と同じ欠陥レベルを持っています しかし、異なるZn関連の欠陥レベル。 O 3 の十分な酸化力 その結果、ネイティブZn i の含有量が低くなります したがって、熱電力率が大きくなります。 O 3 の強力な酸化効果 ドープされていないZnO膜の熱電性能を向上させます[6]。 O 3 の同時投与 およびH 2 Oは、適切なALDプロセスのためにZnO薄膜の均一性と適合性を改善する可能性があります[5]。
内因性および外因性のひずみは、サファイア基板上に自然に成長したZnO膜に存在します。固有のひずみは、ZnOの高密度の結晶学的欠陥に起因します。結晶学的欠陥には、水素錯体、亜鉛格子間原子(Zn i )が含まれます )、酸素空孔(V O )、貫通転位(TD)、および粒界(GB)[10,11,12,13,14,15,16,17,18,19,20,21]。外因性ひずみは、ZnOエピ層とサファイア基板間の格子定数と熱膨張係数の大きな不一致から発生します。サファイア上のZnO材料の内因性および外因性ひずみを減少させるために、さまざまな方法が実行されます。薄いMgOバッファ層は、外因性歪みを低減し、表面粗さを58.8%低減し、サファイア上のZnO薄膜の表面クラックを抑制することができます[22]。サファイア上のZnOの外因性ひずみは完全に緩和され、550°Cでのマグネトロンスパッタ堆積によって調製された厚さは30nmに達します[23]。ガラス基板温度が350℃から450℃に上昇するスプレー熱分解法で堆積したZnO膜の1.77から1.47GPaへの圧縮応力の緩和が見られます[24]。
1パルス前駆体(DEZnおよびH 2 )を使用して180°Cで成長させたALD ZnO O)バックグラウンド電子濃度が〜10 18 と高いことを示しています cm -3 堆積後のTAでも[25]。一般的に使用される1パルスH 2 ALDプロセスのO前駆体は、酸素原子の理想的な単分子層を生成しません。 3パルス前駆体(DEZnおよびH 2 O)前駆体分子と表面配位子との複数のヒットまたは衝突を生成して、低温100°Cで成長したALDZnOの反応確率を促進する可能性があります。 「3つの」パルスの選択は、開いた化学吸着または反応サイトを適切に配置する反応物の確保に役立ちます。非常に低いバックグラウンド電子濃度8.4×10 14 cm -3 、高い電子ドリフト移動度62.1 cm 2 / Vs、および適切なバッファ層とRTA条件を備えた3パルス前駆体ZnOのバンドギャップ付近のエッジ(NBE)フォトルミネッセンス(PL)の顕著な増強が得られます[26]。いくつかの報告は、熱アニーリングによるZnO薄膜およびZnO / ZnMgO多重量子井戸の材料品質の向上を示しています[27、28]。このレポートでは、3パルスのO 3 その後の1パルスH 2 ALDサイクルあたりの酸化剤としてのOは、180°CでZnO薄膜を成長させるために使用されます。堆積後熱アニーリング(TA)は、サンプルの結晶品質を改善するために適用されます。 ALDで成長させたZnO薄膜の材料のマイクロおよびナノ構造、フォトルミネッセンス、およびホール効果の特徴を調査します。
実験方法
ZnOエピ層は、従来のc面サファイア(c-Al 2 O 3 )Cambridge NanoTech Savannah 100ALDシステムによる基板。 ALD ZnO薄膜の成長において、脱イオン(DI)H 2 を含む前駆体 O、O 3 、およびジエチル亜鉛(DEZn、Zn(C 2 H 5 ) 2 )を利用します。表1に、O 3 のパルス数の条件を示します。 A、B、Cという名前の3つの試料の堆積後のTA。サンプルのALDサイクルあたりの時間によるパルスシーケンスの概略図を図1に示します。この図では、1つのALDサイクルに6つの連続したステップが含まれています。最初のステップは、1パルス脱イオン(DI)H 2 の注入です。 Oをメートルスケールの反応器に入れて、サファイア上にヒドロキシル(OH)で終端された表面を作成するか、ぶら下がっているエチル基(C 2 H 5 )ヒドロキシル表面基を持つZn表面に亜鉛-酸素(Zn–O)ブリッジを形成します。酸素(O)の1つの原子層が生成されます。 2番目のステップは、高純度窒素ガス(N 2 )のパージです。 )過剰な前駆体分子と揮発性副生成物を除去し、反応物の各曝露後の後続の前駆体の混合を防ぐため。 3番目のステップは、3パルスのO 3 の注入です。 ネイティブ欠陥の削減を容易にするために原子炉に。 4番目のステップは、N 2 によるチャンバーのパージです。 ガス。 5番目のステップは、1パルスのDEZnを反応器に注入して、酸素層上に亜鉛(Zn)の1つの原子層を生成することです。最後のステップは、N 2 によるチャンバーのパージでもあります。 ガス。キャリーガスN 2 を介して反応チャンバーにパルスされる前駆体 チャンバー圧力4×10 -1 トル。反応物DIH 2 の曝露時間の最適条件 O、O 3 、およびDEZnは、それぞれ0.01、0.5、および0.015sです。チャンバーの排気のパルス時間は5秒です。 ZnO薄膜の厚さは85nmで、各サンプルのALDサイクルは500回です。堆積パラメータの他の好ましい条件は、以前のレポート[29]に示されています。 O 2 の環境での300°Cでの堆積後のTA 炉内で1時間、サンプルCで処理されます。
<図>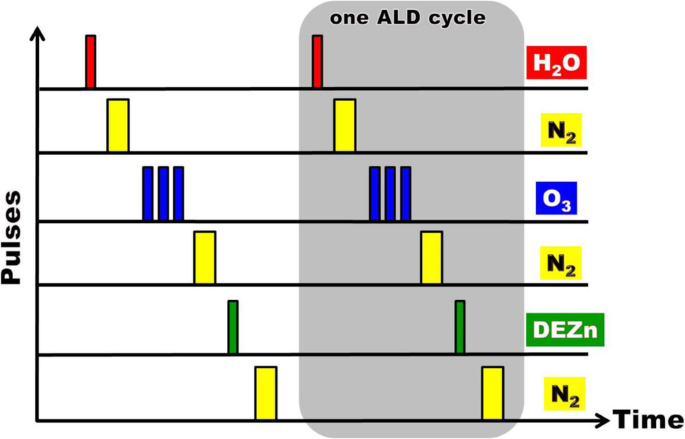
パルスシーケンスH 2 のサファイア基板上にALD成長したZnO膜 O / N 2 / O 3 / N 2 / DEZn / N 2 DI水を使用して、O 3 、およびZn(C 2 H 5 ) 2 前駆体として
サンプルの材料の構造的、光学的、および電気的特性は、以下の測定によって行われます。 X線回折(XRD)パターンは、回折角(2 θ)で測定されます。 )機器D2フェイザー(Bruker Corporation)を使用して、33〜38°の範囲で、銅Kα放射の波長0.154nm。ホール効果測定はEcopiaHMS-3000システムを使用し、試験片は0.7×0.7 cm 2 のサイズ領域を持つ正方形にカットされます。 。試験片の四隅は、ファンデルパウ構成のオーミック接触を示す小さなインジウムブロブによってはんだ付けされています。フィルムのシートキャリア密度、移動度、抵抗率を測定します。フォトルミネッセンス(PL)スペクトルは、励起波長325 nm、出力55 mWのHe–Cdレーザーを使用して10〜300Kで実行されます。温度の上昇に伴うPLスペクトルの積分強度の熱消光を分析します。原子間力顕微鏡(AFM)の高解像度画像から調べた標本の表面の質感と粗さは、Veeco Dimension3100の機器によって取得されます。
結果と考察
図2は、XRDパターンの測定による試料の結晶性を示しています。 2つのブラッグ回折ピーク(002)と(101)は、ZnOの六角形のウルツ鉱型構造に対応します。 XRDパターンの最も強いピーク強度は、サンプル間のピーク強度を比較するために正規化されています。上部の水平軸に示されている2つの緑色の矢印は、粉末回折に関する合同委員会の組織によってリリースされた材料データセットから取得された歪みのないバルクZnOの(002)と(101)のそれぞれ34.4°と36.2°の回折角を示しています。標準(JCPDS)。この図では、サンプルBとCの(002)と(101)のピークが観察され、歪みのないバルクZnOの(002)と(101)の回折角にさらに近づいています。

試料の(002)および(101)方向に沿った結晶配向を持つZnO膜のXRDパターン。矢印は、バルクZnOの(002)と(101)の回折角34.4°と36.2°をそれぞれ示しています。
c に沿った二軸ひずみ -エピタキシャル層の軸は、歪みのないバルクZnOとは対照的に、(002)に沿ったXRDパターンのシフトによって取得できます。平均ひずみ(ε z )ZnO膜の格子定数は、次の式を使用して格子定数から推定されます。
$$ {\ varepsilon} _z =\ frac {c- {c} _0} {c_0} \ times 100 \%$$(1)ここで c および c 0 c に沿った格子定数です -ZnO膜とバルクの(002)ピークのブラッグの回折角から計算された軸。平均応力(σ )フィルムの平面では、2軸ひずみモデルを使用して計算できます:
\(\ sigma =\ frac {2 {c} _ {13} ^ 2- {c} _ {33} \ left({c} _ {11} + {c} _ {12} \ right)} {c_ {13}} \ times {\ varepsilon} _z =-453.6 \ times {\ varepsilon} _z \ left(\ mathrm {GPa} \ right)\)(2)ここで c 11 =209.7 GPa、 c 12 =121.1 GPa、 c 13 =105.1 GPa、および c 33 =210.9 GPaは、バルクZnOの弾性剛性定数です。表1では、ひずみ/応力(ε z / σ )A、B、およびCサンプルの)は、それぞれ1.08%/ 4.90 GPa、0.74%/ 3.37 GPa、および0.49%/ 2.22GPaです。サンプルBおよびCでは、ひずみ/応力が減少し、さらに減少します。
サンプルの10〜300 Kのさまざまな温度でのPLスペクトルを図3に示します。すべてのサンプルのPLスペクトルでは、スペクトルピークエネルギーが約3.34eVの励起子の強い近バンドエッジ放射再結合が支配的です。縦光学(LO)フォノン支援発光は、サンプルのPLスペクトルの低エネルギーショルダーで観察されます。図4a–cでは、PLスペクトルの積分強度と温度の逆数のアレニウスプロットを示しています。温度の上昇に伴うPLの積分強度の熱消光は、次のアレニウスの式で近似できます。
$$ I(T)=\ frac {A} {1+ {D} _ {nr1} \ exp \ left(\ frac {-{E} _ {A1}} {k _ {\ mathrm {B}} T} \ right)+ {D} _ {nr2} \ exp \ left(\ frac {-{E} _ {A2}} {k _ {\ mathrm {B}} T} \ right)} $$(3)ここで私 ( T )は、統合されたPL強度を表します。 A 定数です。 D nr 1 および D nr 2 非放射再結合中心の密度に関連する定数です。 E A 1 および E A 2 は、それぞれ低温でのドナー結合励起子と高温での自由励起子の非放射再結合プロセスに対応する活性化エネルギーです。 k B ボルツマン定数です。回帰分析の最小二乗法を使用して、 D のパラメーターを示すデータを近似します。 nr 1 、 D nr 2 、 E A 1 、および E A 2 表2および図4a–cに赤いフィッティング曲線があります。フィッティングの結果は、 D のバリエーションが nr 1 、 E A 1 、および E A 2 サンプルの中には軽いものがあります。 D nr 2 は、サンプルA、B、Cのそれぞれ132.7、153.6、110.8であり、欠陥密度の量に大きな違いがあります。 D の最小値 nr 2 サンプルCで熱的に活性化された欠陥の密度が最も低いことを示唆しています。
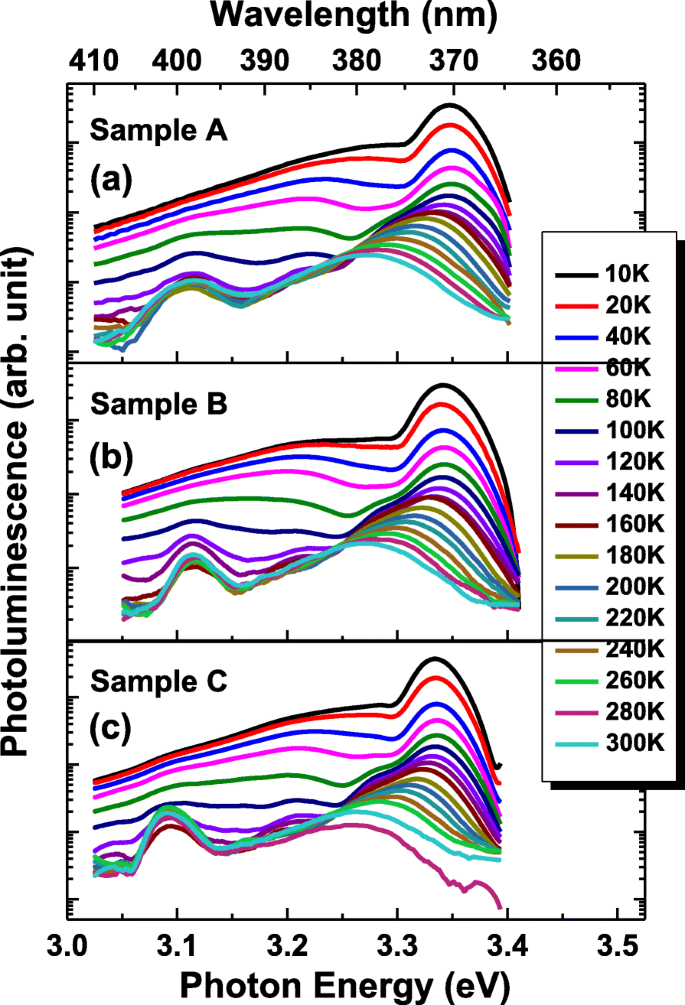
a – c 試料の温度依存PLスペクトル
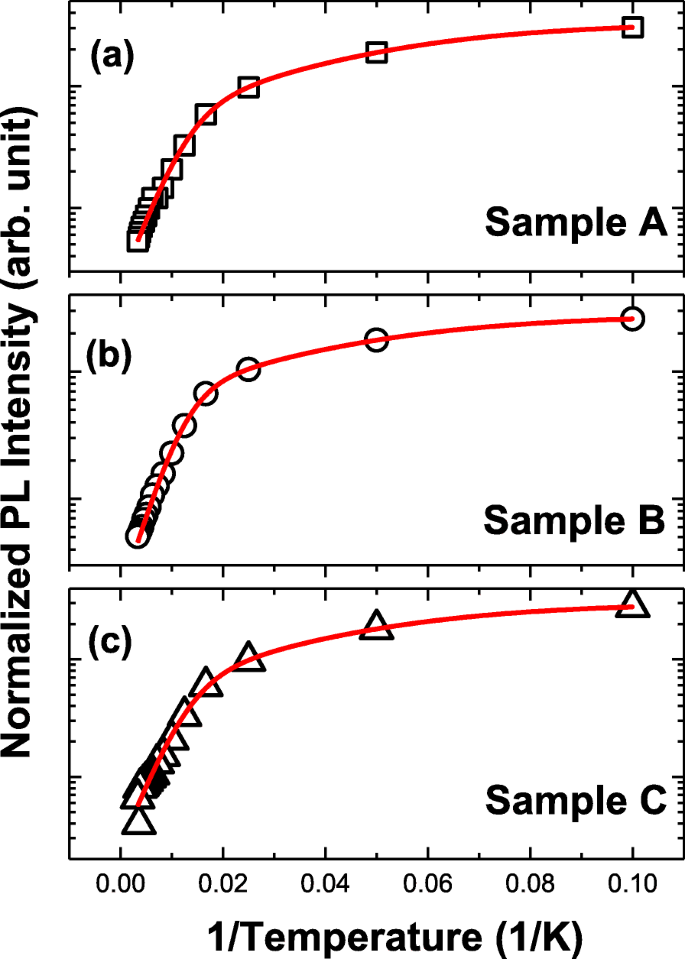
a – c PLスペクトルの積分強度の熱消光のアレニウスプロットとサンプルの赤フィッティング曲線
サンプルのホール効果測定のバックグラウンド電子濃度、移動度、および抵抗率を表2に示します。サンプルBでは、サンプルAと比較して、移動度の低下に伴うキャリア濃度の2桁の減少が示されています。キャリア濃度のさらなる大幅な減少最小値の9.4×10 15 cm -3 移動度が6.1cm 2 に上昇します。 / Vsは、サンプルBと比較してサンプルCで観察されます。電子濃度が最小になるのは、ひずみ/応力状態の緩和が最大であり、サンプルCの固有の欠陥密度が著しく減少しているためです。
図5a–cおよびd–fは、標本の2Dおよび3DAFM画像です。表2に示すように、A、B、およびCの二乗平均平方根(RMS)粗さは、それぞれ1.92、4.30、および2.18 nmです。サンプルAで最も低い表面テクスチャ粗さが発生しました。O 3を使用した場合 サンプルBの前駆体では、表面粗さが増加します。 ALD ZnO膜の空間的均一性の低下は、O 3 の表面損失によるものです。 [21]。 O 3 の表面損失 反応制限成長から再結合制限成長への移行に関連しており、膜を破壊するための主要な原子損失チャネルを構成して、厚さの均一性を低下させる可能性があります。これは、図2のサンプルBの(002)に沿った回折ピーク強度の減少と相関しています。サンプルCの堆積後TAの処理により、表面の均一性が改善されます。一方、バックグラウンド電子濃度の劇的な減少と移動度の増加が達成されます。熱アニーリングは結晶格子の移動を引き起こします。したがって、冶金学的再結晶が起こります。再結晶は、ひずみ/応力の強度の低下と固有の結晶格子の欠陥を伴います。したがって、より良い品質のZnO薄膜が得られます。この結果は、サンプルCのXRDパターンの2つの回折ピーク強度の向上と一致しています。電子の移動度は、不純物、格子、欠陥などの散乱源の影響を受ける可能性があることに注意してください。その散乱源は平均電子速度を変える可能性があります。一般に、欠陥密度の低下、したがって電子濃度の低下は、移動度の上昇につながります。このレポートでは、オゾン前駆体の投与による表面テクスチャの粗さの増加により、サンプルCの電子移動度がAよりも低くなる可能性があります。図6では、異なる色の3つの三角形を含むピラミッド図が3つの主要な成長を示しています。このレポートでは、高品質のALDZnOエピ層を実現するための処理条件。
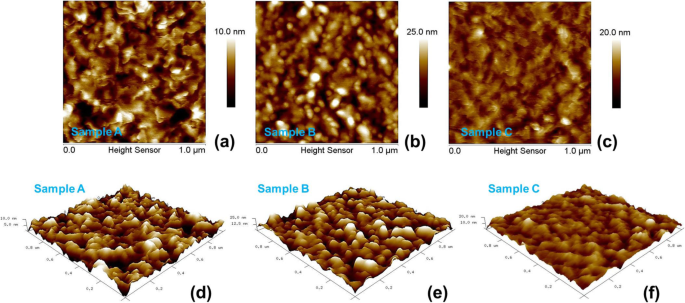
a – c 2Dおよび d – f 標本の3DAFM画像。 2D画像の高さのスケールは、右側のカラーバーに表示されます

ピラミッド図。ピラミッドでは、4つの三角形が異なる色で示されています。ピラミッドの端にある3つの三角形は、ZnOの主要な成長と処理条件を示しています。成長におけるこれらの3つの重要な要素の組み合わせは、ピラミッドの中心にある三角形で示されるALDZnOエピ層の品質を促進します
結論
ワンパルスH 2 Oおよび3パルスの強力な酸化剤O 3 ALDプロセスの前駆体は、ひずみ/応力を減少させる可能性があるため、ZnO薄膜の電子濃度を著しく低下させますが、表面粗さを増加させます。酸素環境(O 2 )での300°Cでの堆積後のTA )1時間の場合、3パルスO 3 を使用して成長させた後、ひずみ/応力が低く、バックグラウンド電子濃度が低く、表面粗さが改善された、欠陥のない粒子の形成がさらに促進されます。 前駆体。 0.49%/ 2.22GPaおよび9.4×10 15 である最低のひずみ/応力およびバックグラウンド電子濃度 cm -3 それぞれ、ALD成長したZnO薄膜の固有の固有欠陥が劇的に減少するために達成されます。
データと資料の可用性
この研究の結果を裏付けるデータは、合理的な要求に応じて、対応する著者(Yung-Chen Cheng)から入手できます。
略語
- ALD:
-
原子層堆積
- O 3 :
-
オゾン
- TA:
-
熱アニーリング
- O 2 :
-
酸素
- PL:
-
フォトルミネッセンス
- H 2 O:
-
水
- H 2 O 2 :
-
過酸化水素
- OH:
-
ヒドロキシル
- Zn i :
-
亜鉛インタースティシャル
- V O :
-
酸素空孔
- TD:
-
貫通転位
- GB:
-
粒界
- NBE:
-
バンドギャップエッジの近く
- c-Al 2 O 3 :
-
c-フェイスサファイア
- DI:
-
脱イオン化
- C 2 H 5 :
-
エチル基
- N 2 :
-
窒素ガス
- Zn:
-
亜鉛
- XRD:
-
X線回折
- AFM:
-
原子間力顕微鏡
- RMS:
-
二乗平均平方根
ナノマテリアル
- マイクロLEDおよびVCSEL用の高度な原子層堆積技術
- 原子層堆積によって製造されたPtおよびTiNコーティング基板上のHfO2 / TiO2 / HfO2三層構造RRAMデバイスのバイポーラ抵抗スイッチング特性
- プラズマ化学原子層堆積によるその場で形成されたSiO2中間層を有するHfO2 / Geスタックの界面、電気、およびバンド整列特性
- 原子層堆積と水熱成長によって製造された抗菌性ポリアミド6-ZnO階層型ナノファイバー
- プラズマ化学原子層堆積によって調製されたCo3O4被覆TiO2粉末の光触媒特性
- 界面層の設計によるZnO膜の表面形態と特性の調整
- 超循環原子層堆積によるZnO膜のフェルミ準位調整
- 原子間力顕微鏡によるポリスチレン薄膜の接着力とガラス転移の研究
- ITO / PtRh:PtRh薄膜熱電対の調製と熱電特性
- PECVDによる低欠陥密度nc-Si:H薄膜の堆積のための便利で効果的な方法
- c面GaN上に堆積した原子層AlNの界面および電気的性質への厚さ依存性



