アニーリングされたGaAsBi / AlAs量子井戸のビスマス量子ドット
要約
330°Cの基板温度で分子線エピタキシーによって成長し、750°Cでアニールされた成長後のGaAsBi層でのビスマスナノ結晶の形成が報告されています。厚さ10nmのGaAsBi層とAlAs層を交互に含む超格子を、半絶縁性のGaAs基板上に成長させました。 AlAs層は、Bi原子の拡散バリアとして機能し、サンプルのアニーリング後に核形成したナノクラスターのサイズは、ビスマイド層の厚さと相関していました。エネルギー分散型分光法とラマン散乱測定により、ナノ粒子は主にBi原子から構成されていることが証明されています。アニーリング後、1.3〜1.7μmの範囲の光子波長を持つ強いフォトルミネッセンス信号が観察されました。その振幅は、GaAsBi層の数の増加に伴ってスケールアップしていました。観察されたフォトルミネッセンスバンドは、Biナノ結晶からの発光に起因する可能性があります。実行された理論的推定は、この仮定を裏付けています。彼らは、量子サイズ効果により、Biナノ粒子が直接バンドギャップ半導体状態への遷移を経験することを示しています。
背景
GaAsBiベースのヘテロ構造は、近赤外領域から中赤外領域に及ぶ広いスペクトル範囲でのオプトエレクトロニクスアプリケーションに大きな可能性を秘めています。 GaAsBiは、GaAsベースの赤外線放射エミッター[1]および検出器[2、3、4、5]について活発に研究されているIII-V族半導体化合物です。 〜987 nmの波長(Bi含有量1.8%)で放射するGaAsBi活性層を備えた発光ダイオードは、Lewis etal。によって説明されました。 [6]; GaAsBi / GaAs多重量子井戸(MQW)に約6%のBiを含む電気注入されたビスマイドレーザーは、参考文献に報告されています。 [7]。この分野での主な問題は、Bi含有量が5%を超えるGaAsBi層の分子線エピタキシー(MBE)成長に必要な基板温度が低いため、非放射再結合中心密度が増加することです。非放射再結合率の低減を可能にする標準的な技術手順の1つは、MBE成長に使用される温度よりも高い温度での成長後アニーリングです。ただし、GaAsBiの場合、アニーリングの効果は明白ではありません。私たちのグループ[8、9]は、600°Cを超える温度でのアニーリングがいくつかの新しい機能をもたらすことを以前に示しましたが、その中で最も重要なのは、かなり強いフォトルミネッセンス(PL)のサンプルの一部での開始です。 1.35〜1.5 µmの波長範囲では、このプロセスはGaAsBiエピタキシャル層の大幅な変化を伴います。これは、結晶格子内のBi含有量の減少と、ナノメートルサイズのクラスターの出現です[9]。
ナノ構造(ナノワイヤ、歪んだ量子井戸、または量子ドット(QD))の成長は、基板とその上に成長するエピタキシャル層との間の格子不整合を回避するための一般的な方法です。 III-V化合物に基づくQDの最も広く研究されている例は、Stranski-Krastanow技術[12]によって成長したInGaAs- [10]およびInGaN- [11]ベースのQDです。 GaAsBiの場合、そのような成長メカニズムはまだ実現されていません。アニールされたエピタキシャルGaAsBi層におけるBi関連クラスターの核形成とそれらの構造特性は、参考文献で体系的に研究されています。 [13]。異なる結晶構造と組成のナノクラスター(菱面体晶のAsとBi、および閃亜鉛鉱型のGaAsBiナノクラスター)が、アニーリング時にビスマイド層で核形成することが示されています。サイズは5〜20nmの間で変化します。低温(200°C)で成長した比較的大きなBi含有量(4.7%)のGaAsBiで、純粋なビスマスの菱面体晶クラスターが観察されました[13]。私たちの以前の研究[9]では、ナノメートルサイズのBiクラスターの形成が6%を超えるBi含有量の高温アニールされたGaAsBiで報告されました。さらに、サイズ量子化効果により、ビスマスナノクラスターは半金属ではなく半導体になり(バルクBi結晶の場合のように)、Biクラスターで発生する放射再結合は次のようになると想定されています。アニールされたGaAsBiサンプルで観察される長波長発光の原因です[9]。
本研究は、アニールされたGaAsBi / AlAs量子井戸におけるBiナノ結晶の形成について報告します。 AlAs層は、電荷キャリアの閉じ込めと、アニーリング手順中のGaAsBi層からのBiの外方拡散の防止の両方のバリアとして機能していました。 AlAs層の存在により、Biナノ粒子の核形成がより制御された方法で確保されました。それらのサイズ分布は狭く、密度はアニールされたバルク層よりも高かった[9]。得られたサンプルは、高分解能透過型電子顕微鏡(HRTEM)、PLおよびラマン分光測定によって特徴づけられました。これらの実験の結果は、アニールされたヘテロ構造に純粋なBiナノ結晶が存在することを示しています。実行された理論的推定により、Biナノ結晶はサイズ量子化効果によって直接ギャップ半導体に変換できることが確認されています。
メソッド
GaAsBi / AlAs MQW構造は、金属Ga、Al、Biソースを備えたSVT-A MBEリアクターと、As 2 。以下のMBE成長スキームが使用されました。まず、GaAsバッファ層(約100 nm)と最初のAlAsバリアを、600°Cの高温で標準のMBE成長モードを使用して成長させました。次に、成長を中断し、基板温度を下げて、GaAsBiQWおよびAlAsバリアを成長させた。移行強化エピタキシー(MEE)モードは、次の成長シーケンスでのAlAs堆積に使用されました:Alの1つの単分子層(ML)、グループIII原子の移行のための5回の中断、その後1 MLのAsの供給[14、15 ]。最後に、MQW構造は5nmの厚さのGaAsキャッピング層で覆われていました。 GaAsBi層のBiの含有量は、ω-2ΘXRDスキャンの(200)反射から決定され、成長したままのサンプルでは約7%でした。
2つの異なるMQWサンプルが測定用に選択されました。 MQW Aサンプルには、厚さ10nmのGaAsBiQWが3つ(330°CでMBE成長)、厚さ20 nmのAlAsバリア(同じ温度でMEE成長)で分離されています。 MQW Bサンプルには、Aサンプルの成長に使用される条件と同様の条件下で成長した厚さ4nmのAlAsバリアによって分離された幅10nmのGaAsBi層を備えた20個のQWが含まれています。両方のサンプルの高温処理は、急速熱アニーリング(RTA)オーブン内で、750°Cの温度で180秒間、窒素雰囲気で実行されました。アニーリング中の表面層からのヒ素の損失を防ぐために、サンプルは犠牲GaAsウェーハで覆われていました。
原子間力顕微鏡の表面分析は、成長したままのMQW構造とアニールされたMQW構造の両方の液滴のない表面を示しました。 GaAsキャップ層の表面粗さは1nm未満でした。サンプルアニーリング後にMQWで形成されたナノ粒子の構造的高分解能測定は、元素用のX線エネルギー分散型分光法(EDS)検出器を備えたSTEMモジュールを備えたFEI Tecnai G2 F20 X-TWINTEMによって実行されました。 Zコントラストイメージング用のマッピングおよび高角度環状暗視野(HAADF)検出器。 Omniprobeマニピュレーターを備えたFEIHelios Nanolab 650デュアルビーム顕微鏡を使用して、TEM測定用の試料を準備しました。
図1は、AサンプルのSTEM画像を示しています。この画像は、アニーリング後にGaAsBi量子井戸(QW)層に形成された多数のナノ粒子を明らかに示しています。ナノ粒子のサイズとQW層の幅の間の明らかな相関関係は、画像で追跡できます。相関関係は、AlAs層(最も暗い領域)がGaAsBi層からのBi原子の外方拡散を防ぐバリアとして効果的に機能していることを示しています。 HAADFイメージングと同時に得られたサンプルの選択された領域のEDS元素マッピングは、形成されたナノ結晶が主にビスマス原子で構成されていることを示しています(図2)。
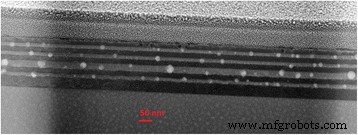
MBEによって成長させた厚さ10nmのGaAsBiQWを3つ、厚さ20nmのMEE成長させたAlAsバリアを1つ使用したAサンプルのSTEM画像。750°Cの温度で180秒間アニーリングした後

GaAsBi / AlAs MQW構造のBiナノ結晶のHAADF–STEM Zコントラスト画像(上記 )。 EDS画像(下 )STEM画像のマークされた領域で測定されたGa、Al、Bi、およびAsの強度の元素マッピングを表します
結果
ラマン分光法
調査したGaAsBiMQWサンプルのラマンスペクトルは、熱電冷却(-70°C)CCDカメラと顕微鏡を備えたVia Raman(Renishaw)分光計によって後方散乱ジオメトリで記録されました。光励起には、ダイオード励起固体レーザーからの532nmの放射線を使用しました。 50×/ 0.75NAの対物レンズと1800本の線/ mmの格子を使用してラマンスペクトルを記録しました。蓄積時間は400秒でした。サンプルの損傷を避けるために、サンプルのレーザー出力は0.06mWに制限されました。ラマン周波数は、シリコン標準(520.7 cm -1 の線)を使用して較正されました。 )。振動モードのパラメータは、GRAMS / A1 8.0(Thermo Scientific)ソフトウェアを使用して、実験スペクトルをガウス-ローレンツ形状成分に適合させることによって決定されました。
成長したままのGaAsBi / AlAs MQW Aサンプルのラマンスペクトルを図3に示します。成長したままのサンプル(図3、緑色の曲線)で269および290 cm で観察された強いダブレット-1 GaAsのような横方向光学(TO)および縦方向光学(LO)フォノンモードにそれぞれ対応します[16、17、18]。後方散乱ジオメトリでは、TOバンドは理想的なGaAs結晶に対して対称的に禁止されています[17、18]が、Biによって誘発される結晶構造の乱れはGaAs結晶格子の対称性を破り、TOモードをアクティブにします。 227および181cm -1 の近くに見える他の2つの広いBi誘導振動モード GaBiのような振動モードに起因する可能性があります[18]。 AlAsバリアの存在は、402 cm -1 の鋭いLOモードからのラマンスペクトルで認識できます。 [19]。
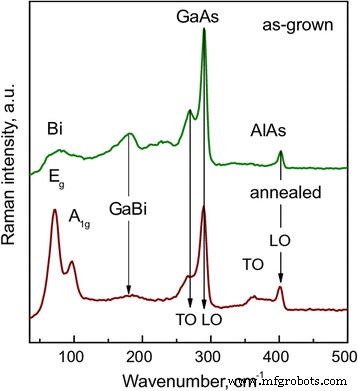
成長したままのラマンスペクトル(緑色の曲線 )およびアニーリング(赤い曲線 )GaAsBi MQWAサンプル
750°Cでのサンプルの比較的短い(180秒)熱アニーリングは、ラマンスペクトルに本質的な変化を引き起こします。(i)72および96 cm -1 に強い低周波数帯域が現れます。 、(ii)269、227、および181 cm -1 付近のバンドの強度 減少し、(iii)361 cm -1 付近の広い特徴 アニーリングされたサンプルスペクトルに表示されます。 72cmと96cmの2つの低周波帯域 -1 E によく対応します g および A 1g 結晶ビスマスのモード[20、21、22、23、24]。これらのバンドの出現と、269および181 cm -1 でのBiによって誘発されたGaBiのようなバンドの強度の減少 は、熱アニーリングがGaAsBi格子サイトからのビスマスの引き抜きとBiナノ結晶へのその凝集を引き起こすことを示しています。さらに、ビスマスナノ結晶の形成は、AlAs層の結晶構造にも影響を及ぼします。これは、361 cm -1 付近で欠陥によって引き起こされる幅広いTO機能の上昇から明らかです。 [25]。
フォトルミネッセンス測定
温度依存フォトルミネッセンス(PL)測定は、500 mm焦点距離モノクロメーター(Andor SR-500i)と液体窒素冷却InGaAs光検出器を使用して実行されました。 532 nmの波長で発光するダイオード励起固体レーザーを、38mWの励起パワーで励起源として使用しました。サンプルは、温度コントローラーと組み合わせたクローズドサイクルヘリウムクライオスタットのコールドフィンガーに取り付けられ、3〜300Kの温度範囲での測定が可能になりました。
さまざまな温度で測定された、厚さ10nmのGaAsBiQWが3つと厚さ20nmのGaAsBiQWが1つ含まれているアニールされたAサンプルのPLスペクトルを図4aに示します。 GaAsのバンドギャップより下のスペクトル特性の2つの主要なセットを区別することができます。約1.35eVにある強力な高エネルギーピークは、GaAsBiQWの放射遷移に起因する可能性があります。ピークの位置は、GaAs 0.979 で観察されたものに近い。 Bi 0.021 / GaAs量子井戸[26]であり、アニーリング後のAサンプルのGaAsBi QW層のBi含有量が2.1%であることを示すXRDデータと相関しています。低エネルギー側の0.6〜1.05 eVのスペクトル特性は、サンプルの熱アニーリング後にPLスペクトルに現れるため、Biナノ結晶の光学遷移に起因する可能性があります。低エネルギーPLバンドは内部構造を持っており、低温でそれ自体が現れます。つまり、 T で =3 K、0.67、0.88、および0.98eVに配置されたPLコンポーネントを区別できます。図4aからわかるように、液体ヘリウム温度では、GaAsBi QWからのPL信号は、低エネルギーPLバンドよりも2桁強力です。ただし、高エネルギーPLピークは温度の上昇とともに急速に減少し、低エネルギーPLピークは T で支配的になり始めます。> 100K。

アニーリングされた a の温度依存PLスペクトル 3つの10nm幅と1つの20nm幅のGaAsBi / AlAsQWと b で構成されるサンプル 20個の10nm幅のGaAsBi / AlAsQWで構成されるBサンプル
図4bに、厚さ4nmのAlAsバリアで分離された厚さ10nmのGaAsBi量子井戸を20個含むBサンプルのPLスペクトルを示します。熱アニーリングの前は、Aサンプルの場合と同様に、Bサンプルはより高エネルギーのQW関連のPLバンドのみを示していました。熱アニーリング後に約0.85eVの強い低エネルギーPLピークが観察されたため、Biナノ結晶からの発光に起因すると考えられます。 Bサンプルの低エネルギーピークの強度はAサンプルの強度よりも強く、QWの数が増えるとスケールアップします。低温では、Aサンプルで十分に分離されたピークの3つの成分を追跡できます。ただし、Bサンプルでは、調査した全温度範囲で低エネルギーPLピークが0.85eV成分によって支配されています。 XRDデータによると、高エネルギーのQW関連のPLピークの位置は、Aサンプル内の位置に対してわずかに低エネルギーにシフトしています。これは、Bサンプルの量子井戸層のBiが2.8%であることを示しています。その熱アニーリング。 Bサンプルでは、QW関連のPLピークがその内部構造を示しています。ピークは、低温で支配的な約1.27 eVの結合励起子関連成分と、約1.35 eVに位置し、高温で支配的な非局在化励起子関連成分で構成されます。 QW関連ピークの内部構造により、PLピーク位置の特徴的なSタイプの温度依存性が生じます(図5の完全なドット)。これは、バルクGaAsBi [27]とGaAsBi / GaAs量子井戸の両方で以前に観察されました。 [26]。低光子エネルギーに配置されたPLピークは、温度依存性がはるかに弱いことを示しています(図5の白抜きの点と曲線)。これは、Varshni関数 E で近似できます。 ( T )= E (0)− αT 2 /(β + T )αおよびβパラメータが10 -4 に等しい場合 それぞれeV / degと100K。温度によるエネルギーギャップの変化の原因となるαパラメータの値は、大部分の半導体の標準値である3°10 -4 よりもはるかに小さいことに注意してください。 –5°10 -4 eV /度これにより、Biナノクリスタルマトリックスは、テレコム波長で発光し、温度感度が低い光源にとって重要な潜在的なシステムになります。

20個の10nm幅のGaAsBi / AlAsQWで構成されるアニールされたBサンプルの高エネルギーおよび低エネルギーPLバンドのスペクトル位置の温度依存性
ディスカッション
本研究で実施されたHRTEM、EDS、およびラマン分光測定は、低温MBE成長GaAsBi / AlAs MQWサンプルの熱アニーリング後にBiナノ結晶(量子ドット)がGaAsBi層に析出することを示しています。これらのナノ結晶は、アニールされたサンプルに現れる長波長のフォトルミネッセンスバンドの原因であると推測できます。バルクビスマスは半金属ですが、Bi電荷キャリアの有効質量が小さいため、Biベースのナノ構造で量子閉じ込め効果が早期に発生します。実際、サイズ量子化効果の最初の実験的観察の1つは、薄いBi層について報告されました[28]。 Bi薄膜の半金属から半導体への転移、 d <30 nm、参考文献で実験的に観察されました。 [29]。この遷移は、直径が65 nm未満のBiナノワイヤでも明らかになっています[30、31]。どちらの場合も、温度に依存する電気的特性の測定から半導体状態が特定されました。ビスマスナノ粒子の量子サイズ効果は、電子エネルギー損失分光法によって初めて研究され[32]、半金属から半導体への遷移は、直径40nm未満のBiナノ粒子で発生することがわかりました。直接半導体状態への移行は、コロイド状の3.3 nmBiナノ粒子について最近報告されました[33]。
純粋なBiでは、電子と正孔の主な谷は L にあります。 および T ブリュアンゾーンのポイントであり、楕円体の等エネルギー面に対応します(表1)。球形の量子ドットの楕円体の谷の電子(正孔)の基底状態は、おおよそ次のように推定できます。
<図> $$ W =\ frac {\ pi ^ 2 {\ hslash} ^ 2} {2 \ overline {m} {r} _0 ^ 2} \。 $$(1)ここで r 0 はQD半径で、\(\ overline {m} \)は平均逆有効質量です。
$$ \ frac {1} {\ overline {m}} =\ frac {1} {3} \ left(\ frac {1} {m_1} + \ frac {1} {m_2} + \ frac {1} { m_3} \ right)、$$(2)m 1 、 m 2 、および m 3 楕円体の谷の主要な有効質量です。
現象論的公式(1)は、地表エネルギーレベルε 1 の厳密な推定値を示します。 有効質量の任意の比率で無限に深い球形QDで。確かに、それは正確です、ε 1 = W 、球形の等エネルギー面の場合( m 1 = m 2 = m 3 )、ε 1 を予測します 精度12%のエネルギー、ε 1 ≈0.88 W 、および25%、ε 1 =0.75 W 、強く扁平な球状の谷( m )の限定的な場合 1 = m 2 、 m 3 →∞)そして回転楕円体を強く扁平化する( m 1 = m 2 、 m 1 →∞)、それぞれ。したがって、主要な有効質量の任意の値で、式(1)は25%よりも優れた精度でQD地表エネルギーを近似します。
式(1)を使用すると、ビスマス量子ドット E の有効エネルギーギャップを簡単に簡単に評価できます。 g、eff = E g + W e + W h 、ここで E g はバルク結晶のエネルギーギャップであり、 W e および W h は電子と正孔のサイズの量子化エネルギーです(1)。計算された実効 T および L エネルギーギャップは図6にグラフで示されています( T の両方での電子と正孔の質量 および L ポイントは等しいと見なされました。)

サイズを小さくしたBiQDエネルギースペクトルによる進化( r 0 および d QDの半径と直径です)
バルクの半金属ビスマスでは、 L の伝導帯の最小値 谷は T より38meV下です 最大価電子帯。 Bi粒子のサイズを小さくすると、 L での実効エネルギーバンドギャップが大きくなります。 ポイントは T よりも速く増加します L の有効質量が小さいためにポイント -谷、最終的に半金属から半導体への移行につながるもの( i -図6のクロスオーバーポイント)。最初に、ビスマスナノ結晶は、 L で最小の伝導帯を持つ間接半導体になります。 T での点と最大価電子帯の最大値 点。 QDサイズをさらに小さくすると、価電子帯と伝導帯の両方のエッジが T に現れます。 Bi QDをダイレクトギャップ半導体にするポイント( d -図6のクロスオーバーポイント)。
図6は、エネルギースペクトルの大まかなスキームのみを示していることに注意してください。このスキームは、非放物線効果を無視し、QDの無限のエネルギー障壁を想定しているためです。 L には、放物線分散則からの逸脱が不可欠です。 -谷([34]などを参照)。実際、 L での有効質量 -谷の中心は、フェルミエネルギー(図6に示されているエネルギースペクトルの計算に使用された)での値の約5分の1です。一方、非放物線効果は T では弱くなります。 エネルギーバンドギャップが大きい点、したがって、提示された有効な T エネルギーギャップ(図6)は、関連する見積もりと見なすことができます。
上記では、約0.85 eVの低エネルギーPLピークは、直径が約10nmのBiナノ結晶で発生している光学遷移によるものと想定していました。 d の提示された計算 =10nmQDは E を予測します g、eff =0.76 eVの有効エネルギーギャップ。これは実験と合理的に一致しているため、低エネルギーPLピーク原点の仮定をサポートします。
結論
要約すると、複数のGaAsBi / AlAs層状量子井戸構造は、GaAs基板上で混合MBE / MEEプロセスによって成長しました。 750°Cでの構造の成長後の熱アニーリングの後、多数の比較的低分散のナノ粒子がGaAsBi量子井戸内で核形成されました。 HRTEM、EDS、およびラマン分光測定は、ナノ結晶が主にビスマスで構成されていることを示しています。実行されたフォトルミネッセンス測定により、アニーリングされたサンプルに現れる追加の低エネルギー、約0.85eVのPLピークが明らかになります。低エネルギーPLピークは、おそらくBiナノ結晶の光学遷移に起因する可能性があり、量子サイズ効果によって直接バンドギャップ半導体状態に変換されます。実行されたBi量子ドットのエネルギースペクトルの推定は、この仮定を裏付けています。明確な答えを得るには、さらに詳細な実験的および理論的作業が必要です。
略語
- EDS:
-
エネルギー分散型分光法
- HAADF:
-
高角度環状暗視野
- HRTEM:
-
高分解能透過型電子顕微鏡
- MBE:
-
分子線エピタキシー
- MEE:
-
移行が強化されたエピタキシー
- PL:
-
フォトルミネッセンス
- QD:
-
量子ドット
- QW:
-
量子井戸
- RTA:
-
ラピッドサーマルアニーリング
- STEM:
-
走査型透過電子顕微鏡法
- TOおよびLO:
-
それぞれ横光学フォノンモードと縦光学フォノンモード
ナノマテリアル
- Fe3 +の高感度測定のためのMXene量子ドットの蛍光を制御するN、N-ジメチルホルムアミド
- 効果的な酵素模倣物としてのピリジニックリッチN、S共ドープ炭素量子ドットの合成
- 重金属を含まない発光ダイオードに適用するためのInP / ZnSコア/シェル量子ドットのグリーン合成
- 豆腐廃水から蛍光炭素量子ドットを合成するための簡単なアプローチ
- 水溶性硫化アンチモン量子ドットの合成とそれらの光電特性
- グラフェン/ Ag3PO4量子ドット複合材料の簡単なワンステップソノケミカル合成と光触媒特性
- 1.3μm量子ドットレーザーの調製のためのInAs / GaAs量子ドットのバイモーダルサイズの排除
- ユウロピウムをドープしたコアシェルZnSe / ZnSe量子ドットにおける粒子間エネルギー移動のシェル厚依存性
- 1.3〜1.55μmウィンドウでの変成InAs / InGaAs量子ドットのバンド間光伝導
- 水溶性青色発光Mn合金CdTe量子ドットの合成と性質
- Si基板上での中赤外直接バンドギャップ放出のためのひずみ工学GeSn / GeSiSn量子ドットの設計



