1.3〜1.55μmウィンドウでの変成InAs / InGaAs量子ドットのバンド間光伝導
要約
変成InAs / In x の光電特性 Ga 1 − x 量子ドット(QD)ナノ構造は、光伝導性(PC)とフォトルミネッセンス分光法、電気測定、および理論的モデリングを使用して、室温で研究されました。 In x の化学量論が異なる4つのサンプル Ga 1 − x クラッド層が成長するにつれて:インジウム含有量 x 0.15、0.24、0.28、0.31でした。 InAs / In 0.15 Ga 0.85 QD構造は、1.3μmのテレコム範囲で感光性であることがわかったため。 x として 増加すると、すべてのサンプルで赤方偏移が観察され、 x の構造になります。 =0.31は、1.55μm付近、つまり3番目の通信ウィンドウで感度が高いことがわかりました。同時に、 x の増加に対して、QDPCのわずかな減少のみが記録されました。 、したがって、In 0.15 のものに匹敵する良好な光応答を確認します。 Ga 0.75 構造としておよびGaAsベースのQDナノ構造。また、PCの減少は、フォトルミネッセンス強度の同様の減少と相関しています。量子エネルギーシステムとQDのキャリア局在化を理論的にシミュレートすることにより、PCメカニズムへの洞察を得て、そのようなタイプの構造における欠陥の特異な挙動と関連付けることにより、光電流の減少の理由を示唆することができました。これはすべて、 x が高い変成QDを意味します。 光電子赤外線感光性デバイスの有効な構造です。
背景
変成InAs / In x Ga 1 − x QDナノ構造は、多くの利点があるため、過去10年間で多くの関心を集めてきました[1,2,3,4,5,6,7]。彼らの最も魅力的な特徴は、InGaAs変成バッファ(MB)上でQDを成長させることにより、従来のIn(Ga)As / GaAsQD構造と比較してQDレベル間の遷移エネルギーを大幅に削減できることです[8]。 。これは、InAsQDとInGaAsバッファ間の格子不整合の減少の結果としてのInAsQDバンドギャップの減少、したがってQDの歪みが原因で発生します[9、10、11]。したがって、閉じ込め材料としてMBを適用すると、高効率を維持しながら、発光波長値を赤外線(IR)範囲、特に1.3および1.55μmの通信ウィンドウにさらに深くシフトさせることができます[4、12、 13]。さらに、変成QDは、(i)高いQD密度[14]、(ii)QDと濡れ層(WL)レベルを広く調整する可能性[10、15]、(iii)優れた性能などの興味深い特性を示しています。発光デバイスの活性元素[16]。ただし、変成QDの深いレベルに関する最近の調査では、InAs / In 0.15 にもかかわらず、 Ga 0.85 InGaAs / GaAs仮像QDに匹敵するQD層に近い総欠陥密度を持つQD構造として、より高い x の変成構造 より高い欠陥密度を示した[17、18]。
メタモルフィックInAsQD構造は、レーザー[19、20]、単一光子源[3、7、21、22]、太陽電池[23]などのIRフォトニックおよび感光性デバイスの設計と製造に成功したアプリケーションを発見しました。 、24、25]。 In(Ga)As QD光検出器は、通常の入射での照射に対する応答により、近赤外から長波赤外の範囲での検出を強化するために、現在、バンド間およびサブバンド間遷移に基づいて積極的に研究されています[26、27、28、29、30]。 。たとえば、量子閉じ込めレベルと連続状態の間の電子のサブバンド間遷移は、InGaAs層にInAs QDを埋め込むことによって設計できます[29、30、31、32]。この設計では、検出ピーク波長を調整して、外部から加えられたバイアスによる応答と暗電流の低減[33、34]。現在まで、光検出器での変成QD構造の実装に関する論文はありません。
この分野の開発の重要な役割は、従来のInAs / GaAs QD構造と少なくとも同等である必要がある変成QD構造の高い発光効率と感光性を維持することです[1、5、35]。構造設計の開発[6、14、21]、光電特性の改善[5、13]、およびヘテロ構造のひずみ関連欠陥の制御/低減[4、 36、37]。
したがって、InAs / In x Ga 1 − x 変成QDナノ構造は興味深いナノ構造であるため、1.3および1.55μmのIR範囲で発光または光応答性を示すことができます[1,2,3,4,5,6,7]。さらに、垂直方向のInAs / In 0.15 は、以前に報告されました。 Ga 0.75 QD構造はGaAsベースのものに匹敵する感光性を維持できるため[5]。ただし、このような変成構造は、横方向の形状の光電測定ではめったに研究されません。この場合、光電流は、2つの上部接点間のチャネルを横切るキャリアの面内輸送を介して進行します。一般に、QD層は関連するWLとともに、横方向の形状設計されたGaAsベースの構造でこれらの導電率チャネルを形成します[38]。この特異なタイプの導電性のために、横方向輸送を備えたQD光検出器は、高い光応答性の可能性があると考えられています[39、40]。横方向の構成における変成InAs / InGaAs QDナノ構造の詳細な研究は、光伝導(PC)メカニズムとプレーンキャリア輸送の効率に関する基本的な知識を提供することができます。変成QD構造の欠陥に関する最近の論文[17]では、欠陥に起因するIRスペクトルエッジのみを考慮して、低温での横方向PC測定を報告しました。ただし、室温での構造の適切な特性評価と基本的な調査により、メタモルフィックQDを実装することにより、近赤外光検出器、線形アレイ、カメラマトリックスなどの新しい感光性デバイスをさらに改善するための貴重な洞察が得られると考えています。
本研究では、変成InAs / In x の面内光電特性を研究しました。 Ga 1 − x 異なるIn組成の分子線エピタキシーによって成長したQDナノ構造として x 、PCおよびフォトルミネッセンス(PL)分光法、横方向の電気測定、およびモデリング計算を採用しています。特に、In 0.15 の感光性を維持しながら、1.3μmを超えるIRに対するQD層の光応答の赤方偏移の可能性の観察に焦点を当てました。 Ga 0.85 AsおよびGaAsQD感光性構造。室温での近赤外波長範囲での高い感光性は、これらのナノ構造がバンド間遷移に基づくデバイスだけでなく、10μmを超えて動作するサブバンド間光検出器にも役立つ可能性があることを示しています。
メソッド
サンプルの準備と説明
図1に概略的に示されている研究対象の構造は、分子線エピタキシー法によって成長させたものです。最初に、半絶縁性(100)GaAs基板を600°Cで100 nmの厚さのGaAsバッファで覆い、続いて490°Cで500nmの厚さのドープされていないInGaAsMBを堆積しました。次に、基板を冷却するために210秒間の事前の成長中断の後、3.0 ML(単分子層)のInAsを460°Cで成長させました。最後に、これらの自己組織化QDは、20nmのドープされていないIn x で覆われていました。 Ga 1 − x 同じMB化学量論と同じように。 In x の化学量論が異なる4つのサンプル Ga 1 − x クラッド層が製造されたとき:内容 x 0.15、0.24、0.28、0.31でした。
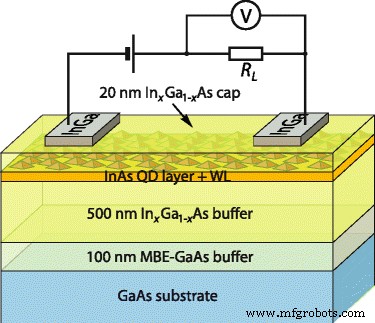
オンラインカラー。変成InAs / In x のスキーム Ga 1 − x 光電測定のためのQD構造とそれらの接続として
理論的モデリング
変態構造の設計とエネルギープロファイルの理解のために、In(Ga)As QD、アンドープMB、およびキャップ層で構成される量子エネルギーシステムの計算は、私たちが実証したTibercadソフトウェア[41]を使用して実行されました。半導体の低次元ナノ構造の光学特性をシミュレートするのに十分である[2、15、42]。
実験的な原子間力顕微鏡データから得られた円錐形とサイズが切り捨てられたInAsQDを検討します[14]。 InAs WLの存在を含めます。このパラメーターは、In x に依存します。 Ga 1 − x 変成層の特性として[15]。
まず、構造のひずみ計算は、不一致 f によって引き起こされるQDのひずみテンソル成分を計算することによって行われます。 QD QDとMBの間、次のように定義されます
$$ {f} _ {\ mathrm {QD}} =\ left [{a} _ {\ mathrm {InAs}} \ hbox {-} {a} _ {\ mathrm {MB}}(x)\ right ] / {a} _ {\ mathrm {MB}}(x)$$(1)ここで a MB ( x )はIn x の格子定数です Ga 1 − x MBおよび a として InAs InAsの格子定数です。次に、QDと埋め込み層のバンドプロファイルは、関連する材料の変形ポテンシャルに依存します(QDとWLの場合はInAs、MBの場合は緩和されたInGaAs)。
最後に、シュレディンガー方程式
$$ \ boldsymbol {H} \ psi =E \ psi $$(2)は、電子のシングルバンド有効質量アプローチとホールの6バンドk•pアプローチによるエンベロープ関数近似で解かれます。ここで、3Dハミルトニアンは
$$ \ widehat {H} =-\ frac {\ upeta ^ 2} {2} {\ nabla} _ {\ mathbf {r}} \ left(\ frac {1} {m \ left(E、\ mathbf { r} \ right)} \ right){\ nabla} _ {\ mathbf {r}} + V \ left(\ mathbf {r} \ right)、$$(3)V で ( r )3Dの可能性です。
このような近似は、QD基底状態計算を実行するときに満たすと見なされます[2]。したがって、電子と重い正孔の地表レベルが、それらの確率密度とともに取得されます。フォトルミネッセンスの放出エネルギーは、励起子効果を考慮して20 meV減少させた、電子と重い正孔の閉じ込められたレベル間のエネルギー差を考慮して導き出されました。
モデル計算の詳細については、参考文献を参照してください。 [2]。
光電特性評価
横方向の光電測定では、2つのInGa共晶表面接触が5×2mmの構造片上に堆積されました。測定された線形 I – V 図2に示されている特性により、接触のオーミシティが確認されています。サンプルを流れる電流は、Siglent SDM3055マルチメーターによって、直列負荷抵抗 R の両端の電圧降下として標準のDC技術[43、44]を使用して測定されました。 L 1MΩであり、これはサンプル抵抗よりはるかに小さかった。光電流は、プリズムモノクロームで分散された250 Wのハロゲンランプ光によって励起され、PCスペクトルは0.6〜1.6eVの範囲で記録されました[44,45,46]。スペクトルは、光源の励起量子数に正規化されました。 PLスペクトルは、励起源として532 nmのレーザーを使用し、出力密度が5 W / cm 2 で取得されました。 。すべての測定は室温(300 K)で実施されました。

オンラインカラー。 私 – V InAs / In x の特性 Ga 1 − x x の構造として =0.15( a )、0.24( b )、0.28( c )、および0.31( d )暗闇(黒)および350μW/ cmの照明下 2 (色)PLスペクトルピーク(QD励起)および1.3 eV(InGaAsでの有効吸収)のエネルギー。挿入図:バイアス電圧に対する光電流の依存性
結果と考察
研究された変成InAs / In x のPCスペクトル Ga 1 − x 室温でのQD構造は、QD基底状態間の光学遷移を示すPLバンドとともに図3に示されています。 PLバンドの相対強度と位置も図4bに示されています。 QD、InGaAs閉じ込め層、およびGaAs底層による特徴がPC曲線上に観察されます。 PLバンドの開始より下のエネルギーでの光電流信号は、以前に検出された構造欠陥に関連している可能性があります[17]。

オンラインカラー。変成InAs / In x のPCスペクトル Ga 1 − x 室温および x のバイアスが11Vの構造物として =0.15( a )、0.24( b )、0.28( c )、および0.31( d )。 1.3 eVでの黒、赤、青の曲線の励起強度は、88、350、および1400μW/ cm 2 に対応します。 、 それぞれ。 QD基底状態遷移のエネルギーポジショニングのために、任意の単位のPLスペクトルが与えられます。垂直の矢印は、InGaAsバンドギャップ(ε g )を示しています。 )Paul etal。に従って計算。 [48]および励起強度に対するPCの依存性が測定されたスペクトル位置(図5に示されています)

オンラインカラー。変成InAs / In x のモデリング計算 Ga 1 − x QD構造として: a x が異なる構造のバンドプロファイル 成長軸に沿って; b 実際のQDPLバンドとそれらの計算されたピーク位置(破線の垂直線)。および c InAs / In 0.15 の閉じ込められた電子と正孔の確率密度 Ga 0.85 QDとして。モデル化された構造のすべての計算は、300Kで実行されました
調査した変成InAs / In 0.15 Ga 0.85 QD構造は、0.95 eV(1.3μm)のテレコム範囲で感光性であることがわかったため(図3a)。 x として 増加すると、すべてのサンプルで赤方偏移が観察されました。 x の構造 =0.31は、0.8 eV(1.55μm)付近(図3d)、つまり3番目のテレコムウィンドウで感度が高いことがわかりました[47]。このシフトは、InAsQDとIn x の材料間の格子不整合の低減に関連しています。 Ga 1 − x x が増加したバッファとして したがって、QDのひずみが減少します。これにより、InAs QDバンドギャップが狭くなり、PLバンドの赤方偏移と、IRへの光応答の開始が発生します[1,2,3,4,5,6、19,35]。
同時に、QD光電流信号のわずかな減少のみが記録されたため、In 0.15 と同等の良好な光応答性が維持されていることが確認されました。 Ga 0.75 サンプルとして。最近[5]で議論したように、 x の変成QD構造 =0.15は、仮像InAs / GaAsQDナノ構造と非常によく似た光応答を示します。また、図3に示すように、PCの削減はPLの削減と相関関係があります。
サンプルに対するこのような影響は、図2で最も顕著であることがわかりました。ここで、 I – V バイアス電圧に対するさまざまな特性スペクトルポイントでの暗所および照明下での依存性が、挿入図の光電流依存性とともに示されています。図3のように、光電流値は、暗電流値を差し引いて、照明下の全電流から得られた電流の光誘起部分のみを意味します。これらのスペクトルポイントは、PLバンドの最大値と1.3 eVであり、InGaAsMBで効果的なバンド間吸収が発生します。暗い私のためだけでなく – V 特性、これらの依存関係は実験誤差内で線形のようです。
最良の光応答は、閉じ込め層のIn含有量が最小の構造で測定されました。また、暗電流が最も低かった。適用された励起レベル(350μW/ cm 2 )での光電流値 )InAs / In 0.15 Ga 0.85 構造はMBがポンピングされたときの暗電流の2〜3倍上にあったため。 QD励起での光応答は暗電流に匹敵しました。ただし、構造にはQDレイヤーが1つしかないことを考慮する必要があります。多層QD構造の製造は、確かにIR光応答の大幅な増加につながります。 x が高いその他の構造 より低い光電流信号を明らかにした。両方のスペクトルポイントで検出された大きさは、広範囲の印加電圧での暗電流値よりも約1桁低かった。最も低い光応答は、InAs / In 0.31 で見つかりました。 Ga 0.69 MBInコンテンツが最大の構造として。
おそらく、この光応答性の低下は、 x によるMB欠陥密度の増加に関連しています。 、これらの構造について以前に決定された、深いレベルの熱刺激電流分光法[17]を使用して、そのようなナノ構造の構造分析とよく相関しました[1]。 InAs / In 0.15 Ga 0.85 QD構造はInGaAs / GaAs構造に匹敵するQD層に近い総欠陥密度を持っていたのに対し、In含有量が高い他の構造は、既知のGaAs関連点欠陥複合体EL2、EL6、EL7、EL9、およびQD層の近くのEL10と、バッファを介して伝播する拡張欠陥に起因する3つのレベル。
スペクトル形状(図3)に関しては、QD励起より上では、光吸収、したがってキャリア生成は、主にMBでInGaAs閉じ込め層のバンドギャップε g > 、さまざまな x の値 経験式[48]によって推定されました。ただし、ε g を超える光子エネルギーの増加は注目に値します。 光応答のわずかな低下につながります。当然、これは、効果的な再結合中心[1、2、12、22]であるにもかかわらず、変成QDがMB [5、6、23]よりも光電流に効率的に寄与することを確認します。
この特異性のPCメカニズムを理解するには、図4aを参照してください。ここでは、サンプルの成長方向に沿って計算されたQDバンドプロファイルを示しています。計算は、電子と正孔の量子エネルギーレベルの結果によって検証されます。予想されるPL放出エネルギーは、実験的に測定されたPL QD基底状態遷移と一致しています(図4b)。図4cに、Tibercadモデル化で計算されたキャリア波動関数によって得られた、閉じ込められた電子と正孔のシミュレートされた確率密度を示します。これは、電子と比較して重い正孔の局在化のレベルが高いことを示しています。
光電流信号に寄与するために、QDバンド間吸収によって生成された電子正孔対は、熱放射によってQDから逃げる必要があります。以前の研究[49]で、変成QDでは、電子と重い正孔が相関ペアとしてQDから同時に脱出することが確立されました。さらに、そのようなプロセスの活性化エネルギーは、2つの粒子の活性化エネルギーの合計に対応することも実証されました[50]。
変成QDからのPL放出の熱消光を研究している間[10、51]、そのような活性化エネルギーはWLレベルとQD状態からのエネルギー距離の合計に等しく、 x =0.15 x の場合は150meVまで =0.31。参考文献で広く議論されているように。 [51]、これらの値は、閉じ込められたキャリアの熱逃げを介して、室温でのPL発光の強力な消光を引き起こします。
このような根拠に基づいて、QDで励起されたキャリアはWLとMBに熱的に逃げることができると推測できます。そこでは、電子と重い正孔がQD付近でバンドベンディングによって分離され(図4a)、正孔がQDにトラップバックするのを促進します。そして、電子の障壁でありながら、それによってそれらの放射再結合を効果的に抑制します。その結果、重い正孔はQDの周辺に集中しますが(図4c)、電子はWLとMBのポテンシャル井戸に沿って自由に移動し、導電率に寄与します。参考文献でそれを注目する価値があります。 [49]、脱出プロセス中に相関しているが、キャリアは室温で励起子と見なすことはできないと議論されている。今後は、QD付近でバンドを曲げることで簡単に分離できます。
そうしないと、MBを励起すると、非平衡正孔が閉じ込め層に生成され、電子と再結合します。ここで、WLはGaAsに基づくナノ構造の導電性チャネルであることが知られており[52]、表面接触で設計されたラテラル構造ではヘテロ接合がないため、キャリアは表面近くで効率的に収集されます。
図3では、PC信号がε g のすぐ上に落ちています。 x のサンプルの場合、1.3または1.1 eVを超えるなど、より高いエネルギーで上昇に変わりました。 それぞれ0.15または0.31の。これは、表面とQD層に近い光吸収が原因であると考えられ、トラップが浅くなります。熱刺激電流分光法と深層過渡分光法によってこれらの構造に対して確立されたように[17、18]、より深い電子トラップは主にInGaAs MB層にあり、浅い電子トラップは表面近くに集中しています(これらのサンプルに関連して、 QD層の近く)。浅いトラップにトラップされた電子は、室温で伝導帯に簡単に戻ることができます。したがって、QD層の近くの自由電子は、MBの奥深くで励起された自由電子よりも移動性が高く、したがって、電荷移動への寄与が大きくなります。さらに、表面近くで生成された電子は、WL導電率チャネルに自由に移動できます。
GaAsバンドギャップ(1.4 eV付近)を超えると、同様の光電流の低下が観察されました。この効果は、トラップと再結合中心である欠陥状態の密度が高いことが知られているInGaAs / GaAs界面に近いキャリア生成が原因である可能性があります。
構造の光応答に対するさまざまな光学遷移の相対的な寄与は、励起強度によって異なります。これは、さまざまな特徴的なスペクトルポイントでの励起強度の関数としての光電流値を示す図5でよりよく観察されます。つまり、PLバンドの開始(QDアンサンブルの共鳴励起)またはInGaAsでの効率的なバンド間吸収です。 (1.3 eV)およびGaAs(1.5 eV)。
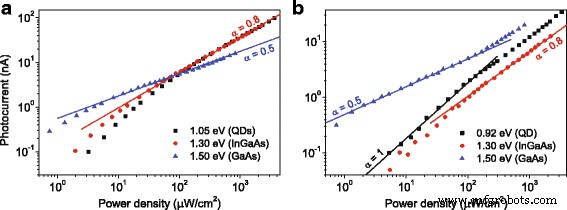
オンラインカラー。 InAs / In x の光電流と励起強度 Ga 1 − x a の構造として x =0.15および b 0.31。線は関数 f によるフィッティングです ( x )〜 x α
閉じ込め層のIn含有量が異なる構造は、同等のスペクトル範囲で同様の依存性を示しました。したがって、GaAs(1.5 eV)のバンド間励起は、ほとんどの強度値で2次依存性を示します。これは、非平衡電荷キャリアのバンド間再結合に典型的です。たとえば、平衡キャリアの下で非常に優勢である場合[53]:これはドープされていない構造で予想されます。 QDおよびInGaAs閉じ込め層での励起の場合の依存性は互いに非常に似ていますが、GaAsの場合とは異なります。それらは、低い励起強度では線形であり、高い強度では劣線形になります。この振る舞いは、Shockley-Readセンターが関与するキャリア再結合を明らかに示しています。一部のセンターはより高いキャリア生成率で飽和しているため、線形依存性は劣線形になります[54]。強度依存測定のこれらの結果は、QD埋め込み層での比較的低い再結合率とGaAs層でのはるかに高密度の再結合中心での主電荷キャリアの効率的な生成を明確に示しています。たとえば、同様の特性評価でのQD励起中に、InGaAs / GaAsQD感光性構造は PC のように強度からの依存性を示しました。 (私 )〜私 0.25 、QD放射再結合に伴う欠陥レベルを介して非放射再結合の割合が高いために発生しました[40、55]。ただし、InGaAs / GaAs構造は7つのQD層を持つ多層構造であることに注意してください。
これらの測定値とその解釈から、IR検出に変成QDを使用するためのいくつかの兆候を強調することができます。(i) x を使用する場合> 0.15、変成QDの開発で行われたのと同様に、ひずみ関連の欠陥を制御できる高度な設計を使用する必要があります[19、20、37]。 (ii)暗電流を超えるQD PCを得るには、QDの多層スタック(最低10層)が必要です[27、56]。 (iii)重い穴のより高い閉じ込めは、量子ドットを励起するときに得られる光電流にとって有益であるため、重い穴のためのより高いギャップの障壁を備えた高度な設計を検討することができます[51、57]。したがって、これらの調査結果は、IR検出および変成QD光検出器の開発を目的とした変成QDの設計に非常に役立つ可能性があります。
結論
変成InAs / In x の光電特性 Ga 1 − x QDナノ構造は、PCおよびPL分光法、電気測定、および理論モデルシミュレーションを使用して、室温で研究されました。研究された変成InAs / In x Ga 1 − x QDナノ構造は、1.3( x =0.15)および1.55μm( x =0.31)。ただし、QD PCと、MB単位のIn含有量が高い構造のPL効率は低く、それでもInAs / In 0.15 と同等であると推定されました。 Ga 0.85 InGaAs / GaAsQD構造と同様の感度を持つAs構造。この光応答性の低下は、 x によるMB欠陥密度の増加に関連しています。 。また、モデリング計算のおかげで、調査したタイプのQD構造のPCメカニズムに関する洞察を提供しました。これはすべて、 x が高い変成QDを意味します。 ナノ構造の設計を最適化することでいくつかの懸念事項に対処するという条件で、オプトエレクトロニクスIR感光性デバイスの有効な構造です。
略語
- ε g :
-
InGaAs閉じ込め層のバンドギャップ
- E c および E v :
-
導電率と価電子帯のエネルギー
- IR:
-
赤外線
- MB:
-
変成バッファー
- ML:
-
単層
- PC:
-
光伝導
- PL:
-
フォトルミネッセンス
- QD:
-
量子ドット
- R L :
-
負荷抵抗
- WL:
-
ぬれ層
ナノマテリアル
- Fe3 +の高感度測定のためのMXene量子ドットの蛍光を制御するN、N-ジメチルホルムアミド
- マイクロピラーのInAs二重層量子ドットに基づく1.3μmの明るい単一光子源
- 効果的な酵素模倣物としてのピリジニックリッチN、S共ドープ炭素量子ドットの合成
- 自己組織化InAs / InGaAs量子ドット超格子における空間的に局在化した励起子の検出:光起電効率を改善する方法
- アニーリングされたGaAsBi / AlAs量子井戸のビスマス量子ドット
- 変成InAs / InGaAs / GaAs量子ドットヘテロ構造の光起電力における双極効果:光感受性デバイスの特性評価と設計ソリューション
- 豆腐廃水から蛍光炭素量子ドットを合成するための簡単なアプローチ
- 水溶性硫化アンチモン量子ドットの合成とそれらの光電特性
- グラフェン/ Ag3PO4量子ドット複合材料の簡単なワンステップソノケミカル合成と光触媒特性
- 1.3μm量子ドットレーザーの調製のためのInAs / GaAs量子ドットのバイモーダルサイズの排除
- データ バスの完全な概要:点をつなぐ!



